

第七届华进开放日在无锡成功举办
电子说
描述
2020年9月15日,SYNAPS 2020 &第七届华进开放日在无锡新湖铂尔曼成功举办。本次研讨会由华进和Yole共同主办,由SPTS、BESI、百贺、Moldex3D、ERS、LexisNexis IP、首镭激光、KNS、北方华创、HANMI、JSR、ASM倾情赞助,芯师爷、半导体芯科技联合宣传。
活动赞助商及媒体合作伙伴
由于摩尔定律减缓和异质集成带来的强劲动力,加上5G、AI、HPC、IoT等大趋势,先进封装市场在整个半导体市场中所占的份额正在不断增加。截至2025年,它将占据总市场的近50%。当前先进封装正从封装基板平台转向硅平台,这一重大转变为台积电、英特尔和三星这样的巨头带来巨大的机遇。
SYNAPS和华进开放日作为华进的品牌活动,关注全球行业趋势,为业界同仁提供了一个分享行业观点、评估新兴方案、开拓市场机遇的专业平台。由于疫情影响,2020年SYNAPS和华进开放日合并召开,现场人气依然高涨。本次会议共有嵌入式技术及系统级封装、高端封装及3D、存储封装、玻璃封装四个议题,由华进技术总监姚大平博士和孙鹏博士主持,华进副总经理肖克和Yole分析师Richard Li致欢迎词,矽品高级总监C. Key Chung博士、海思何洪文博士、Evatec 先进封装事业部负责人Ewald Strolz、华进研发总监王启东博士、长电科技工程总监沈国强、华天科技技术市场总监刘卫东、武汉新芯COO&高级副总裁孙鹏、EVG业务开拓总监Thomas Uhrmann、Formfactor CMO Amy Leong、ASM销售经理林德荣、Camtek COO Ramy Langer、Corning 产品线经理Varun Singh、厦门云天CEO于大全博士以及Yole首席分析师Santosh Kumar等十八位重量级嘉宾与会报告,呈现一场半导体先进封装的技术盛宴。
主活动现场
嵌入式技术和系统级封装
矽品高级总监C. Key Chung博士介绍了一种可扩展的小芯片(chiplet)封装技术,即扇出嵌入式桥(FOEB)。该解决方案具有低成本、延展性佳、传输损耗低、设计灵活、热翘曲低等优势。
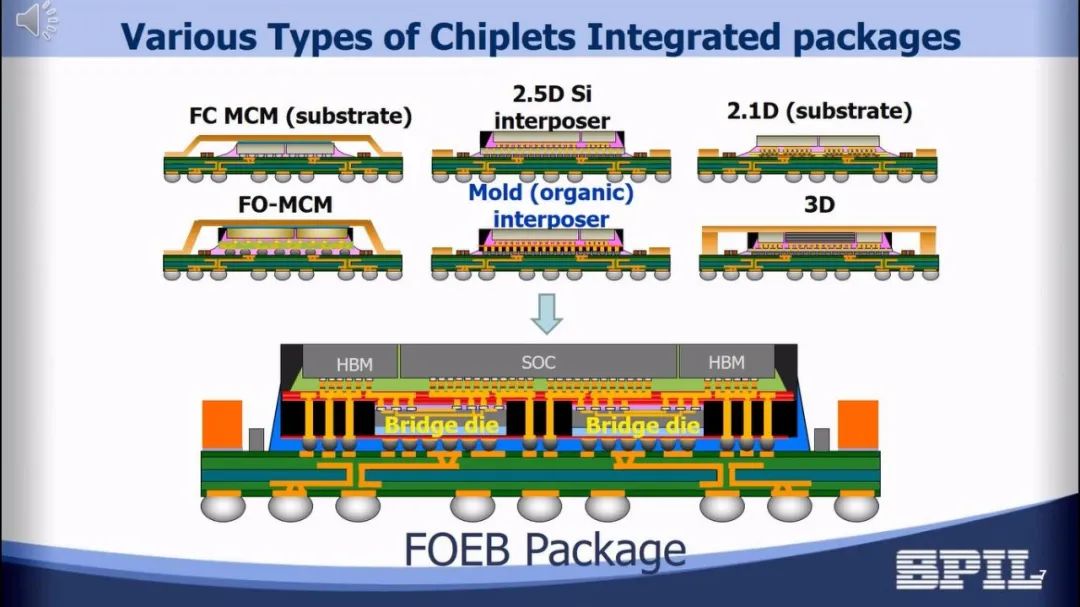
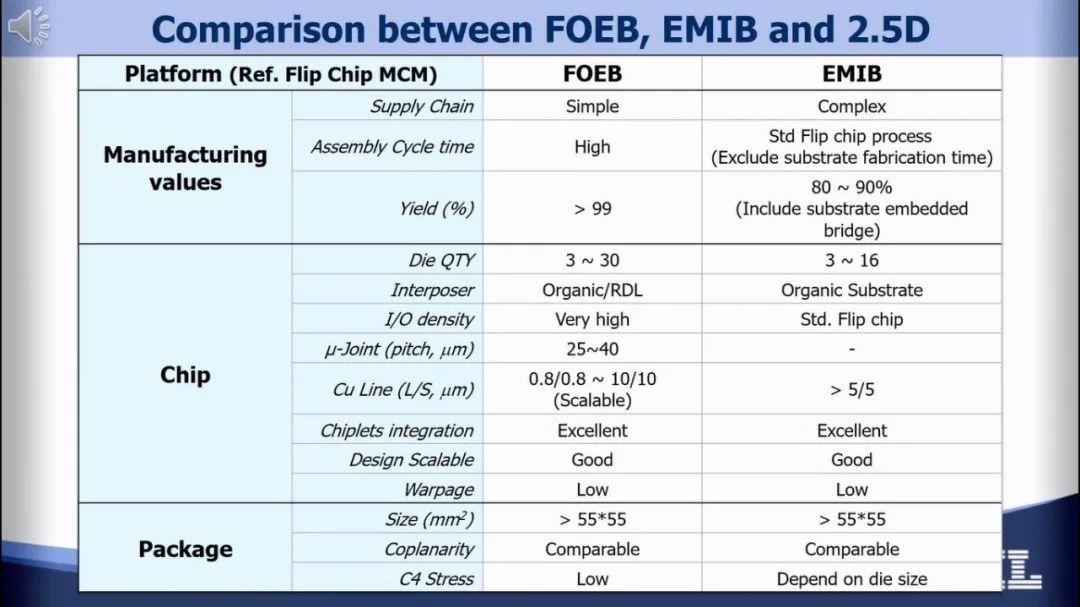
矽品报告
ASM Assembly System高级产品经理Sylvester Demmel认为随着嵌入式工艺的渗透,无疑为贴片设备在拿持大尺寸薄基板和贴装大量不同类型的芯片和被动元件时增加复杂性和挑战。ASM与终端用户合同,从软件、面板处理、支持系统以及载板设计等方面入手解决这些挑战。Evatec工艺开发负责人Ewald Strolz提到大规模面板工艺需要解决翘曲或凹陷问题,介绍了晶圆级&PCB/IC基板技术的融合以及一种面板级PVD种子层工具。SPTS 执行副总裁&总经理David Butler为大家介绍了HD FOWLP PVD研发进展,讨论了物理气相沉积(PVD)下凸点和RDL金属层过程中优化产量和生产率的解决方案。
华进半导体研发总监王启东博士为观众介绍了华进半导体先进基板的研发进展。作为国内唯一一条全面的先进基板研发线,华进先进基板线具有FCBGA、嵌入式、UHDIE以及Coreless等工艺能力。
海思何洪文
华进王启东
Evatec报告
SPTS报告
存储封装
长电科技工程总监沈国强和华天科技技术市场总监刘卫东分别介绍了企业在存储封装领域的进展及布局。沈国强强调尽管受新冠疫情影响,2020年存储IC市场仍将突破1240亿美元。存储封装的特色是多芯片堆叠和混合封装,会面临很多挑战,如翘曲、剥落等。长电集团和国内外客户在NOR Flash、NAND Flash、DRAM、DDR4、EMMC/EMCP等领域有深入合作。刘卫东介绍了华天科技存储工艺路线图及产品线(3D NAND-SSD、eMMC/UFS、2D NAND、FC DDR等),与Micron、Intel、三星、铠侠、长江存储都有深入合作。

存储组装/测试趋势
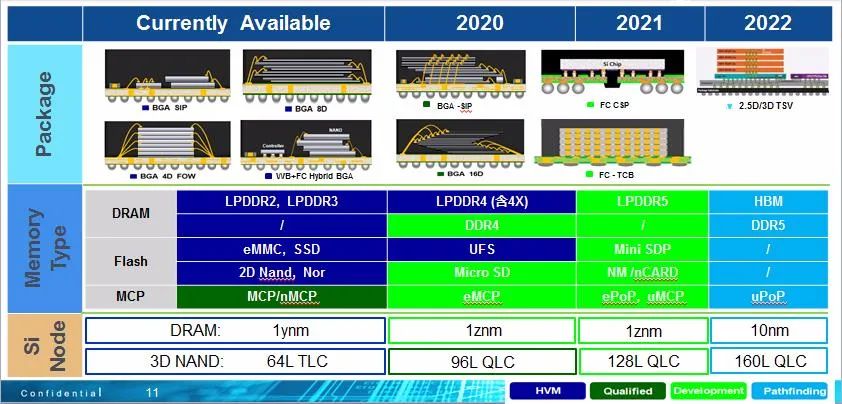
华天技术路线图
长电科技 沈国强
华天科技 刘卫东
高端封装及3D
随着5G、AI和数据中心的快速发展,高带宽、大容量和低功耗成为制约芯片性能的关键因素。晶圆级3D集成电路技术作为后摩尔时代的解决方案已经成熟,如晶圆键合、透硅通孔(TSV)和混合键合工艺。武汉新芯COO&高级副总裁孙鹏博士介绍了武汉新芯3DLinkTM生态体系,详细介绍了S-stacking——一种领先的高密度微节距3D互连技术,M-stacking——一种晶圆堆叠HBM方案,以及Hi-stacking——一种实现晶圆和 die 堆叠的解决方案。
EVG业务开拓总监Thomas Uhrmann分享了Die to Wafer混合键合方案。BESI CTO Ruurd Boomsma认为封装和后道技术在半导体价值链中愈发重要,混合键合技术无疑将成为下一代主流键合技术,但是需要更高的清洁度和精度;此外塑封技术也在复杂的SiP封装和晶圆级封装中体现优势。KNS高级经理王琼安和ASM Pacific Technology销售经理Percy Lam分别介绍了异质集成的挑战与解决方案。FormFactor CMO Amy Leong和Camtek COO Ramy Langer分别介绍了针对2.5D/3D异质集成量测和先进封装检查/计量的挑战与解决方案。
武汉新芯 孙鹏
ASM Percy Lam
BESI报告
KNS 王琼安
玻璃封装
Corning产品线经理Varun Singh分享了Corning的最新创新成果——实现机械拆解和的玻璃载片方案,还介绍晶圆减薄玻璃载片的优势。厦门云天CEO于大全博士分享了5G应用的3D WLP和集成技术进展,5G通讯的快速发展给先进封装提出了更高要求,晶圆级封装对于5G器件集成非常重要。晶圆级扇入技术可用于滤波器、IPDs和射频模块,晶圆级扇出可用于射频模块和毫米波芯片。近年来,采用玻璃穿孔(TGV)技术和嵌入式玻璃扇出(GFO)技术的玻璃圆片级封装越来越成熟,可用于IPD、mmWave、RF模块的三维集成。玻璃圆片封装具有体积小、成本低、工艺简单、电性能好等优点。针对各种5G应用的晶圆级系统集成技术开发仍有大量创新工作。会议最后,Yole首席分析师Santosh Kumar为大家做了针对半导体器件和先进封装应用的玻璃基板趋势的报告。
厦门云天 于大全
Corning报告
作为国家级封测/系统集成先导技术研发中心,华进肩负着促进国内外产学研合作,推动中国集成电路产业做大做强的使命。SYNAPS和华进开放日是全球独一无二的平台,更是业界企业和专家之间的独特纽带。经过多年积累,已成为行业认可的最专业的先进封装技术交流平台,获得好评无数。本次活动共吸引超百家半导体企业参会,接待了专业观众200余人(含在线观众),包括设计公司、OSAT、IDM、OEM、终端用户、设备及材料供应商等,相信未来将有更多的半导体追梦人们在此相遇相知,带着共同的信念为集成电路事业做出巨大贡献。
(华进战略部)
原文标题:SYNAPS 2020 &第七届华进开放日圆满落幕
文章出处:【微信公众号:华进半导体】欢迎添加关注!文章转载请注明出处。
责任编辑:haq
-
2015第七届亚洲(北京)国际智慧城市与物联网技术应用展览会2015-09-21 0
-
有奖征集——第七届“北斗杯”全国青少年科技创新大赛(中南区)2015-12-11 0
-
第七届蓝桥杯单片机个人赛题目2016-05-02 0
-
第七届蓝桥杯大赛嵌入式设计与开发项目模拟题2016-05-02 0
-
2017年第七届中国(杭州)国际新能源汽车产业展览会2017-06-30 0
-
2017第七届中国(杭州)国际新能源汽车产业展览会2017-07-07 0
-
第七届ARM联合大型技术讲座,线上直播火爆开启2018-05-29 0
-
2019年深圳第七届中国电子信息博览会2018-09-06 0
-
2019第七届中国(上海)国际机器视觉技术及工业应用展览会2018-10-13 0
-
中移物联网2020第七届中国IoT大会的演讲资料2020-12-10 0
-
是德2020第七届中国IoT大会AI技术运用方案资料2020-12-14 0
-
【精彩回顾】2020第七届中国IoT大会 演讲资料分享2020-12-14 0
-
蓝桥杯第七届省赛(单片机)_模拟风扇控制系统 精选资料分享2021-07-16 0
-
2019第七届汽车与环境创新论坛正式落幕2019-09-23 1192
全部0条评论

快来发表一下你的评论吧 !

