

GaN射频技术将如何发展
电子说
描述
以5G为代表的Sub 6G通信射频系统非常复杂,尤其是那些需要使用高载波频率和宽频带的新技术,包括载波聚合、Massive MIMO等。为此,很多半导体公司在技术上全面开花希望利用先进的半导体工艺技术应对甚至引领新一代的通信技术需求。以ADI为例,该公司全面拥有GaN、GaAs和SiGe以及28纳米CMOS等完整工艺,努力打造更具高集成度、低功耗和低成本的整合系统解决方案。
然而,在下一步的5G系统部署以及高端测试应用和卫星及航天应用中,无疑以高带宽和大功率为优势的GaN是其中的佼佼者,正在进入许多应用领域。那么,GaN射频技术将如何发展?
1.衬底技术以SiC为主,衬底外延向大尺寸、低缺陷方向提升
高质量的衬底和外延材料决定着器件的性能,而大尺寸的材料决定着器件的成本。未来5-10年,预计主流SiC、Si衬底将突破到6-8英寸。
(1) SiC衬底技术仍是主流,Si衬底有小部分应用
目前90%以上GaN射频器件采用高纯半绝缘SiC衬底技术,少部分采用Si衬底技术。
▲SiC/Si基GaN技术市场占有率预测
数据来源:Yole,CSA Research
SiC衬底的优势在于:散热性能好,可以满足大功率器件的散热要求、外延工艺较为成熟,外延片缺陷密度较低、供应链体系较为完善;但缺点在于衬底尺寸相对较小。SiC基GaN射频器件适用于受性能驱动较大的应用领域,其射频器件的优势在于优异的器件性能,能同时实现高频高增益,适用于性能驱动的领域,如国防、宏基站等。
Si衬底的优点在于:生长工艺成熟,可扩展的晶圆尺寸较大,衬底价格较便宜,且基于成熟大尺寸Si衬底加工和与CMOS工艺兼容的器件加工工艺,规模量产后可以实现低成本;但是缺点在于Si衬底与GaN外延层晶格适配较大,外延片存在较高缺陷密度,且由于Si衬底散热性能较差,主要适用于中小功率器件(因为通常情况下,工作频率越高,对器件的输出功率要求会降低,因而对散热要求也会同步降低)。因此Si基器件适用于受成本驱动较大以及对输出功率要求相对较低的应用领域,如无线回传以及小基站、射频能量(例如微波炉加热功能)、有线电视(CATV)、卫星通信系统(VSAT)等领域。
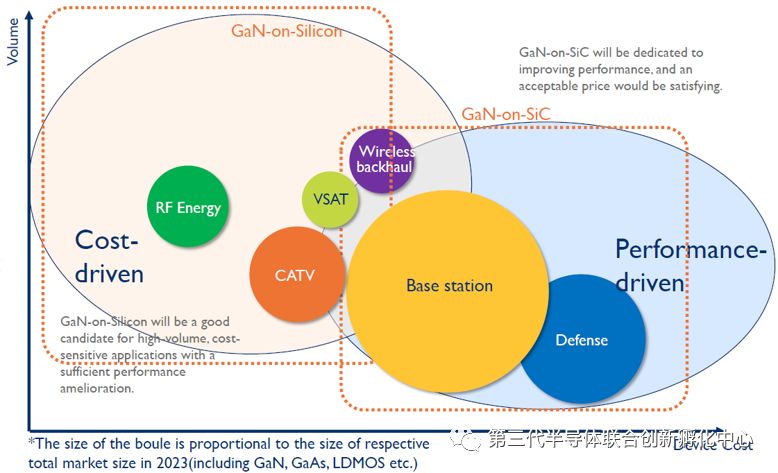
▲SiC基、Si基GaN技术适用领域对比
资料来源:Yole,CSA Research
(2) 衬底及外延材料向更大尺寸和更低缺陷发展
衬底和外延材料将继续沿着大尺寸、低缺陷、高均匀性生长方向发展。SiC基和Si基GaN异质外延片作为目前应用广泛的两种衬底材料,最大商用尺寸为6英寸。SiC衬底技术在从4英寸向6英寸过渡,为进一步降低器件成本,业界已经研发出8英寸SiC衬底。目前6英寸衬底的位错密度在100/cm2量级,随着单晶生长技术的发展,SiC衬底缺陷密度将快速下降,预计未来5年左右,穿透型螺位错和及平面位错密度将下降到200/cm2。Si基GaN外延片的技术研发在近几年尤其活跃,6英寸Si基GaN技术已经成熟,并且也成功研发出8英寸Si基GaN外延片,在不断降低缺陷密度、提升外延均匀性生长度的前提下,未来将逐步实现商用。2.器件与模块向高效率、高线性度和多功能集成整体而言,GaN射频器件将向着高效率、高线性度和多功能集成方向发展。GaN HEMT射频器件的制程在百纳米量级左右,且在不断微缩。现在GaN工艺尺寸正在从0.25µm至0.5µm向0.15µm转换,一些领导厂商(例如,Qorvo)甚至在尝试60nm。一般来说,大多数制造厂提供两个或三个标准工艺:0.5µm高压(40至50V)工艺主要处理频率低于约8GHz的高功率器件,0.25µm中压(28至40V)工艺处理更高频率的应用(高达约18GHz)。有的制造厂提供第三个选项,即更小的栅极长度(通常约0.15µm)用于毫米波应用(高达40GHz)。

▲主流厂商的GaN HEMT射频器件工艺制程节点
资料来源:Yole,CSA Research
(1) 高效率、高线性度
在性能指标方面,效率和线性度是GaN功率放大器的核心指标,高效率和高线性度的功率放大器是未来发展趋势。Doherty技术和包络跟踪技术可以有效地提高功放的平均效率和线性度,是目前国内外研究的热门功放效率和线性度提升技术。将这两种技术结合,可以使得功放更高效地放大高峰均比信号。在架构层面,Doherty和包络跟踪(ET)等将是主流结构。在现代通信系统中,Doherty已经获得广泛应用。Doherty功放通过与输入信号成反比地调整负载阻抗,从而实现高效率的放大。而ET功放通过动态调节偏置电压,使之随着信号包络而变化,从而使得功放一直工作于高效率情况下,且ET功放在提高效率的同时不受射频频率的限制。与Doherty功放仅在射频域上做处理不一样,ET功放还包含一部分基带信号的处理。典型的ET功放至少应包含包络调制器、包络成形、延迟对齐、射频放大链路。
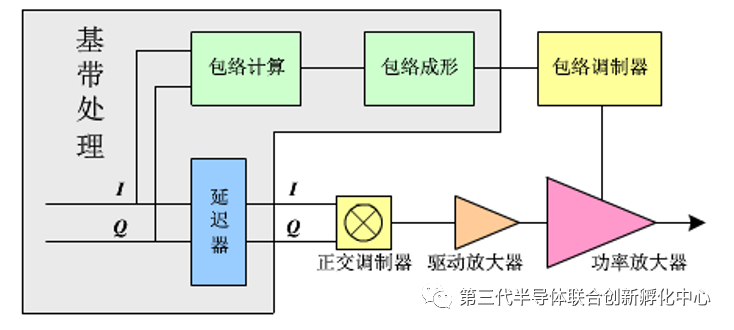
▲ET功放框架图
资料来源:网络资料,CSA Research
(2) 多功能集成
全GaN射频模块的集成是重要的发展趋势。除分立的功率模块外,GaN也已经应用于单片微波集成电路(MMIC)。MMIC是采用平面技术,将元器件、传输线、互连线直接制做在半导体基片上的功能块。单片微波集成电路包括多种功能电路,如低噪声放大器(LNA)、功率放大器(PA)、混频器、上变频器、检波器、调制器、压控振荡器(VCO)、移相器、开关、MMIC收发前端,甚至整个发射/接收(T/R)组件(收发系统)。目前国际上主流企业已经推出GaN MMIC PA和MMIC LNA等GaN射频集成模块,且正在研发集成多种功能的GaN MMIC射频前端(FEM)。
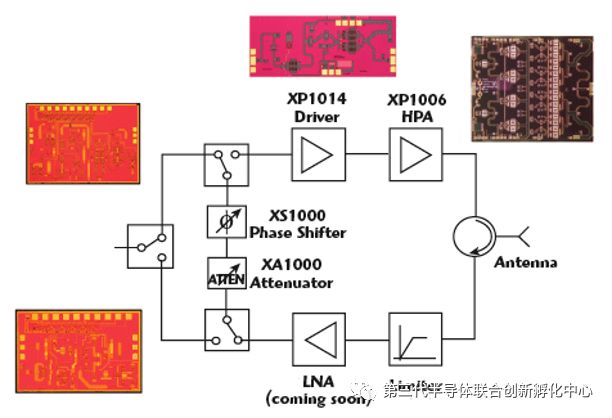
▲MMIC示意图
资料来源:网络资料,CSA Research
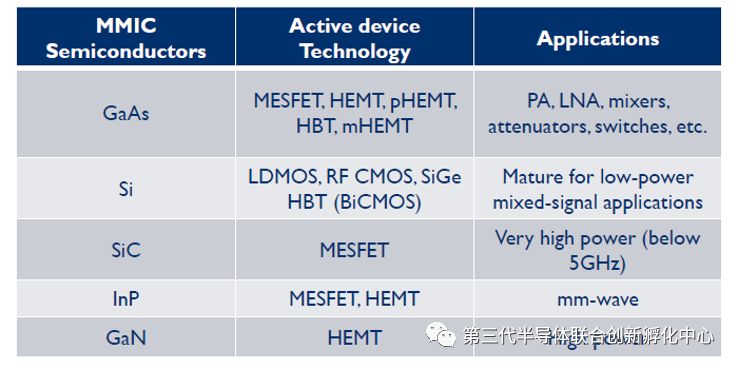
▲不同材料体系的MMIC的工艺及应用
资料来源:Yole,CSA Research
为了提升性能,减小器件尺寸,GaN射频芯片集成度将不断提高,并向多功能集成和天线集成方向发展。
1) 单一功能芯片集成
功率放大器、低噪声放大器等单一功能射频芯片将集成电阻、电容等被动元件。集成方式包括封装集成和单片集成。封装集成器件如多芯片组件功率放大器(MCM PA)。单片集成器件如单片微波集成电路功率放大器(MMIC PA)和单片微波集成电路低噪声放大器(MMIC LNA)等。
2) 收发一体多功能芯片集成
GaN射频芯片将由单一功能芯片向收发一体等多功能芯片发展,在射频前端模组(FEM)层面实现集成。其中MMIC FEM是重要的发展方向。MMIC FEM将在MMIC中集成功率放大器、低噪声放大器和射频开关等器件,在缩小系统体积的同时,使得系统功能更加强大和高效。
▲GaN毫米波MMIC FEM
资料来源:网络资料,CSA Research
3) 天线集成
GaN射频芯片与天线集成在一起将为系统级无线芯片提供一种良好的天线解决方案,正在受到芯片制造商的青睐。天线是无线系统中的重要部件,同其它射频器件一样,集成天线是未来发展趋势。集成天线包括片上天线(AoC)和封装天线(AiP)两种类型。AoC技术是单片集成技术,通过系统级芯片(SoC)方式实现。考虑到成本和性能,AoC技术更适用于太赫兹频段。而AiP技术是封装集成技术,通过系统级封装(SiP)方式实现。AiP技术很好地兼顾了天线性能、成本及体积,在毫米波频段获得了广泛应用。毋庸置疑,AiP技术也将会为5G毫米波移动通信系统提供很好的天线解决方案。3.配套封装材料及结构不断演进为了充分发挥GaN的高频高功率的器件优势,封装材料及结构在不断演进。GaN射频器件与模块的封装主要涉及基板、贴片材料和封装外壳三个部分。总的来看,目前GaN射频封装基板在转向纯铜,贴片材料正在逐步采用纳米银烧结,而封装外壳也开始采用塑料封装。
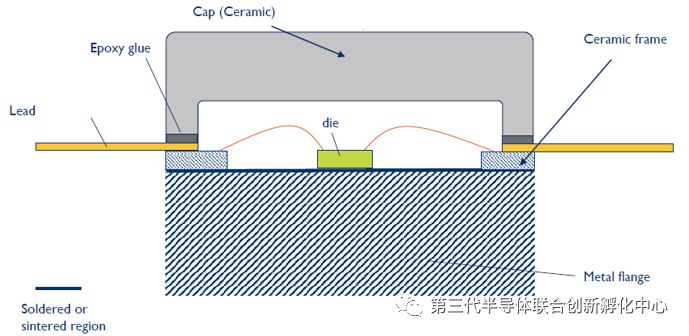
▲射频器件封装结构示意图
资料来源:Yole,CSA Research

▲GaN射频器件封装材料演进
资料来源:Yole,CSA Research
(1) 基板-向纯铜演进
目前,少数企业已经开始采用纯铜基板,但只限于中等功率的射频器件,而高功率的器件仍然采用铜合金或叠层材料。封装过程中基板主要起导热、机械支撑作用,部分器件还通过基板来导电。其中,最主要的作用是导热。封装基板通常采用高热导率的材料来减小器件产生的热量。同时,为了减少温度变化导致的应变,基板与贴片材料、器件之间的热膨胀系数(CTE)要尽量匹配。现阶段常用的基板材料是铜合金(铜钨CuW、铜钼CuMo)或叠层材料,而纯铜材料是未来的主流发展方向之一。CuW合金技术比较成熟,可靠性获得验证,但是成本比较高;CuMo叠层材料具备更高的热导率,更加适合高功率器件封装,并且采用了较少的贵金属,成本较低;纯铜具备比铜合金或叠层材料更高的热导率,并且没有使用贵金属从而降低了成本,而其他具备更高热导率的材料要比纯铜贵得多。然而,纯铜与Si或SiC的热膨胀系数差距较大,带来较大的技术挑战,可靠性有待验证。
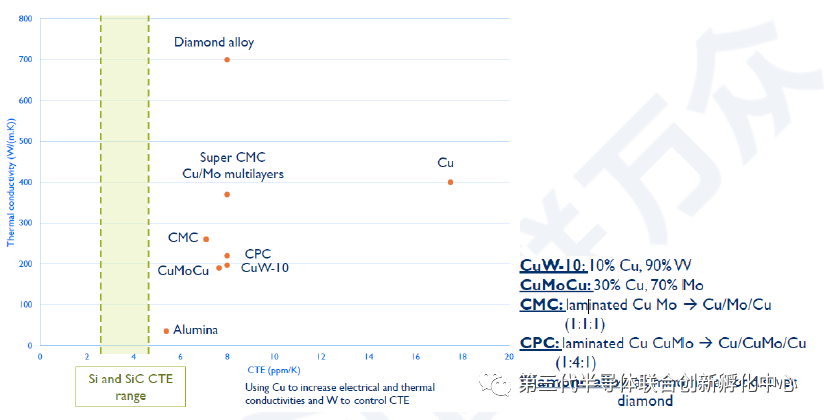
▲射频封装基板常用材料的热导率和热膨胀系数
资料来源:Yole,CSA Research
(2) 贴片材料-银烧结是未来的发展方向
在贴片材料方面,银烧结是未来的发展方向。目前,GaN射频器件主要使用的贴片材料包括AuSn(金锡)、AuSi(金硅)。AuSi只适用于Si基GaN器件的封装,对于SiC基GaN则不适用。得益于物理性能的匹配,AuSi非常适用于Si基器件的封装。然而,因为含有的Au成分比例较高,AuSi材料的成本较高。封装过程中,AuSi材料通常采用共晶焊接,加工温度较高(350-420℃),因而不能用于塑料基板的封装。目前,AuSn是使用最广泛的贴片材料。由于含有的Au的比例较低,AuSn的成本低于AuSi,并且AuSn既适用于SiC基器件也适用于Si基器件的封装。AuSn材料也采用共晶焊接技术,加工温度较高(270-320℃),同样不能用于塑料基板的封装。

▲GaN射频器件贴片材料
资料来源:Yole,CSA Research
银烧结是最新发展起来的一种封装贴片材料。银的成本要比金低得多。银的烧结过程有两种类型:加压或不加压。对于较小的芯片,通常采用纳米银粉末,且无需加压。而对于较大的芯片,通常采用微米银粉末,并且需要施加压力,确保键合牢固。银烧结的加工温度较低(200-280℃),加工时间短,适用于大多数封装基板材料。 ▼GaN射频封装贴片材料简介
| 贴片材料 | 成分 | 技术类型 | 加工温度 | 加工时长 | 适用领域 |
| AuSi | Au96.8-Si3.2 | 共晶焊接 | 350-420℃ | 30分钟以内 | 塑料基板除外 |
| AuSn | Au80-Sn20 | 共晶焊接 | 270-320℃ | 30分钟以内 | 塑料基板除外 |
| 银烧结 | 纳米银粉末 | 烧结 | 200-280℃ | 100秒左右 | 适用于多数情况 |
资料来源:Yole,CSA Research
(3) 封装外壳--塑料封装代替陶瓷封装
按照封装密封程度,可以分为气密性封装和非气密性封装。气密性封装可以有效隔绝湿气或有害气体,避免造成器件内部结构的腐蚀,增加产品使用寿命。金属、陶瓷和玻璃是常用的气密性封装外壳,而非气密性封装外壳通常采用聚合物材料,例如塑料。塑料外壳的优点在于可以降低成本,减轻器件重量,而且如果制作得当,仍然可以实现接近于密封的效果。

▲常用封装外壳材料
资料来源:Yole,CSA Research
业界正在转向采用塑料封装代替陶瓷封装。GaN封装最早开始采用的外壳是陶瓷外壳,它们被通常被做成非气密性封装的形式,因为通信应用中无需高度的气密性封装。现在,越来越多的企业开始采用塑料外壳封装。塑封的优势体现在:成本较低;可降低体积和重量,便于集成;具备成熟的制造标准;具有较低的介电常数,电磁信号损耗小,适用于高频应用;此外,塑料具备和纯铜接近的热膨胀系数,与陶瓷封装相比,塑封搭配纯铜基板可以显著改善热传导效果。其中,成本是最主要的影响因素。在大规模生产的情况下,芯片制造和封装构成最主要的成本,而检测占成本的比例较低。同时,采用塑料封装可显著降低成本。在规模量产的情况下,塑料封装的成本大约只有陶瓷封装的一半。
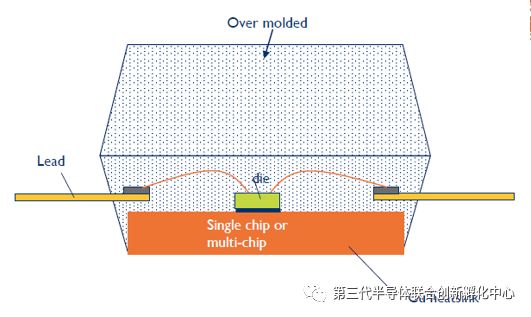
▲注塑封装示意图
资料来源:Yole,CSA Research
根据封装形式,GaN射频器件的封装分为多层封装(Multi-level package)和共平面封装(表面贴装)。依据经验,如果器件的耗散功率低于50W、PCB的厚度小于2mm,就可以采用表面贴装的封装形式。按是否填充材料,塑料封装分为注塑封装和空气腔(air cavity)封装。目前,采用多层封装和表面贴装的GaN射频器件均采用注塑封装。2017年,GaN射频器件采用注塑封装实现的最高频率达到3.2GHz(功率为100W)和6GHz(功率为5W)。 来源:第三代半导体联合创新孵化中心
责任编辑:xj
原文标题:GaN射频技术发展趋势
文章出处:【微信公众号:微波射频网】欢迎添加关注!文章转载请注明出处。
-
射频GaN技术正在走向主流应用2016-08-30 0
-
GaN是如何转换射频能量及其在烹饪中的应用【1】2017-04-05 0
-
GaN是如何转换射频能量及其在烹饪中的应用【4】2017-04-17 0
-
GaN是如何转换射频能量及其在烹饪中的应用【6】2017-05-01 0
-
TI助力GaN技术的推广应用2018-09-10 0
-
第三代半导体材料氮化镓/GaN 未来发展及技术应用2019-04-13 0
-
基于GaN的开关器件2019-06-21 0
-
物联网助力RFID产业发展2019-07-23 0
-
对于手机来说射频GaN技术还需解决哪些难题?2019-07-31 0
-
GaN是如何转换射频能量的?如何在烹饪中的应用的?2019-07-31 0
-
不同衬底风格的GaN之间有什么区别?2019-07-31 0
-
为什么GaN会在射频应用中脱颖而出?2019-08-01 0
-
手机射频技术和射频模块有什么关键元件?2019-08-12 0
-
手机射频技术有什么关键元件?2019-08-26 0
-
GaN射频应用优势明显,功率玩家厚积薄发2022-07-18 4143
全部0条评论

快来发表一下你的评论吧 !

