

 多晶硅薄膜后化学机械抛光的新型清洗解决方案
多晶硅薄膜后化学机械抛光的新型清洗解决方案
今日头条
描述
索引术语—清洗、化学机械抛光、乙二胺四乙酸、多晶硅、三氧化二氢。
摘要
本文为后化学机械抛光工艺开发了新型清洗液,在稀释的氢氧化铵(NH4OH+H2O)碱性水溶液中加入表面活性剂四甲基氢氧化铵(TMAH)和/或螯合剂乙二胺四乙酸(EDTA),以增强对金属和有机污染物的去除。从实验结果可以发现,化学机械抛光后的清洗显著提高了颗粒和金属的去除效率和电特性。
介绍
化学机械抛光(CMP)工艺已成为制造深亚微米集成电路的主流平面化技术。随着尺寸的缩小,CMP过程后对清洁表面的要求变得比以往任何时候都更加严格。有两个主要的问题。一个是粒子,另一个是晶片表面的金属杂质污染。刷洗涤技术已应用多年,被认为是CMP工艺后去除颗粒最有效的方法。在清洗溶液方面,去除颗粒的最有效的方法是使用稀释的氢氧化铵(NHOH+HO)碱性水溶液,这将导致晶片表面的蚀刻和电排斥力来去除颗粒。
本研究采用表面活性剂四甲基氢氧化铵(TMAH)提高颗粒去除效率,采用螯合剂乙二胺四乙酸(EDTA)减少金属杂质污染。我们发现,使用这种新溶液可以显著提高粒子、金属去除效率和电特性。
实验 略
结果和讨论
图中。1说明了硅表面在接触角测量中的润湿性。将一个300nm的低压化学气相沉积(LPCVD)掺杂的聚硅沉积在一个4000A的氧化物上,首先种植6英寸晶片。聚硅CMP实验在Westech372M抛光器上用稀释的cabotSC-1浆液进行。在CMP过程中去除A500a聚si。CMP工艺后,用巨晶片喷洒稀释的NHOH溶液,然后用PVA刷分配清洗溶液。
不同的清洗溶液为(A)稀释的29%NHOH,(B)29%NHOH+2.38%TMAH(与NHOH的体积比为1%)、(C)29%NHOH+EDTA(100ppm)和(D)29%NHOH+2.38%TMAH(1%)+EDTA(100ppm)。制备了聚氧化物电容器,以确定聚硅半氧化物处理工艺后的清洗效率。在接触角测量中,浸泡高频溶液去除天然氧化物后,将这些溶液滴在裸硅表面。粒子数由天科表面扫描4500系统计数。为了测量聚硅表面吸收的金属杂质浓度,将晶片浸入Fe(NO)浆液溶液中。全反射x射线荧光光谱(TXRF)提供了一个很好的测量金属杂质。利用惠普(HP)4145B半导体参数分析仪测量了J-E的多氧化物的电学性能和随时间变化的介电击穿(TDDB)特性。结果表明,溶液A具有疏水性(高接触角),溶液B具有亲水性(低接触角)。
原因是四烷基铵阳离子通过范德瓦尔斯力吸收在疏水硅氢表面。图中。2显示了cmp清洗后在聚硅表面留下的粒子数量。结果发现,溶液A的效率最低。溶液B和C均显著提高了颗粒去除效率。晶片的轻微表面蚀刻和晶片表面和颗粒之间的电排斥力可以增强颗粒的去除。
研究表明,疏水表面比亲水表面在晶片表面存在更多的颗粒。从接触角测量的结果来看,TMAH显然可以作为一种表面活性剂,可以将聚硅的表面性质从疏水转变为亲水性。另一方面,EDTA可以捕获来自koh碱浆液的钾离子,以降低溶液离子强度,增强粒子与晶片表面之间的电双层斥力。从这些数据来看,TMAH和EDTA似乎都发挥着粒子去除的重要作用。TMAH与EDTA联合使用的效果最好。图中。3为用TXRF测量到的金属杂质浓度。

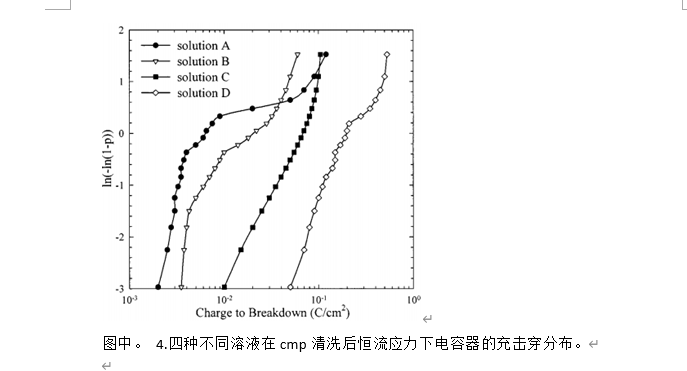
结论
在本文中,新的解决方案已经被证明用于cmp后的清洗。通过将NHOH+HO)碱性水溶液中加入稀释氢氧化剂(TMAH)和螯合剂(EDTA),显著提高了颗粒和金属杂质的去除效率,从而提高了电容器的电性能。
审核编辑:符乾江
-
新型铜互连方法—电化学机械抛光技术研究进展2009-10-06 0
-
《炬丰科技-半导体工艺》III-V/SOI 波导电路的化学机械抛光工艺开发2021-07-08 0
-
基于白光干涉测量的非接触光学测量方法评估化学机械抛光面2020-07-30 1448
-
化学机械抛光是一种广泛应用的高精度全局平面化技术2020-12-29 1588
-
化学机械抛光CMP技术的发展应用及存在问题2021-04-09 792
-
化学机械抛光(CMP)技术的发展、应用及存在问题2021-06-04 926
-
氮化镓晶片的化学机械抛光工艺综述2021-07-02 898
-
刷洗清洗过程中的颗粒去除机理—江苏华林科纳半导体2022-01-11 466
-
关于薄膜金刚石的化学机械抛光的研究报告2022-01-25 1810
-
CMP后化学机械抛光清洗中的纳米颗粒去除报告2022-01-27 683
-
化学机械抛光(CMP)的现状和未来2022-03-23 1301
-
半导体行业中的化学机械抛光(CMP)技术详解2023-08-02 9027
-
芯秦微获A+轮融资,用于化学机械抛光液产线建设2023-11-16 267
-
半导体行业中的化学机械抛光技术2024-01-12 432
-
碳化硅晶片的化学机械抛光技术研究2024-01-24 591
全部0条评论

快来发表一下你的评论吧 !

