

 CMP后化学机械抛光清洗中的纳米颗粒去除报告
CMP后化学机械抛光清洗中的纳米颗粒去除报告
今日头条
描述
摘要
我们华林科纳研究了化学机械抛光(CMP)工艺后颗粒在晶圆表面的粘附情况。嵌入的颗粒可以是浆中的磨料颗粒、垫材料中的碎片和被抛光的薄膜颗粒。为了找到最有效的颗粒去除机理,研究了不同的去除方法。在cmp清洗后,在溶液中加入表面活性剂。结果与不含表面活性剂的清洗进行比较,表明通过刷扫的机械相互作用和表面活性剂在溶液中的化学作用(即摩擦化学相互作用),清洗更有效。数值分析还预测了添加表面活性剂后的颗粒去除率。计算了晶圆-粒子界面中存在的范德华力,以找出去除粒子所需的能量。最后,通过将范德华力建模为粒子与表面分离距离的函数,研究了粘附过程。弹性理论对纳米颗粒-表面相互作用的成功适应,揭示了CMP的清洗机制。该模型告诉我们,随着分离距离的减小,引力并不总是会增加。估计的力值可用于浆料设计和CMP工艺估计。
介绍
化学机械抛光最初用于玻璃和硅片抛光。随着其功能的增加,化学机械抛光被引入到平面化层间电介质(ILD)、浅沟槽隔离(STI)和用于片上多级互连的镶嵌金属布线中。该工艺适用于半导体加工中的铜、钨和低介电常数介质。化学机械抛光的目标是实现粗糙表面的平面化。在化学机械抛光过程中,晶片被倒置在载体中,并被压入与流过浆液饱和抛光垫的浆液膜接触。晶片表面通过机械磨损和化学腐蚀进行抛光,以实现局部和整体平面化。这一过程对于制备光滑的表面层至关重要,以便后续过程可以从平坦的表面开始。
本研究的主要目的是研究化学机械抛光后清洗中的颗粒去除机理。本研究采用了三种方法。首先是用刷扫法进行清洗,然后在清洗液中加入化学药品和添加剂,最后通过数值模拟来预测附着力范围和偏转表面。
化学机械抛光后清洗中纳米粒子的去除机理
介绍:化学机械抛光的主要问题是残留颗粒含量高。根据化学机械抛光的类型和抛光条件,由于抛光垫施加的机械压力,这些颗粒可以物理吸附在表面或部分嵌入衬底中。由于范德华力在粘合过程中更占主导地位,因此必须通过刷子刷洗的机械力或使用化学溶液或添加剂来克服它。在微粒的情况下,机械力是不够的。因此,必须添加化学物质或添加剂来控制静电排斥,以防止颗粒重新粘附。这可以通过控制基底和颗粒上的电荷来实现,这可以通过改变溶液的酸碱度或添加表面活性剂来改变。
实验:刷子用作上盘,晶片用作下盘。本研究使用聚乙烯醇刷子。为这个实验准备了两种清洗溶液。在第一种溶液中,使用10毫升去离子水作为清洗溶液。第二种溶液是通过混合10毫升去离子水和0.1重量%含醇醚硫酸盐的阴离子表面活性剂制成的。在数据采集之前,将直径为5毫米的刷子浸泡在去离子水中30分钟。清洁实验在室温下进行,参数如下:刷子压力为125帕,速度为0.5厘米/秒。刷子在晶片上的七个位置往复运动。清洗过程后,用去离子水在超声波清洗机中清洗样品1分钟,以防止颗粒再沉积到基底上。
结果和讨论:用连续力学方法进一步分析了实验结果。结果如图14所示.从该图中可以推断,去除颗粒所需的力随着颗粒尺寸而变化。在达到一定尺寸后,机械移除的效果会显著降低。在这个阶段之后,使用表面活性剂将有助于减少去除较小颗粒所需的力。
结论:这项研究为理解表面活性剂分子在化学机械抛光后清洗中的作用开辟了未来的研究领域。在这方面,我们将观察表面活性剂在达到临界胶束浓度(CMC)前后的行为。将讨论表面活性剂浓度和温度范围内的摩擦学方法。
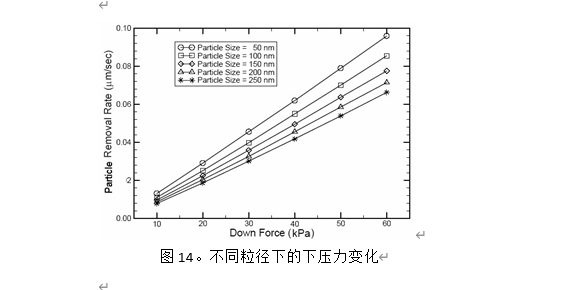
表面活性剂分子在化学机械抛光后清洗中的作用
介绍:化学机械抛光后清洗过去是用去离子水冲洗以去除浆料颗粒的简单过程。然而,它们现在必须加入额外的化学物质或添加剂以有效去除颗粒。有效的后化学机械抛光清洗溶液的最新发展有助于减少冲洗水的消耗。因此,表面活性剂和去离子水的使用将有助于降低耗材成本。
实验:清洁实验在室温下进行,参数如下:刷子压力为125帕,速度为0.5厘米/秒。刷子在晶片的三个位置往复运动。清洗过程后,用去离子水在超声波清洗机中清洗样品1分钟,以防止颗粒再沉积到基底上。
结果和讨论:图18和19显示了在化学机械抛光后清洗过程中,表面活性剂浓度和温度对摩擦系数的影响。结果表明,随着表面活性剂浓度和温度的增加,平均摩擦系数降低。这种现象可以解释如下。因为在高温下,表面活性剂将比在低温下花费更少的时间均匀分散到基底表面,这又降低了表面张力。较低的表面张力会产生较低的润湿角。此外,较低的润湿角产生较高的润湿,从而降低基底表面上的平均摩擦系数。在这种情况下,该过程有助于在刷扫过程中去除颗粒。另一个原因是硅片在清洗过程中容易发生放热反应;因此,界面温度的升高会降低基底表面的平均摩擦系数。
结论:在这项研究中,我们使用了一种新的方法来研究后化学机械抛光清洗过程中的颗粒去除机制。该方法从抛光实验开始,以便将颗粒粘附在晶片表面上。化学环境是专门为此而设计的。抛光后,进行清洗实验以研究颗粒去除机理。还特别考虑了表面活性剂的选择。结果表明,表面活性剂分子可以降低颗粒间的粘附力。对于较大的颗粒,用较高浓度的表面活性剂和较高的操作温度进行清洗被证明能有效地减小粘附在基底表面上的残余颗粒的尺寸。其机理主要是界面相互作用。

结论
颗粒与晶片表面的粘附是化学机械抛光工艺中的主要问题之一。使用实验的化学机械抛光和化学机械抛光后清洗过程中的机理与数值分析相结合,粘附过程由颗粒和表面附近存在的范德华力控制。
结果表明,虽然表面活性剂分子可以减少颗粒之间的粘附,但机械去除仅对一定尺寸的大颗粒有效。对于较大的颗粒,用较高浓度的表面活性剂和较高的操作温度进行清洗被证明能有效地减小粘附在基底表面上的残余颗粒的尺寸。一旦颗粒尺寸达到临界尺寸,剩余的小颗粒将不能被有效去除。
对于剩余的小颗粒,加入表面活性剂可以有效去除颗粒。表面活性剂有两个基本作用。一是削弱粒子与粒子和表面之间的结合。另一个是防止颗粒和晶片表面之间的进一步粘附。其机理主要是界面相互作用。此外,利用弹性理论,我们能够分析表面中点处的垂直位移。范德瓦尔斯力被评估为分离距离的函数。我们发现,当距离达到临界值ALPHA时,范德华力将不再吸引。这一结果由误差%的稳定图和70到80范围内的ALPHA试验次数显示。
审核编辑:符乾江
-
新型铜互连方法—电化学机械抛光技术研究进展2009-10-06 0
-
《炬丰科技-半导体工艺》III-V/SOI 波导电路的化学机械抛光工艺开发2021-07-08 0
-
化学机械抛光(CMP) 技术的发展应用及存在问题2023-09-19 0
-
化学机械抛光是一种广泛应用的高精度全局平面化技术2020-12-29 1588
-
化学机械抛光CMP技术的发展应用及存在问题2021-04-09 792
-
化学机械抛光(CMP)技术的发展、应用及存在问题2021-06-04 926
-
氮化镓晶片的化学机械抛光工艺综述2021-07-02 898
-
刷洗清洗过程中的颗粒去除机理—江苏华林科纳半导体2022-01-11 466
-
多晶硅薄膜后化学机械抛光的新型清洗解决方案2022-01-26 600
-
化学机械抛光(CMP)的现状和未来2022-03-23 1301
-
采用化学机械抛光(CMP)工艺去除机理2022-03-23 1691
-
芯秦微获A+轮融资,用于化学机械抛光液产线建设2023-11-16 267
-
CMP抛光垫有哪些重要指标?2023-12-05 548
-
半导体行业中的化学机械抛光技术2024-01-12 433
-
碳化硅晶片的化学机械抛光技术研究2024-01-24 592
全部0条评论

快来发表一下你的评论吧 !

