

稀释HF清洗过程中硅表面颗粒沉积的机理报告
今日头条
描述
摘要
本文讨论了稀氢氟酸清洗过程中颗粒沉积在硅片表面的机理。使用原子力显微镜的直接表面力测量表明,硅表面上的颗粒再沉积是由于颗粒和晶片表面之间的主要相互作用。表面活性剂的加入可以通过改变颗粒和晶片之间的表面相互作用力来影响稀氟化氢溶液的清洁效果。我们表明,颗粒沉积与晶片和颗粒的ζ电势的乘积之间存在简单的相关性。这种相关性可以通过在双电层相互作用的推导中引入线性叠加近似来解释。表面活性剂的加入也将降低分散吸引力,引入空间排斥,并消除粘附力,如表面力测量结果所示。
介绍
随着半导体工业向越来越小的尺寸发展,去除颗粒污染物变得极其重要。因此,硅片超净是半导体加工的一个重要领域。最广泛使用的清洗方法是基于RCA的湿化学清洗,可去除晶片表面的有机残留物、颗粒和金属离子。经RCA清洗的晶片表面有一层约1-2纳米厚的化学氧化层。使用稀释的HF清洗来去除该层,并获得氢钝化的裸露硅表面,该表面具有高的抗氧化稳定性和低密度的表面状态。然而,在HF清洗期间,浴中的颗粒倾向于再沉积到裸露的硅表面上。
实验
所有的实验都在室温下进行。每个实验的0.5% HF溶液都是从电子级49% HF溶液新鲜制备的。在这些实验中,氮化硅颗粒被选为模型颗粒。颗粒沉积实验如下进行;硅片在浸入含200 ppm氮化硅颗粒的0.5 wt % HF溶液前,先在SC-1溶液中清洗~Alfa Aesar。平均直径为0.3毫米,表面活性剂含量为1重量%,持续10分钟。在稀氢氟酸溶液中分别加入不同的阳离子、阴离子、两性或非离子表面活性剂来改变表面电荷。在水洗和氮气吹干后,使用Jeol 6400扫描电子显微镜对晶片进行分析。从照片中统计表面颗粒。表面活性剂效率定义为并且小于零的值表示与没有添加表面活性剂的情况相比颗粒沉积增加。
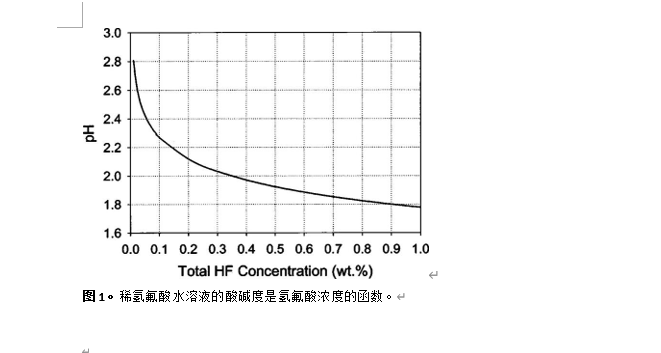
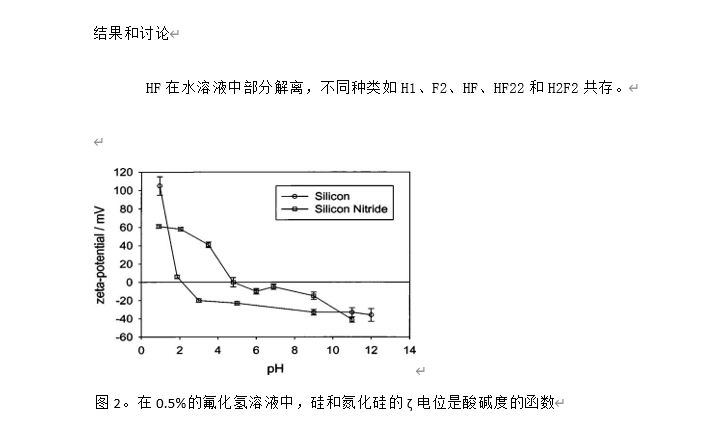


结论
已经进行了直接力测量,以了解在DHF清洗期间硅表面上的粒子污染。在0.5%的氟化氢溶液中,酸碱度约为1.9,硅表面略有正电荷。由于硅表面和颗粒之间的大范德华相互作用,裸露硅表面上的颗粒沉积非常普遍。表面活性剂可用于减少DHF清洁中的颗粒沉积。表面活性剂的效率与其增加硅和粒子ζ电势乘积的能力相关。在计算硅和粒子之间的电相互作用时,可以用线性叠加近似来理解这种相关性。表面活性剂可以减少分散相互作用,并在硅表面之间引入空间排斥和粒子表面。一些表面活性剂的加入也可以消除颗粒和硅表面之间的粘附力,促进颗粒从硅晶片上去除。
审核编辑:汤梓红
-
如何规避等离子清洗过程中造成的金属离子析出问题?2021-06-08 0
-
芯片清洗过程中,颗粒洗不掉2021-10-22 0
-
刷洗清洗过程中的颗粒去除机理—江苏华林科纳半导体2022-01-11 478
-
关于刷洗清洗过程中的颗粒去除机理的研究报告2022-01-18 473
-
PVA刷擦洗对CMP后清洗过程的影响报告2022-01-26 454
-
湿法清洗过程中硅片表面颗粒的去除2022-02-17 2247
-
湿法清洗系统对晶片表面颗粒污染的影响2022-03-02 562
-
半导体制造过程中的硅晶片清洗工艺2022-04-01 3112
-
湿式化学清洗过程对硅晶片表面微粒度的影响2022-04-14 499
-
PVA刷接触式清洗过程中超细颗粒清洗现象2022-04-15 543
-
稀释SC1过程中使用兆声波来增强颗粒去除效率2022-05-18 641
-
晶片表面沉积氮化硅颗粒的沉积技术2022-05-25 1306
-
湿法清洗过程中的颗粒沉积和去除研究2022-06-01 6950
-
湿法清洗中去除硅片表面的颗粒2022-07-05 1790
-
湿清洗过程中硅晶片表面颗粒去除2023-03-30 2002
全部0条评论

快来发表一下你的评论吧 !

