

湿法清洗过程中硅片表面颗粒的去除
电子说
1.2w人已加入
描述
摘要
研究了在半导体制造过程中使用的酸和碱溶液从硅片表面去除粒子。 结果表明,碱性溶液的颗粒去除效率优于酸性溶液。 在碱性溶液中,颗粒去除的机理已被证实如下:溶液腐蚀晶圆表面以剥离颗粒,然后颗粒被电排斥到晶圆表面。 实验结果表明,需要0.25 nm /min以上的刻蚀速率才能使吸附在晶圆表面的颗粒脱落。
介绍
由于半导体器件正在追求更高水平的集成度和更高分辨率的模式,ET清洁技术对于重新移动硅片表面的污染物仍然至关重要。 在1970年提出的RCA清洗工艺作为一种湿式清洗技术在世界各地仍在使用,以去除晶圆表面的污染物。 虽然RCA净化过程中,NH4OH-H2O2-H2O溶液对颗粒的去除效果非常好,但其颗粒去除机理尚不完全清楚。
实验
采用五英寸CZ(1,0,0)晶片进行粒子吸附实验。 天然氧化物首先在0.5%的HF溶液中从晶圆表面去除。 然后将晶片浸泡在含有颗粒的各种溶液中10分钟,然后冲洗和干燥。 天然氧化物在晶圆表面形成后,再在0.5%的HF溶液中移动,然后清洗和干燥。
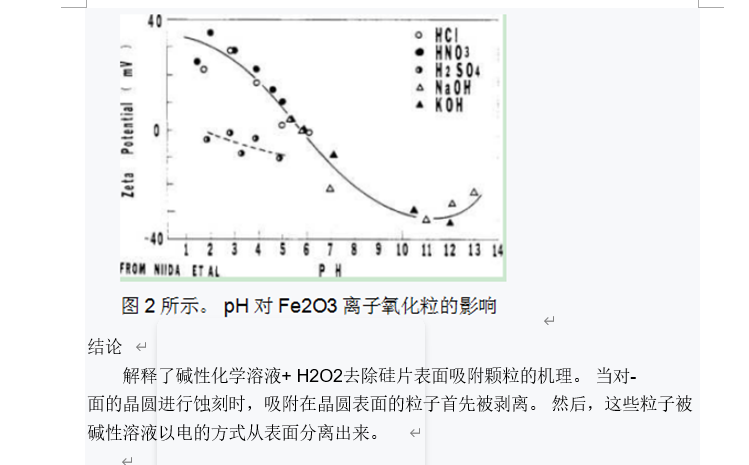
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
硅片湿法清洗设备设备出售2015-04-02 0
-
如何规避等离子清洗过程中造成的金属离子析出问题?2021-06-08 0
-
《炬丰科技-半导体工艺》DI-O3水在晶圆表面制备中的应用2021-07-06 0
-
芯片清洗过程中,颗粒洗不掉2021-10-22 0
-
关于刷洗清洗过程中的颗粒去除机理的研究报告2022-01-18 461
-
稀释HF清洗过程中硅表面颗粒沉积的机理报告2022-02-11 1519
-
湿法清洗系统对晶片表面颗粒污染的影响2022-03-02 545
-
兆声清洗晶片过程中去除力的分析2022-03-15 480
-
湿法清洗过程中晶片旋转速度的影响2022-04-08 606
-
湿法和颗粒去除工艺的简要概述2022-04-08 1257
-
湿法和颗粒去除工艺详解2022-04-11 557
-
PVA刷接触式清洗过程中超细颗粒清洗现象2022-04-15 531
-
湿法清洗过程中的颗粒沉积和去除研究2022-06-01 6936
-
湿法清洗中去除硅片表面的颗粒2022-07-05 1760
-
湿清洗过程中硅晶片表面颗粒去除2023-03-30 1981
全部0条评论

快来发表一下你的评论吧 !

