

单晶圆旋转清洗工艺详解
电子说
描述
摘要
从热力学和传输的角度研究了从半导体晶片上的纳米级特征中去除液体。热力学模型考虑特征中液体的各种圆柱对称状态并计算它们的自由能。开发了一个相图,以显示在给定特征的纵横比、液体所占的体积分数和内部接触角的情况下,圆柱特征中哪种液体配置最稳定。从特征中去除液体所需的能量是根据这些参数以及特征外部晶片表面上的接触角来计算的。传输模型用于通过考虑液体蒸发动力学和气相传输来估计干燥时间。干燥由液体的蒸发速率控制。
介绍
半导体晶片在转变为功能性微电路时经历了许多微制造步骤。特别是晶片清洗在器件制造过程中会发生很多次。为确保质量和可靠性,理想的晶圆清洁工艺应去除掩蔽和等离子蚀刻后残留的任何残留物。目前有三种主要的湿法清洁技术:湿台清洁系统、批量喷雾清洁系统和单晶片旋转清洁系统。1 与前两种技术不同,单晶片旋转清洗系统一次处理一个晶片,2——4 在每个晶片的基础上提供更均匀的清洁。使用连续的单晶片清洗方法,工艺混乱只会影响一个晶片,而不是整个多晶片盒。因此,相对于平行清洗方法,单晶片旋转清洗实际上提高了整体工艺效率。
具有更大功能和更低功率需求的微电路的生产需要越来越精细的电路图案。对于最先进节点上的功能,关键尺寸目前低于 32 nm,可以小至 14 nm。5,6 单晶圆旋转清洗已成为应用于这些尺寸特征的主要方法。数字1 提供了单晶片旋转清洁工具的示意图。晶圆被放置在一个可以围绕其中心轴旋转晶圆的盘子上;两个喷嘴——一个分配液体,另一个分配 N2 气体——位于晶片上方。清洁过程包括润湿和干燥步骤。在润湿步骤中,液体从液体喷嘴喷出,而盘片以相对较低的速度 (100-300 RPM) 旋转。在让液体流入晶片上的特征一段时间后,通过中断液体喷射、从另一个喷嘴将 N2 吹到晶片上并增加转速(至 1000-2000 RPM)来进行干燥。
热力学模型
在典型的小表面特征的亚微米长度尺度上,液体表面张力开始在应力和能量分析中发挥重要作用。毛细管长度,κ−1,7 通过将拉普拉斯压力的尺度与重力和静水力引起的压力 的尺度相等来估计。
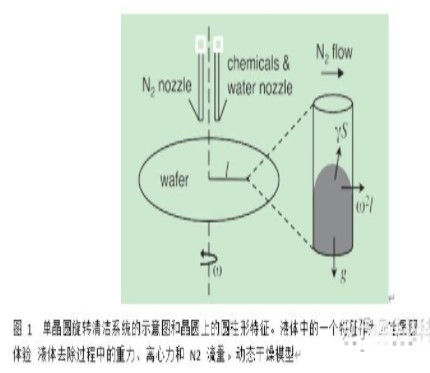
上面的热力学模型假设在蒸发和随后的气相传输过程中不会发生液体损失。动态模型有助于估计通过相变和传输过程干燥特征所需的时间。为了建立一个简单的定性模型,我们采用简化假设,即液体去除仅通过蒸发和扩散发生,并进一步假设气相表现理想。对于这个基线分析,我们还忽略了液体/蒸汽界面的曲率,以促进一维传输模型的应用。数字8a 显示 假设的干燥机制,包括液体蒸发、特征中的蒸汽扩散以及特征外的蒸汽扩散或对流。
结论
已经开发了热力学模型和动态模型来研究半导体晶圆旋转清洗过程中的液体去除过程。热力学模型计算不同状态的能量,其中液体可能存在于圆柱特征的内部和外部。能量包括表面张力和拉普拉斯压力的贡献。总共分析了七种可能的液体状态(定义在图2 作为状态 I-VII),包括五个内部状态,
允许给定的特征深度、液滴体积和接触角。详细的能量分析允许计算相图,并指出在可能的情况下,状态 III 或 IV 的能量总是最低的;否则状态 I 主要占据相图。在了解内部和外部平衡状态的情况下,将去除液滴所需的能量作为液体体积分数 φ 以及特征内部和顶部液体的接触角的函数进行研究。晶圆。对于状态 I 和 II,可以自发去除液体。状态 III 的液体总是需要能量输入才能移除,因为状态 III 类似于外部状态 (VI),但总是获得较小的接触角。
审核编辑:汤梓红
-
激光用于晶圆划片的技术与工艺2010-01-13 0
-
n型单晶硅退火工艺2011-03-01 0
-
半导体及光伏太阳能领域湿法清洗2011-04-13 0
-
单片机晶圆制造工艺及设备详解2018-10-15 0
-
晶圆制造工艺的流程是什么样的?2019-09-17 0
-
PCBA的清洗工艺介绍2021-02-05 0
-
PCBA溶剂的清洗工艺2021-02-05 0
-
单晶的晶圆制造步骤是什么?2021-06-08 0
-
什么晶圆?如何制造单晶的晶圆?2021-06-08 0
-
晶圆制造工艺详解2011-11-24 6373
-
目前光罩清洗机中使用的几种主要的清洗工艺介绍2020-12-29 3542
-
半导体单晶抛光片清洗工艺分析2021-04-08 1238
-
单晶片超音波清洗机的声学特性分析2021-12-20 823
-
湿清洗后晶圆旋转速度对金属线的影响2022-03-16 990
-
细说单晶硅太阳能电池的清洗制绒2023-08-19 1114
全部0条评论

快来发表一下你的评论吧 !

