

 单晶硅片碱性溶液中的蚀刻速率
单晶硅片碱性溶液中的蚀刻速率
今日头条
描述
本文研究了用金刚石线锯切和标准浆料锯切制成的180微米厚5英寸半宽直拉单晶硅片与蚀刻时间的关系,目的是确定FAS晶片损伤蚀刻期间蚀刻速率降低的根本原因,无论是与表面结构相关,缺陷相关,由于表面存在的氧化层,还是由于有机残差。
通过采用研磨和离子研磨的方法制备了横截面透射电镜样品,反射率测量是使用基于光纤,光学排列进行的,利用日立S-4800扫描电子显微镜(SEM)、200keVJEOL2010F透射电子显微镜(TEM)和表面成像系统公司的原子力显微镜(AFM)对其表面结构进行了研究。

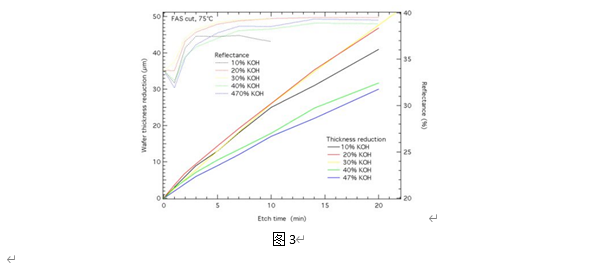
通过比较浆料切割晶片和FAS切割晶片的厚度减少情况,FAS切割晶片在初始时间为5-10分钟内的蚀刻率较低,这在另外图中得到了阐明,其中绘制了当氢氧化钾浓度分别为30%和47%时,浆液和FAS切割晶片的厚度减少图,对于超过大约10分钟的蚀刻时间,这两种类型的晶片的蚀刻速率是相同的。
在浆液切面的横截面上显示了一层非晶Si(a-Si),典型厚度为20-40纳米,在非晶态层的下面,可以观察到一个300-600纳米厚的缺陷区域;大多数缺陷位于表面800纳米的层中,但也有一些位于2000纳米的深度。通过比较切割浆料和切割FAS晶片的表面结构截面,FAS切割晶片的非晶层和缺陷层平均厚2-3倍,根据在蚀刻过程中初始阶段测量的蚀刻速率,TEM观察到的非晶硅层在前2-5秒内被蚀刻掉,因此不是在初始阶段蚀刻速率降低的原因。
在进行预清洗过程时,蚀刻速率变化不大,说明表面没有氧化硅掩蔽层或有机残留物层,透射电镜调查也证实了这一发现。
最后通过FAS和标准浆料晶片的碱性溶液中的蚀刻速率随时间、温度和不同的预清洗过程的变化,结果显示,氢氧化钾浓度的最大蚀刻率在20-30wt%左右,在初始5-10分钟的蚀刻过程中,FAS晶片的蚀刻率低于浆状晶片,这取决于氢氧化钾的浓度和温度;为了表征晶片表面,我们使用了扫描电子显微镜(SEM)、透射电子显微镜(TEM)、原子力显微镜(AFM)以及反射率测量,通过比较切割浆料和切割FAS晶片的表面结构横截面,观察到非晶硅层和缺陷层,但得出结论,不限制初始较高的蚀刻速率。
审核编辑:汤梓红
-
太阳能电池片、IC级硅片,太阳能电池片、单晶硅片2010-10-31 0
-
厂家求购废硅片、碎硅片、废晶圆、IC蓝膜片、头尾料 大量收购单晶硅~多晶硅各种废硅2010-10-31 0
-
厂家求购废硅片、碎硅片、废晶圆、IC蓝膜片、头尾料 ***大量收购单晶硅~多2010-10-31 0
-
PCB制作工艺中的碱性氯化铜蚀刻液-华强pcb2018-02-09 0
-
凤凰光伏即将推出新一代G6准单晶硅片2012-05-21 1006
-
简单了解单晶硅片基本的加工过程2019-03-06 23557
-
隆基发布单晶硅片价格公示 166单晶硅片迎11个月以来首次降价2020-03-26 1629
-
隆基两款硅片价格下调均超10% 或为未来单晶硅片价格战做准备2020-04-18 848
-
自8月初以来,单晶硅片价格维持三个月平稳状态2020-10-27 1755
-
硅碱性蚀刻中的绝对蚀刻速率2022-03-04 900
-
详解单晶硅的各向异性蚀刻特性2022-03-25 2628
-
单晶硅片与蚀刻时间的关系研究2022-04-18 436
-
碱性刻蚀表面形貌对p型单晶硅片少数寿命的影响2022-04-24 472
-
单晶硅的各向异性蚀刻特性说明2022-05-05 2761
-
M111N蚀刻速率,在碱性溶液中蚀刻硅2022-05-20 921
全部0条评论

快来发表一下你的评论吧 !

