

 新型全化学晶片清洗技术详解
新型全化学晶片清洗技术详解
今日头条
描述
本文介绍了新兴的全化学晶片清洗技术,研究它们提供更低的水和化学消耗的能力,提供了每种技术的工艺应用、清洁机制、工艺效益和考虑因素、环境、安全和健康(ESH)效益和考虑因素、技术状态和供应商信息的可用信息。
将晶片暴露于少量(约1克)无水三氧化硫气体中,然后自动转移到一个单独的室中,在那里用去离子水冲洗并甩干(见图1),三氧化硫室的条件要求温度通常低于100°C,且环境干燥,光致抗蚀剂在暴露于三氧化硫期间没有被去除,而是被化学改性,一旦磺化,抗蚀剂可溶于水,并在去离子水冲洗过程中被去除,该工具目前是单晶片单元,但可以扩展到批处理工具配置。
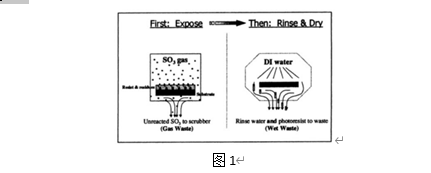
三氧化硫技术将两个清洗步骤/工具合二为一,取代了灰化器和用于灰化后残留物清洗的湿工作台,一种工具的好处包括在大多数剥离应用中完全消除了等离子体,剥离离子注入光刻胶后减少了污染,减少了占地面积,降低了维护,减少了周期时间,并降低了成本。工艺开发的重点是可以集成到集群工具中的单晶片旋转处理器,晶片被安装在晶片旋转器的卡盘上,并被加速到预定的转速(1000到4000转/分),蚀刻化学物质被分配到旋转晶片的表面上大约1-3分钟,工艺温度为45至55℃,过程pH值接近中性,所以旋转蚀刻循环之后是短暂的去离子水旋转冲洗和旋干循环。
在下午0点35分和0点18分为150毫米晶圆准备了150毫米晶圆的氧化后蚀刻和金属蚀刻后测试结构,一组四个测试结构是在臭氧水清洗过程之前的氧等离子体棚,清洁前没有按压其他器械包,用HP 拍摄的截面扫描电子显微镜(SEM)照片提供了对新工艺清洁和腐蚀性能的初步评估,根据电子显微镜检查,在某种测试结构中没有金属腐蚀的迹象,过程温度低,接近中性酸盐,金属腐蚀可能性降低。
本文通过回顾新清洗的挑战和工艺标准,并对一些新兴的清洗技术进行了评述,必须找到具有成本效益的清洁技术,快速、安全、彻底地清除所有污染物,不会对金属、低k或高k材料造成损坏,并且会使用更少的水和化学物质。
审核编辑:汤梓红
-
详解Edmund光学元件的清洗技术2017-10-08 641
-
半导体晶圆清洗站多化学品供应系统的讨论2022-02-22 1750
-
清洗半导体晶片的方法说明2022-02-28 971
-
湿法清洗系统对晶片表面颗粒污染的影响2022-03-02 559
-
半导体工艺—晶片清洗工艺评估2022-03-04 2639
-
晶片清洗及其对后续纹理过程的影响2022-03-15 352
-
湿式化学清洗过程对硅晶片表面微粒度的影响2022-04-14 492
-
一种用湿式均匀清洗半导体晶片的方法2022-04-14 644
-
一种新型的全化学晶片清洗技术2022-04-21 274
-
用于光刻胶去除的单晶片清洗技术2022-05-07 686
-
溢流晶片清洗工艺中的流场概述2022-06-06 1089
-
使用脉动流清洗毯式和图案化晶片的工艺研究2022-06-07 317
-
不同的湿法晶片清洗技术方法2022-07-07 1651
-
硅晶片的清洗技术2022-07-11 1098
-
臭氧清洗系统的制备及其在硅晶片清洗中的应用2023-06-02 1150
全部0条评论

快来发表一下你的评论吧 !

