

硅在氢氧化钾水溶液中的刻蚀机理
今日头条
描述
本文根据测量的OCP和平带电压,构建了氢氧化钾水溶液中n-St的定量能带图,建立了同一电解质中p-St的能带图,进行了输入电压特性的测量来验证这些能带图,硅在阳极偏置下的钝化作用归因于氧化物膜的形成,氧化产物的氧化速率和扩散速率之间的竞争决定了阳极氧化是蚀刻过程还是钝化过程。研究了重掺杂硅的蚀停止,原因是高载流子浓度下氧化膜的生长速率提高。
采用(I00)方向的商业n和pSt。n-St的电阻率为6~i~-cm,p-St的电阻率为15~20~-cm。这些样品在沸腾的三氯乙烷、丙酮和甲醇中依次脱脂,用去离子水冲洗后,将样品浸入HF/H20溶液中,以去除天然的氧化物,将共铜合金粘贴在样品和铜板之间,为电化学测量提供良好的接触,将样品和铜板固定在聚四氟乙烯样品支架中,其中硅的暴露面积为0.072cm2,在2M氢氧化钾溶液中浸泡前,将样品浸入HF/H20溶液中几分钟,然后用去离子水冲洗。
在样品达到平衡后,用恒电位器将n-St的电位控制在比OCP稍多的阳极电位上,记录了稳定的电流,称为暗电流,然后打开光,阳极电流突然变化,达到一个稳定的值,称为光电流。当能带弯曲时,在n-St中存在一个电场,将光化电子和空穴分开,这些光生孔对阳极电流的贡献是光电流的磁化率(hi),对于n-St,光产生的电子和空穴重组的机会增强了,因此,当施加的阳极偏置接近平带电压时,光电流的敏感性减小,在平带电压下,由于电场的消失,光电流磁化率应为零。
在黑暗中,系统的I-V曲线没有明显的变化,n-和p-St的钝化峰的幅度相似,n和p-St钝化峰的电位分别为-0.92和-0.71V,钝化峰的钝化峰为圆形,钝化峰为尖锐,在钝化峰之外,n-St的阳极电流从2.3V略有增加到10V,对于p-St,阳极电流大幅增加,在3.7和8.7V处有两个峰,在阴极偏置条件下,阴极电流随n-St的阴极偏置几乎呈线性增加,而p-St的阴极电流饱和度为-25~A/cm2。
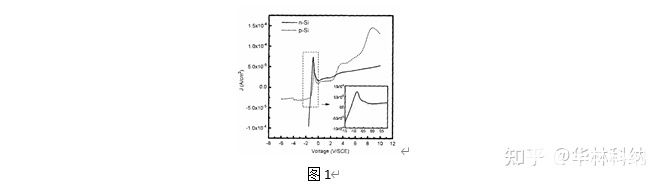
图中的插图1给出了在OCP附近的I-V曲线的详细视图。在钝化峰之前,I-V特性对n-Si/KOH表现出线性的欧姆接触行为,对p-St/氢氧化钾表现出整正的肖特基接触行为,光照对I-V曲线的影响如图所示,在光照下,n-St的阳极电流和p-St的阴极电流的I-V曲线有显著变化,对于n-St,超过-0.92V的钝化电位(PP)的阳极电流增加,在3.7V和8.7V的光照下出现两个峰,光照下n-St的阳极电流与黑暗中p-St的阳极电流表现相同,对于照明下的p-St,阴极电流不饱和,并随阴极偏置的增加而增大。
在这个耗尽区域内的电子空穴对可以分离,并有助于光电流磁化率,由于损耗区域的宽度随偏置的增大而增大,光电流敏感率随阳极偏置的增加而增大,由于(i)阳极磁化率太弱,无法检测到p-St的平带电压,且(i)大于钝化电位,无法测量p-St的平带电压,因此,在阳极偏置达到平带电压之前,p-St的表面被钝化。
不同的碱烃电解质中OH-/H~O的费米水平不同,氢氧化钾中n-St的OCP值与其他碱性电解质中的OCP值不同,因此在2M氢氧化钾中,OH-/H20的费米水平应该不同于其他碱性电解质,如氨。
我们假设平衡时的电位降落在半导体上,平衡时n-St的能带弯曲可以从OCP和平带偏置电压的知识来确定,在平衡状态下和平带偏置状态下,n-St的能带图,从测量的平带电压-1.04V和OCP,-1.25V,在平衡时,n-St的能带在界面处向下弯曲0.21eV,因此,n-St的表面随电子一起积累,这种大多数载体的积累导致了n-St和氢氧化钾之间的欧姆接触的形成。
通过测量OCP来构建2M氢氧化钾中p-St的能带图,2M氢氧化钾中p-Si在平衡状态和平带偏置时的能带图,得到的平带电压为-0.44V,在平衡状态下,氢氧化钾中的p-Si的能带向下弯曲了0.49eV,即在界面附近形成了一个势垒,图中能带弯曲qbs的大小,说明p-St的表面还没有处于强反转状态。
通过测量OCP和平带电压,建立了2M氢氧化钾中n-Si的能带图,采用光电流磁化率法测定了氢氧化钾中n-Si的拉带电压为-1.04V,根据氢氧化钾中对n-Si和p-Si的电子亲和力相等的假设,构造了p-Si的能带图,在平衡状态下,n和pSi的能带在界面附近向下弯曲,对于nsi,在界面上存在一个堆积层,而对于p-Si,在界面附近存在一个势垒和一个耗尽区,这导致n-Si具有欧姆接触I-V特征,p-Si具有肖特基接触I-V特征,在钝化峰之前,观察到n-Si的线性I-V关系,以及p-Si的整流特性,这些特性与氢氧化钾水溶液中硅的能带图相一致。
当施加阳极值大于PP的偏置时,结构从Si/电解质转变为Si/氧化物/电解质,正硅和psi的阳极电流归因于氧化膜的电化学形成,正硅反转层和正硅堆积层中的孔有助于氧化物膜的形成,利用能带图可以清楚地解释这些空穴的形成,照明对n-Si和p-Si的OCP和I-V曲线的影响也可以通过能带模型来理解,利用能带图可以解释氢氧化钾中硅的刻蚀机理和载流子输运现象,氧化速率与氧化产物扩散速率之间的竞争决定了阳极氧化是蚀刻过程还是钝化过程,重掺杂Si的蚀刻停止机制归因于高载流子浓度下氧化膜生长速率的提高。
审核编辑:符乾江
-
如何解决氢氧化钠罐体腐蚀问题2021-05-28 1244
-
KOH硅湿化学刻蚀—江苏华林科纳半导体2022-01-11 2249
-
对于不同KOH和异丙醇浓度溶液中Si面蚀刻各向的研究2022-01-13 1294
-
HF/HNO3和氢氧化钾溶液中深湿蚀刻对硅表面质量的影响2022-02-24 2538
-
氢氧化钾在凸角处的蚀刻行为2022-03-07 409
-
用NaOH和KOH溶液蚀刻硅晶片的比较研究2022-03-21 636
-
碱性刻蚀表面形貌对p型单晶硅片少数寿命的影响2022-04-24 474
-
硅晶片在氢氧化钾、TMAH和EDP溶液中的蚀刻速率2022-04-26 2796
-
硅在氢氧化钠和四甲基氢氧化铵中的温度依赖性蚀刻2023-05-29 877
-
晶片湿法刻蚀方法2023-06-05 1868
全部0条评论

快来发表一下你的评论吧 !

