

FuzionSC提升扇出型晶圆级封装的工艺产量
描述
在电子产品市场竞争激烈下,各半导体企业积极研发更为紧凑的封装技术,扇出型晶圆级封装因而迅速成为新的芯片和晶圆级封装技术,成为新一代紧凑型,高性能的电子设备的基础。
扇出型晶圆级封装最大的优势,就是令具有成千上万I/O点的半导体器件,通过二到五微米间隔线实现无缝连接,使互连密度最大化,实现高带宽数据传输,去除基板成本。
由于扇出型晶圆级封装具有不间断的线和节约空间,适用于更高性能的设备,包括传统的内存和应用处理器,与及新兴的汽车和医疗应用,实现了最新一代超薄可穿戴和移动无线设备。
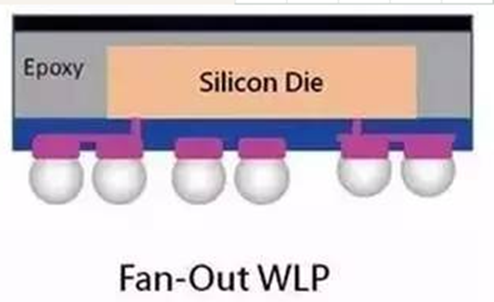
扇出型晶圆级封装工艺流程
• 晶圆的制备及切割– 将晶圆放入划片胶带中,切割成各个单元
• 准备金属载板– 清洁载板及清除一切污染物
• 层压粘合– 通过压力来激化粘合膜
• 重组晶圆– 将芯片从晶圆拾取及放置在金属载板上
• 制模– 以制模复合物密封载板
• 移走载板– 从载板上移走已成型的重建芯片
• 排列及重新布线– 在再分布层上(RDL),提供金属化工艺制造 I/O 接口
• 晶圆凸块– 在I/O外连接口形成凸块
• 切割成各个单元– 将已成型的塑封体切割
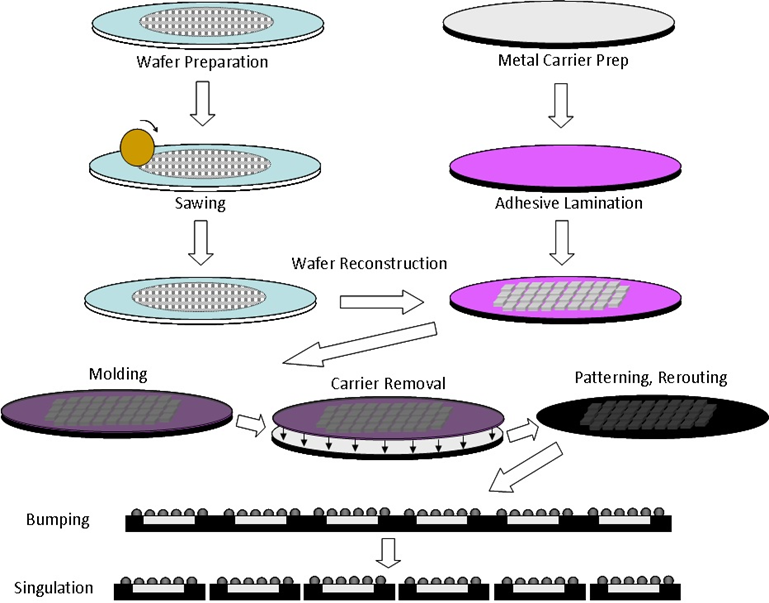
在重组晶圆这个环节上,环球仪器的FuzionSC2-14半导体贴片机因为能支持更大的工作面积(813毫米 x 610毫米),因而大大增加重组晶圆的贴装数量,实现7倍的工艺产量。
FuzionSC半导体贴片机再配合高速送料器,每小时送料高达16K,就更能确保每小时高16K的贴装速度了。
高速晶圆送料器独特功能和优势
14个高精度(亚微米X,Y,Z)伺服驱动拾取头
高精度(亚微米X,Y,Z)伺服驱动顶销
100%拾取前视觉及芯片校准
一步式“晶圆到贴装”切换
同步晶圆拉伸和存储
双晶圆平台每小时速度达16K
组装尺寸范围最大的芯片及超薄芯片
速度为现有设备的4倍
能应对最大尺寸的基板
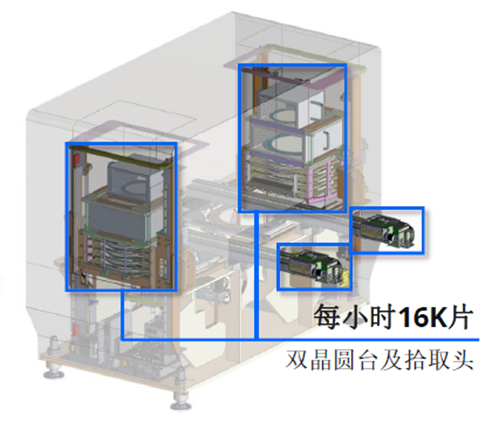
FuzionSC2-14半导体贴片机技术参数
| 贴装速度(cph) | 30,750 (最高) / 14,200 (4-板IPC 芯片) |
| 精度(µm@>1.00 Cpk) | ±10 (阵列元件/倒装芯片) / ±25 (无源元件/芯片) |
| 电路板最大尺寸 | 长813 x 宽610mm,可配备更大板特殊功能 |
| 最多送料站位(8毫米) | 120 (2 ULC) |
| 送料器类型 | 晶圆级(最大至300毫米),盘式、卷带盘式、管式及散装式 |
| 元件尺寸范围(毫米) | (008004) .25 x .125 (最少)至150 平方毫米 (多重视像),最高25毫米 |
| 最少锡球尺寸及锡球间距 (µm) | 锡球尺寸:20µm,锡球间距:40µm |
审核编辑 :李倩
-
什么是晶圆级封装?2011-12-01 0
-
晶圆凸起封装工艺技术简介2011-12-01 0
-
晶圆级封装类型及涉及的产品,求大神!急2015-07-11 0
-
晶圆级CSP贴装工艺吸嘴的选择2018-09-06 0
-
采用新一代晶圆级封装的固态图像传感器设计2018-10-30 0
-
新一代晶圆级封装技术解决图像传感器面临的各种挑战2018-12-03 0
-
晶圆制造工艺的流程是什么样的?2019-09-17 0
-
晶圆级芯片封装有什么优点?2019-09-18 0
-
晶圆级封装的方法是什么?2020-03-06 0
-
用于扇出型晶圆级封装的铜电沉积2020-07-07 0
-
晶圆级三维封装技术发展2020-12-28 0
-
讲解SRAM中晶圆级芯片级封装的需求2020-12-31 0
-
晶圆封装有哪些优缺点?2021-02-23 0
-
怎么选择晶圆级CSP装配工艺的锡膏?2021-04-25 0
-
晶圆级CSP对返修设备的要求是什么?返修工艺包括哪几个步骤?2021-04-25 0
全部0条评论

快来发表一下你的评论吧 !

