

采用化学机械抛光(CMP)工艺去除机理
今日头条
1094人已加入
描述
介绍
采用化学机械抛光(CMP)工艺,在半导体工业中已被广泛接受氧化物电介质和金属层平面化。使用它以确保多层芯片之间的互连是实现了介质材料的可靠和厚度是一致且充分的。在CMP过程中,晶圆是当被载体面朝下按压时,绕轴旋转以及对着旋转抛光垫覆盖的载体膜。具有特定化学性质的硅溶胶泥浆(图1)。例如,由50 - 70纳米组成的磨料浆 熔融石英在水溶液中,浓度在8.5-11之间,在材料种去除机理中起着重要作用。
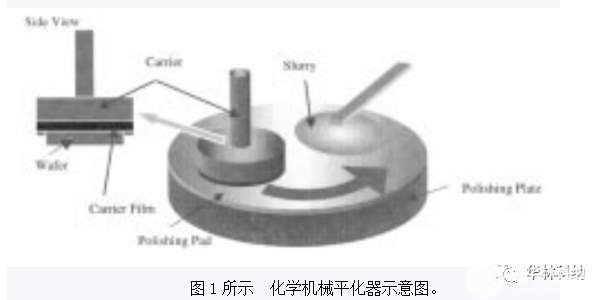
CMP中的固体-固体接触模式
在进一步讨论之前,让我们回顾CMP中两种典型的接触模式,即流体动力接触模式以及固-固接触模式。图2(a)和(b)显示了两者联系方式示意图。如图2(a)所示,当 对晶圆表面施加的下压力小,晶圆的相对速度大。CMP的一个典型性质是研磨颗粒(纳米级)的尺寸比浆液膜的厚度(微尺度),因此很大即使磨料颗粒的大小是相对的,它们也是不活跃的 ,几乎所有材料的清除都是由于部件的三体磨损造成的。
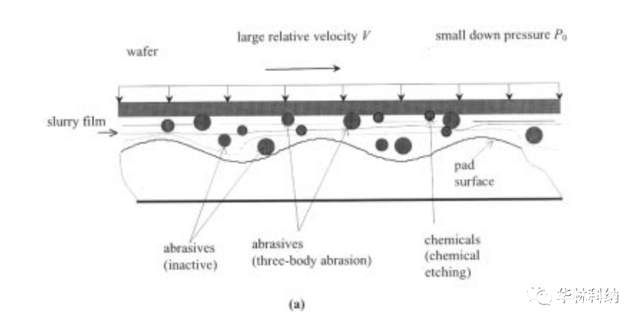
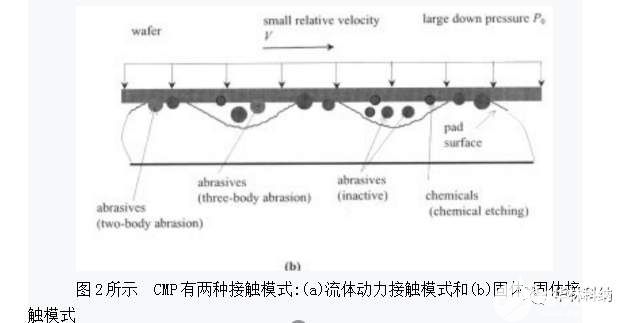
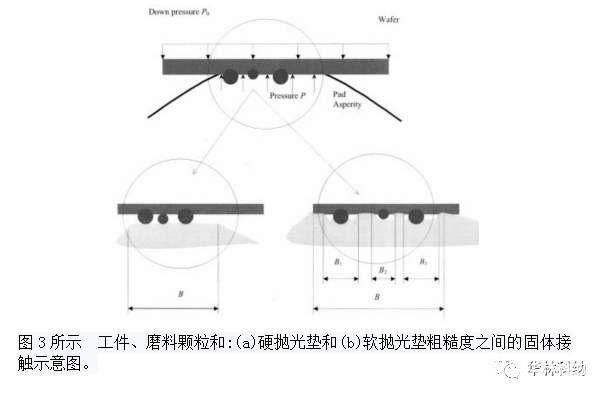
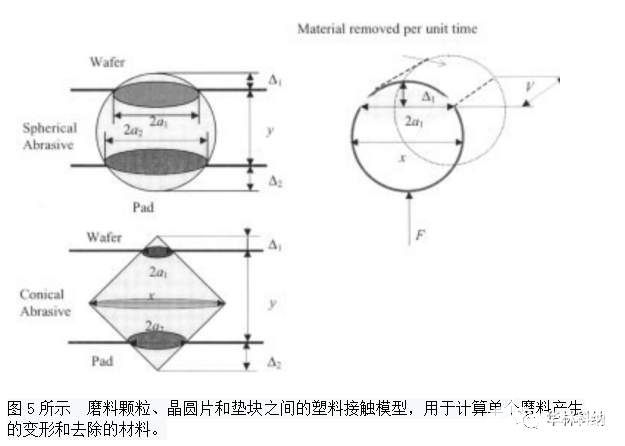
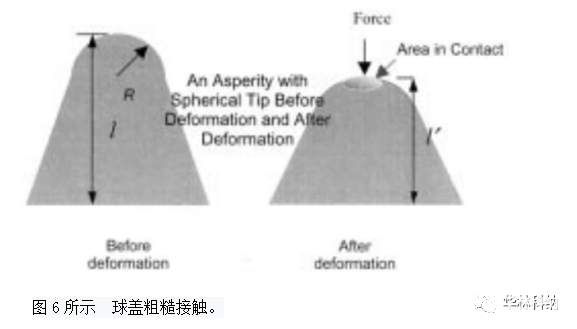
磨料粒度的正态分布
由于磨料尺寸小粒子,不在接触区域的粒子不涉及两体磨损和材料移除 。然而,并不是所有的粒子接触面积将涉及到材料的去除 。

模型验证
材料去除率的预测由于形式复杂 ,而有些输入参数无法得到准确的值,如垫层硬度,我们只能估计其有效性。在这个阶段,全面验证 依靠测量垫块硬度、接触面积比、 磨料粒度的分布。
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
新型铜互连方法—电化学机械抛光技术研究进展2009-10-06 0
-
《炬丰科技-半导体工艺》III-V/SOI 波导电路的化学机械抛光工艺开发2021-07-08 0
-
化学机械抛光(CMP) 技术的发展应用及存在问题2023-09-19 0
-
基于白光干涉测量的非接触光学测量方法评估化学机械抛光面2020-07-30 1450
-
化学机械抛光CMP技术的发展应用及存在问题2021-04-09 793
-
化学机械抛光(CMP)技术的发展、应用及存在问题2021-06-04 927
-
氮化镓晶片的化学机械抛光工艺综述2021-07-02 899
-
多晶硅薄膜后化学机械抛光的新型清洗解决方案2022-01-26 600
-
CMP后化学机械抛光清洗中的纳米颗粒去除报告2022-01-27 684
-
化学机械抛光(CMP)的现状和未来2022-03-23 1302
-
化学机械抛光工艺(Chemical Mechanical Polishing,CMP)2022-11-08 11999
-
芯秦微获A+轮融资,用于化学机械抛光液产线建设2023-11-16 267
-
CMP抛光垫有哪些重要指标?2023-12-05 553
-
半导体行业中的化学机械抛光技术2024-01-12 434
-
碳化硅晶片的化学机械抛光技术研究2024-01-24 594
全部0条评论

快来发表一下你的评论吧 !

