

 详解单晶硅的各向异性蚀刻特性
详解单晶硅的各向异性蚀刻特性
今日头条
描述
为了形成膜结构,单晶硅片已经用氢氧化钾和氢氧化钾-异丙醇溶液进行了各向异性蚀刻,观察到蚀刻速率强烈依赖于蚀刻剂温度和浓度,用于蚀刻实验的掩模图案在硅晶片的主平面上倾斜45°。根据图案方向和蚀刻剂浓度观察到不同的蚀刻特性,当氢氧化钾浓度固定为20 wt%时,在80℃以上的蚀刻温度下观察到U形槽的蚀刻形状,在80℃以下观察到V形槽的蚀刻形状,蚀刻硅表面产生的小丘随着蚀刻剂温度和浓度的增加而减少。
为了了解单晶硅的KOH溶液和KOH-IPA混合用液的各向异性湿式蚀刻特性,利用CZ法生长的4英寸(100) n型硅片。首先,形成了湿式氧化方式购买的硅(SiO2)膜4300 A,为了提高PR与氧化硅膜的附着力,首先涂上了HMDS(己烯)溶液,感光液涂层后,利用对流式OVEN在90℃~ 10分钟进行热处理(soft bake),这一过程增加了涂层后残留的溶剂,增加了感光液与晶片之间的粘合。将显影液DPP-100在室温下按原液原样使用,显影了1分钟。现象结束后,晶片在120℃下热处理10分钟,防止感光膜受损。
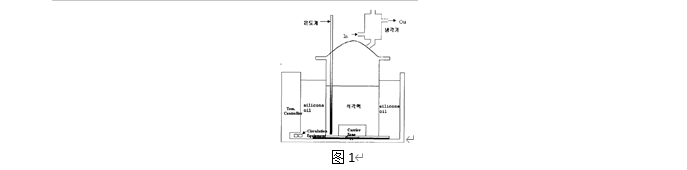
在此过程中,将准备好的晶片切割成0.5 × 0.5 cm2大小,然后将切割的硅标本切割成BOE在溶液中浸泡5分钟,根据面膜模式冷却氧化膜,随后用PPS-100N stripper溶液去除了感光膜,此时,硅晶片上残留的氧化膜层对KOH溶液起到面膜作用,为了进行各向同性湿式蚀刻实验,制作了图1各向异性蚀刻实验装置,蚀刻装置为了保持蚀刻溶液的温度和浓度不变,采用了恒温调制的重汤方式,恒温组使用电热器和全度调节器,可在室温下控制200℃范围内的全度,使用硅油的重汤方式,蚀刻溶液的温度偏差为5℃’的精度。
用JEOL模型TSM 6400扫描型电子显微镜观察各向异性湿式蚀刻硅标本的形态,SEM电子的加速电压为20 keV,在SEM观察时,硅标本垂直于图案形状切割,用样品的截面观察测量蚀刻速率,同时通过蚀刻地板面观察,调查了hillock、蚀刻形态等。并观察了蚀刻速度的变化,KOH溶液的浓度从10~30 w%变化,但可以看出,蚀刻速度看不到,而严重依赖于蚀刻溶液的温度,这样,不管浓度如何,温度越高,食角速度就越大。
图2是根据KOH浓度和温度的不同,食用角速度,比较2(a)和(b),在低温(60℃)下可以非常准确地预测,但在高温(80℃)下,预测比实际蚀刻速度大10%左右,对KOH溶液的浓度和温度,用SEM观察了湿式蚀刻地板表面的粗糙度和蚀刻形态,蚀刻的地板表面的粗糙度呈现出温度和浓度越低越粗糙的趋势。如图2(a)的图表所示,KOH溶液对硅的蚀刻角速度差异很小,但与使用20 w%浓度的KOH溶液相比,底面的粗糙度为30 w%的浓度时,结果良好。这样,浓度的增加改善地板表面粗糙度的倾向随着温度的升高而更加明显。
通常以金字塔形状出现,根据蚀刻溶液的温度和浓度,有时会出现不同的形状。另一方面,由于蚀刻的表面和侧面的角度不同,一部分崩塌的情况也会发生,这样倒塌的部分很快就会被冷却下来,形成平坦的一面。另外,如果食角速度慢,hillock的密度会增加,相反,食角速度快,hillock会减少,原因是食角速度重,就会减少(100)和(110)的食角比例。观察到,KOH溶液浓度高时,Hillock密度高,但大小小。
为了实现成员通道结构,使用含有KOH的两种溶液进行了单晶硅晶片的各向异性湿式蚀刻,并考察了每种蚀刻溶液的蚀刻特性。实验结果表明,蚀刻液的温度和浓度、图案和晶片结晶度的日值等影响了蚀刻特性,其中蚀刻速率随KOH、KOH-IPA的浓度和温度变化很大。KOH-IPA混合溶液用于降低蚀刻速率,在蚀刻速率降低的同时,蚀刻地板表面的粗糙度趋于恶化,观察到对纯KOH溶液的各向异性湿式蚀刻在30° w % 80 ~ 90℃温度范围内的最佳特性,可看出蚀刻形态呈水直形态,底部不粗糙,平坦。当KOH溶液的蚀刻温度低于80℃时,根据结晶取向得到了V-groove结构。
审核编辑:汤梓红
-
单晶硅各向异性腐蚀的微观动态模拟2009-07-02 763
-
单轴各向异性异向介质平板波导中的导模特性2009-10-26 561
-
各向异性衬底上的高温超导( HTS)微带天线2010-02-22 698
-
次氯酸钠对单晶硅表面的纹理蚀刻2021-12-17 896
-
低浓度KOH中的各向异性蚀刻2021-12-28 1120
-
半导体各向异性蚀刻的表面化学和电化学2022-03-03 987
-
各向同性和各向异性工艺如何用于改善硅湿蚀刻2022-03-09 2096
-
一种改进的各向异性湿法蚀刻工艺2022-03-14 624
-
单晶硅各向异性蚀刻特性的表征2022-03-22 441
-
铁磁材料的应力致磁各向异性特性研究2022-04-06 1699
-
单晶硅晶片的超声辅助化学蚀刻2022-04-12 382
-
单晶硅的各向异性蚀刻特性说明2022-05-05 2755
-
硅结构的深且窄的各向异性蚀刻研究2022-05-11 779
-
高速硅湿式各向异性蚀刻技术在批量微加工中的应用2023-05-18 860
-
什么是各向异性刻蚀?2023-08-22 521
全部0条评论

快来发表一下你的评论吧 !

