

 一种半导体制造用光刻胶去除方法
一种半导体制造用光刻胶去除方法
今日头条
描述
引言
本发明涉及一种去除光刻胶的方法,更详细地说,是一种半导体制造用光刻胶去除方法,该方法适合于在半导体装置的制造过程中进行吹扫以去除光刻胶。在半导体装置的制造工艺中,将残留在晶片上的光刻胶,在H2O/O2气体气氛中进行干洗,在CF4等离子体条件下进行干燥,在O2等离子体的条件下进行干燥剂后, 通过执行湿式清洁工艺去除上述残留光刻胶,可以彻底去除半导体装置制造过程中使用的光刻胶,增进半导体装置的可靠性,防止设备污染。
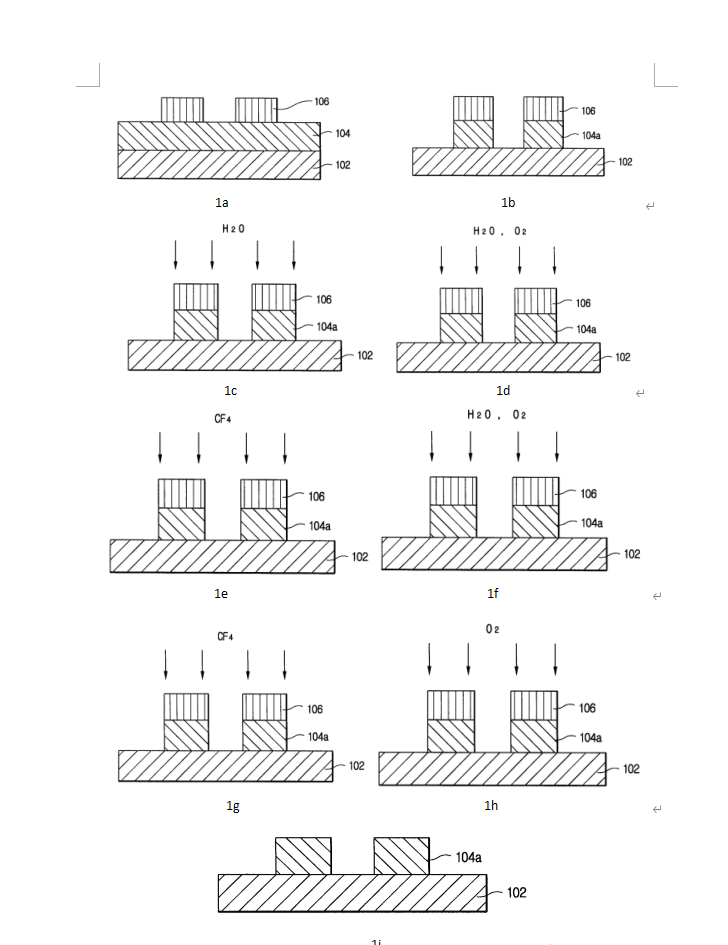
众所周知, 在半导体装置的制造过程中,用于各种电路的无缝电气连接金属布线随着半导体产品的高集成化、高速化,越来越要求以较小的线宽制作。因此,选择合适的光刻胶是非常重要的,随着金属布线的线宽变小,不仅大功率和低压力被用作金属布线形成的蚀刻方法,根据所用光刻胶的特点,去除蚀刻进程中产生的聚合物和光刻胶是非常重要的。
传统的方法是在半导体装置的制造过程中使用H2O等离子体、由于蚀刻过程中产生的聚合物,使用O2等离子体进行干洗,可能无法完全去除光刻胶。 即使执行湿式清洁,由于等离子体室的高温,在等离子体发挥作用之前,随着晶片停留时间的增加,聚合物也会过度硬化,直接残存的问题。因此, 本发明旨在解决上述传统技术存在的问题,在半导体装置的制造过程中,H2O等离子体,其目的在于提供一种半导体制造用的光刻胶去除方法,利用H2O/O2气体、CF4等离子体和O2等离子体进行干燥剂,从而达到完美去除光刻胶的目的。
图1a至图1i是根据本发明,在半导体装置制造过程中使用的光刻胶的工艺流程图。如图1a所示,在半导体元件的制造过程中,在半导体基板上PVD(Physical Vapor Deposition: 物理气相沉积法,离子束, 电子束 或通过射频(RF)冲刷(sputtering)等方法沉积金属层后,在金属层上形成用于蚀刻金属层的光刻胶图案。 在这里,金属层可以使用例如Al、Cu、Ti、TiN等金属。
此外, 正如我们在1b中所看到的,Cl等离子体, 如图1c所示,采用H2O等离子体的干燥剂,压力在0.5 Torr-1.5 Torr之间, 在700瓦-800瓦的电源、450 sccm-550 sccm-H2O量、260℃-280℃的温度下进行28秒-32秒。 可取的是,在1 Torr的压力、750 W的电源、500 sccm的H2O量、270℃的温度下,用H2O等离子体干洗30秒。 这是为了将金属层按照光刻胶图案蚀刻后产生的聚合物及残余Cl去除。
其次,如图1d所示,调节等离子体蚀刻室内压力、H2O量、O2量、时间等,在H2O/O2气体气氛下进行干燥剂,采用H2O/O2气体的干燥剂,压力为8 Torr-12 Torr, 在0W电源、900sccm-1100sccm-H2O量、4900sccm-5100sccm-O2量、260℃-280℃温度下执行4秒-6秒。 最好在10 Torr的压力、0 W的电源、1000 sccm的H2O量、5000 sccm的O2量、270℃的温度下用H2O/O2气体干洗5秒钟。
通过调节等离子体蚀刻室内压力、CF4的量、时间等,如图1e所做的那样,利用CF4弗[0020]razma进行干燥剂,在这里, 采用CF4等离子体的干燥剂,压力在0.5 Torr-1.5 Torr之间, 在700 W-800 W的电源、45 sccm-55 sccm2的CF4量、260℃-280℃的温度下进行,持续8秒-12秒。 可取的是,在1 Torr的压力、750 W的电源、50 sccm的CF4量、270℃的温度下,用CF4等离子体干洗10秒钟。
如图1f所示,通过调节等离子体蚀刻室内的压力、H2O量、O2量、时间等,在H2O/O2气体气氛下进行干燥剂。采用H2O/O2气体的干燥剂,压力为8 Torr-12 Torr, 在0W电源、900sccm-1100sccm-H2O量、4900sccm-5100sccm-O2量、260℃-280℃温度下进行,持续8秒-12秒。 可取的是,在10 Torr的压力、0 W的电源、1000 sccm的H2O量、5000 sccm的O2量、270℃的温度下,用H2O/O2气体干洗10秒钟。
通过调节等离子体蚀刻室内压力、CF4的量、时间等,如图1g所做的那样,利用CF4等离子体进行干燥剂。 采用CF4等离子体的干燥剂,压力在0.5 Torr-1.5 Torr之间, 在700 W-800 W的电源、45 sccm-55 sccm2的CF4量、260℃-280℃的温度下进行16-24秒。 可取的是在1 Torr的压力、750 W的电源、50 sccm的CF4量、270℃的温度下用CF4等离子体干洗20秒。通过调节等离子体蚀刻室内压力、O2的量、时间等,如图1h所做的那样,利用O2普尔razma进行干燥剂。 用O2等离子体干燥剂产生0.5 Torr-1.5 Torr的压力; 在700瓦-800瓦的电源、2900 sccm-3200 sccm-3的O2量、260℃-280℃的温度下进行28秒-32秒。 可取的是,在1 Torr的压力、750 W的电源、3000 sccm的O2量、270℃的温度下,用O2等离子体干洗30秒。
在此之后,执行湿法洗净工艺,形成完全消除了光刻胶图案的下部金属布线,正如在图1i中所做的那样。因此, 在半导体装置的制造过程中,可以依次进行利用H2O等离子体、H2O/O2气体、CF4等离子体和O2等离子体的[0025]干燥剂,从而完全消除用于形成底层金属布线的光刻胶图案。
审核编辑:汤梓红
-
光刻胶在集成电路制造中的应用2018-08-23 0
-
#半导体制造工艺 补充光刻胶灵敏度和调制传递函数电子技术那些事儿 2022-10-15
-
Futurrex高端光刻胶2010-04-21 0
-
光刻胶残留要怎么解决?2016-11-29 0
-
Microchem SU-8光刻胶 2000系列2018-07-04 0
-
光刻胶2018-07-12 0
-
光刻胶有什么分类?生产流程是什么?2019-11-07 0
-
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓2021-07-06 0
-
《炬丰科技-半导体工艺》IC制造工艺2021-07-08 0
-
一文带你了解芯片制造的6个关键步骤2022-04-08 0
-
负光刻胶显影残留原因2023-04-20 0
-
默克推出用于芯片制造的新一代环保光刻胶去除剂2021-07-28 2703
-
微气泡对光刻胶层的影响2022-01-10 1415
-
万润股份在半导体制造材料领域稳步推进,涉足光刻胶单体、PI等业务2023-12-12 384
-
光刻胶分类与市场结构2024-01-03 467
全部0条评论

快来发表一下你的评论吧 !

