

半导体工艺中化学机械抛光后刷洗的理论分析
工艺综述
描述
摘要
化学机械平面化后的叶片清洗,特别是刷子擦洗,是半导体器件制造的一个关键步骤,尚未得到充分了解。临界粒子雷诺数方法用于评估在刷擦洗过程中去除晶圆表面的粘附颗粒,或者是否必须发生刷-粒子接触。考虑了直径为0.1和1.0m的氧化铝颗粒粘附在抛光二氧化硅和铜表面的模型系统。结果表明,流体力学力量可以去除部分粘附颗粒,但必须发生刷状颗粒接触才能去除所有的粘附颗粒。
理论
粘附/移除模型:在得出任何关于粒子去除的结论之前,有必要了解在水动力流场中作用于粒子的力。图1显示了一个直径为d的可变形颗粒,它粘附在运动流体中的表面上。在该模型中,粘附力(FA)、阻力(FD)和升力(FL)力和外部表面应力矩(MD)是通过粒子暴露区域的中心起作用的。 这些力与接触半径(a)之间的关系,由于变形导致的粒子与表面之间的相对接近值a,和表面粗糙度ε,必须被理解为正确地描述颗粒的去除。
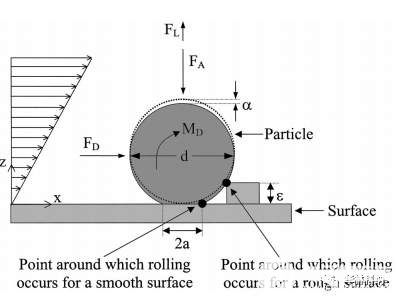
图1 粘性粒子和相关力的示意图
分析
系统和条件:一般来说,cmp后的清洁将包括从各种表面去除各种颗粒尺寸和材料。不对称的氧化铝颗粒,尺寸为0.1和1.0mm,粘附在具有抛光二氧化硅表面的200毫米晶片上作为代表系统。为了进行比较,还考虑了不对称的氧化铝颗粒粘附在类似的晶片上,但与铜表面。类似于图中所示的单面、圆盘型刷式洗涤器的流体流动。 表一显示了所考虑的商业刷式洗涤器的典型操作条件。

表一 刷子擦洗模拟中的参数
流动剖面:多孔手指之间的流动轮廓刷和晶圆是复杂的,但如果有以下假设,可以近似为刷径向位置的函数:(i)刷表现得好像它有一个均匀的固体表面,即无滑移边界条件成立,(ii)刷子和晶片起到如下作用平行平板,底板固定,顶板以刷和晶片之间的相对速度移动,(iii)颗粒的极小尺寸防止它们干扰流场。刷子和晶片之间的流动取决于刷状-晶片分离距离(D)和刷子指δ上的边界层厚度之间的关系。当它经过晶圆片时。如果D>δ,刷子附近的速度剖面取决于边界层的结构,而晶圆附近的速度文件是晶圆旋转的函数。如果D≤δ,速度剖面可以近似为线性。
粘附力,附着力:CMP后粘在晶片表面的颗粒是不同的,是粗糙和不对称的。有必要正确地描述粘附力对颗粒的组成、几何形状和形态的依赖性,或对颗粒去除所做的任何预测都会产生误导。它可以准确地预测不对称粒子的粘附力。表三给出了这里所考虑的粒子和表面的粗糙度统计量和弹性模量。

表三 用于计算不对称Al2O3颗粒附着力的材料特性
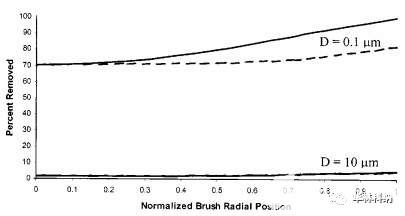
根据1.0mm氧化铝颗粒粘附于抛光二氧化硅的归一化刷径向位置和分析程序,去除的颗粒百分比
结论
本文采用临界粒子雷诺数方法来评估刷子擦洗过程中产生的水动力是否可以去除晶片表面的粘附颗粒,或者是否必须发生刷子粒子接触。临界粒子雷诺数取决于流体性质、粘附粒子附近的速度剖面、作用在粒子上的粘附力和点滚动发生的周围。采用时间相关的边界层分析来确定刷擦洗过程中刷指和晶片之间产生的速度轮廓。刷-晶片分离距离必须小于或等于刷指上的边界层厚度,以便刷诱导的流体在晶片表面附近显著运动。采用一个经过验证的模型计算了感兴趣的粒子的粘附力分布。该模型考虑了衬底化学、粒子和表面形貌和力学性能,以及相互作用表面的几何形状。然后,考虑到粘附力的变化和粗糙度对滚动发生点的影响,计算了每个粒径的临界粒子雷诺数分布。将这种分布与流粒子雷诺数进行比较表明,在考虑的典型工作条件下,在cmp清洗后的过程中,水动力可以去除晶片表面的一些粘附颗粒,但必须发生刷状颗粒接触才能完全去除颗粒。
-
新型铜互连方法—电化学机械抛光技术研究进展2009-10-06 0
-
《炬丰科技-半导体工艺》III-V/SOI 波导电路的化学机械抛光工艺开发2021-07-08 0
-
半导体行业中的化学机械抛光技术2024-01-12 433
-
基于白光干涉测量的非接触光学测量方法评估化学机械抛光面2020-07-30 1449
-
化学机械抛光CMP技术的发展应用及存在问题2021-04-09 793
-
化学机械抛光(CMP)技术的发展、应用及存在问题2021-06-04 926
-
氮化镓晶片的化学机械抛光工艺综述2021-07-02 898
-
刷洗清洗过程中的颗粒去除机理—江苏华林科纳半导体2022-01-11 467
-
多晶硅薄膜后化学机械抛光的新型清洗解决方案2022-01-26 600
-
CMP后化学机械抛光清洗中的纳米颗粒去除报告2022-01-27 684
-
化学机械抛光(CMP)的现状和未来2022-03-23 1301
-
采用化学机械抛光(CMP)工艺去除机理2022-03-23 1691
-
半导体行业中的化学机械抛光(CMP)技术详解2023-08-02 9033
-
芯秦微获A+轮融资,用于化学机械抛光液产线建设2023-11-16 267
-
碳化硅晶片的化学机械抛光技术研究2024-01-24 592
全部0条评论

快来发表一下你的评论吧 !

