

 硅化物膜的溅射刻蚀速率研究
硅化物膜的溅射刻蚀速率研究
电子说
1.2w人已加入
描述
我们测量了硅化物膜(CoSi2、NiSi2、TiSi2和WSi)的溅射刻蚀速率,并研究了离子能量的依赖性,发现它们与二氧化硅薄膜的相对溅射刻蚀速率几乎与溅射离子能量无关,从相对溅射蚀刻速率和计算的Ni和Si的截面比率来估计Ni的表面结合能,并发现由相对溅射刻蚀速率决定的表面结合能与众所周知的值一致。
薄膜(Cosi2,Nisi2,Tisi2,WSi)通过溅射方法在n型Si (100)基板上沉积约200 纳米,这些是由表面分析研究组提供的,它是多晶的,所以说一个的深度是用一个台阶总和来衡量的。
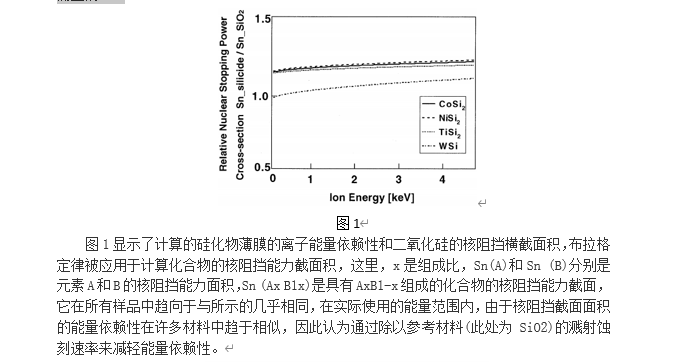
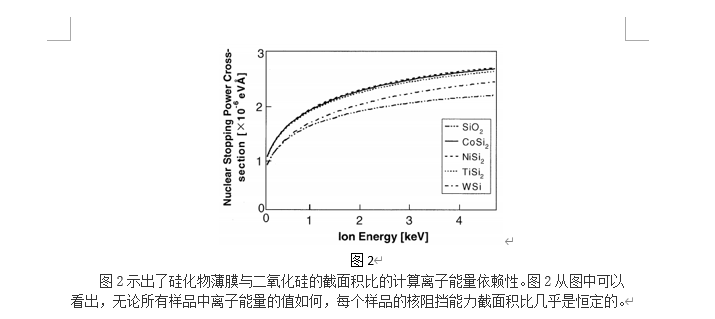

由本实验求出的镍对硅的相对溅射蚀刻速率的离子能量依赖性,用最小二乘法拟合核可阻止截面积比和溅射蚀刻速率,得到硅的离子能量依赖性,根据这些结果,可以认为通过实测不知道表面键能的物质、表面键能和原子密度已知的物质和相对溅射蚀刻速率,计算核阻止能截面积的比,可以推测某物质的表面键能。
测量溅射坑的深度,并且测量硅化物薄膜的溅射蚀刻速率,并且检查这些样品的相对蚀刻速率对SiO2的能量依赖性,可以发现,硅化物薄膜相对于SiO2的相对蚀刻速率具有很小的能量依赖性,如从核阻挡能力横截面积的计算中所预期的,并且能量依赖性放松是实际的优点,因为它可以估计尚未测量的能量下的值,此外,样品的近似表面结合能可以从相对溅射蚀刻速率和核阻挡能力截面比来估计。
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
台面刻蚀深度对埋栅SITH栅阴击穿的影响2009-10-06 0
-
Sic mesfet工艺技术研究与器件研究2009-10-06 0
-
退火对Fe(200 nm)/Si系统中硅化物的形成和微结构的影响2010-04-24 0
-
【转帖】干法刻蚀的优点和过程2018-12-21 0
-
请教碳化硅刻蚀工艺2022-08-31 0
-
磁控溅射WO3薄膜特性研究2009-06-30 402
-
钝化层刻蚀对厚铝铝须缺陷影响的研究2018-03-06 5832
-
GaN材料干法刻蚀工艺在器件工艺中有着广泛的应用2020-12-29 3032
-
关于微技术中硅反应离子刻蚀的研究2022-02-14 1659
-
关于刻蚀的重要参数报告2022-03-15 3105
-
刻蚀工艺基础知识简析2023-02-06 4909
-
半导体行业之刻蚀工艺2023-02-08 2916
-
半导体刻蚀工艺简述(3)2023-03-06 1994
-
半导体行业之刻蚀工艺技术2023-04-07 2621
-
金属湿法刻蚀2023-05-29 2022
全部0条评论

快来发表一下你的评论吧 !

