

 一种将硅和石英玻璃晶片的键合方法
一种将硅和石英玻璃晶片的键合方法
今日头条
描述
本文展示了一种使用连续湿法化学表面活化(即SPM→RCAl清洗)结合硅和石英玻璃晶片的键合方法。经过200 ℃的多步后退火,获得了无空洞或微裂纹的牢固结合,基于详细的表面和键合界面表征,建立了一个键合模型以深入理解低温键合机理,这种具有成本效益的键合工艺对于硅和玻璃基异质集成具有巨大的潜力,而不需要真空系统。
硅是微电子领域中最重要的材料,石英玻璃(也称为“二氧化硅玻璃”)由于其优异的光学、机械和化学性质,在图像传感器、显示器、太阳能电池、光波导和微/纳流体中非常有吸引力。阳极键合是一种众所周知的键合硅和玻璃晶片(例如含钠的硼浮法玻璃或耐热玻璃)的方法,但是它不适用于硅和石英玻璃的直接键合,因为在键合界面上没有金属离子,由于硅和石英玻璃的热膨胀系数相差很大,所以不允许在极高的温度(800~1000 ℃)下进行熔焊,最近,已经开发了多种表面活化方法,能够在低温(< 400℃)退火后实现牢固的结合,与“干”等离子体处理相比,湿化学处理具有成本效益,不需要真空系统,例如对玻璃使用硫酸(h2so 4)过氧化氢(H2O2)混合物(SPM ),或对硅清洗使用标准RCA1 (NH4OH/H2O2/H2O)溶液,然而,在低温下,结合强度通常不足,在本文中,讲了一个顺序化学表面活化过程(即SP’m→RCA 1)来加强预键合,之后,进行多步退火工艺,以进一步增强结合强度并减轻热应力,基于表面和键合界面特征,提出了一个键合模型来解释低温键合机理。
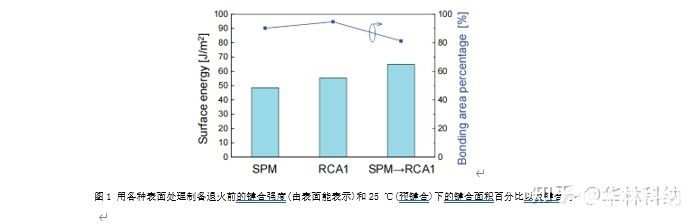
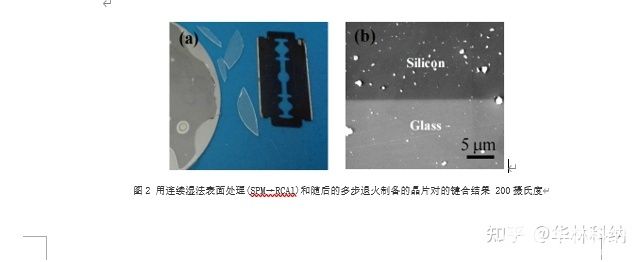
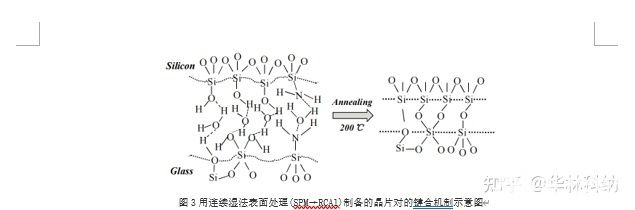
图1显示了预粘合后的粘合强度(表面能)和粘合面积百分比,与标准的SPM或RCAl清洗相比,连续的湿化学处理(SPM→RCAl)产生了更高的预粘结强度,有趣的是,在200℃多步退火后,获得了非常强的键合,由于刀片的强粘合性,插入刀片时会发生割伤,没有空隙或者紧密结合界面处的微裂纹,图3显示了键合机理,其中表面上终止的氨基可能会增强键合强度。
-
制作石英晶振全过程2012-11-16 0
-
彩色石英玻璃管液位计2013-02-20 0
-
晶片边缘蚀刻机及其蚀刻方法2018-03-16 0
-
倒装芯片和晶片级封装技术及其应用2018-08-27 0
-
倒装晶片的定义2018-11-22 0
-
3W UV LED灯 60度45度石英玻璃透镜365nm 395nm 405nm2019-03-01 0
-
石英玻璃管拉制过程的微机检测与控制2009-06-13 545
-
日立推出石英玻璃数据永久存储技术2012-09-26 1101
-
广发证券挖掘了一个被忽略的半导体产业链中的品种:石英玻璃2018-06-05 9701
-
石英玻璃热化学后处理后表面粗糙度改善的研究2021-12-16 1243
-
通过两步湿化学表面清洗来结合硅和石英玻璃晶片的工艺2022-05-07 1166
-
超深熔融石英玻璃蚀刻研究2022-05-23 1316
-
瞬态平面热源法测试石英玻璃导热系数2022-01-05 510
全部0条评论

快来发表一下你的评论吧 !

