

半导体生产中的高压氧化工艺和氧化层测量技术
电子说
描述
高压氧化工艺
高压氧化必须使用特殊的硬件条件,下图是高压氧化系统的说明图。由于硬件条件的复杂性和安全因素,先进半导体生产中并不常使用高压氧化技术。
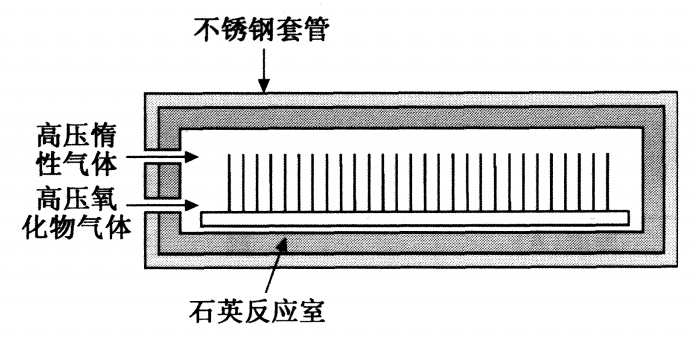
氧化层测量技术
监测氧化层的技术就是测量氧化层的厚度和均匀性。椭圆光谱仪一般用于测量电介质薄膜的折射率和厚度。当光束从薄膜表面反射时,它的极化状态将会改变(见下图)。通过测量极化状态的变化就可以获得有关薄膜反射系数和厚度的信息。由于测量的椭圆数值是厚度的周期函数,所以必须使用一个薄膜厚度的估计值。因为已知二氧化硅对波长为633nm光线(红色 He-Ne激光)的折射系数为1.46,因此椭圆光谱仪也可以用来测量氧化层薄膜的厚度。
氧化层生长完成之后,晶圆的表面颜色会随之改变。颜色与薄膜厚度、折射系数和入射光的角度有关。如下图所示,因为光线2进入氧化薄膜经过了较长的距离,所以从氧化层表面的反射光(光线1)和从硅-二氧化硅界面的反射光(光线2)将有相同的频率但有不同相位。
这两种反射光相互干涉并在不同波长形成建设性和破坏性干涉,这是因为折射系数是波长的函数。增强性的干涉频率决定了晶圆的颜色。
△phi=2tn(lamda)/cos (theta)= 2N pi
其中t是薄膜厚度,n(lamda)是薄膜折射系数,theta为入射角度,而N是一个整数。当相位移△phi 大于2pi时,色彩模式将会重复。下表为二氧化硅厚度的颜色对照表。
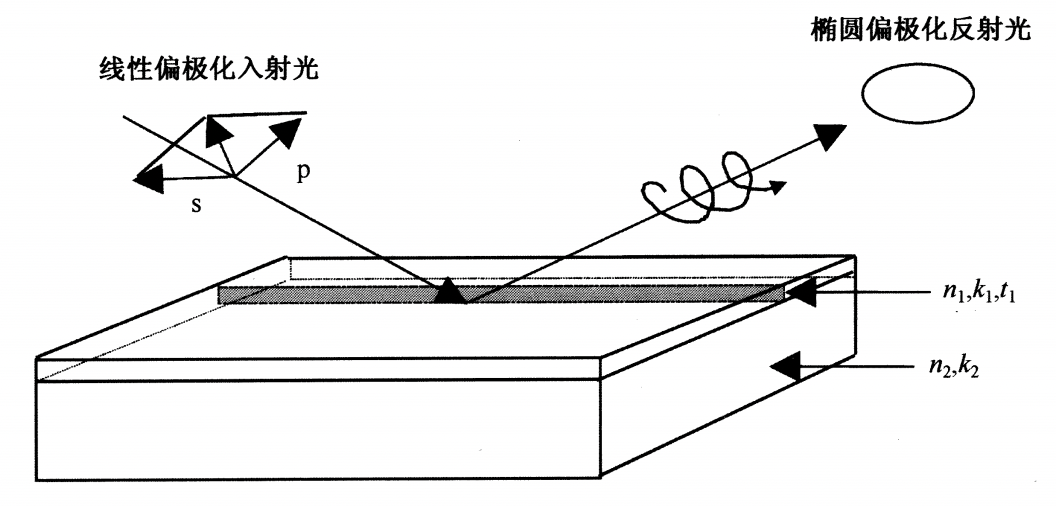
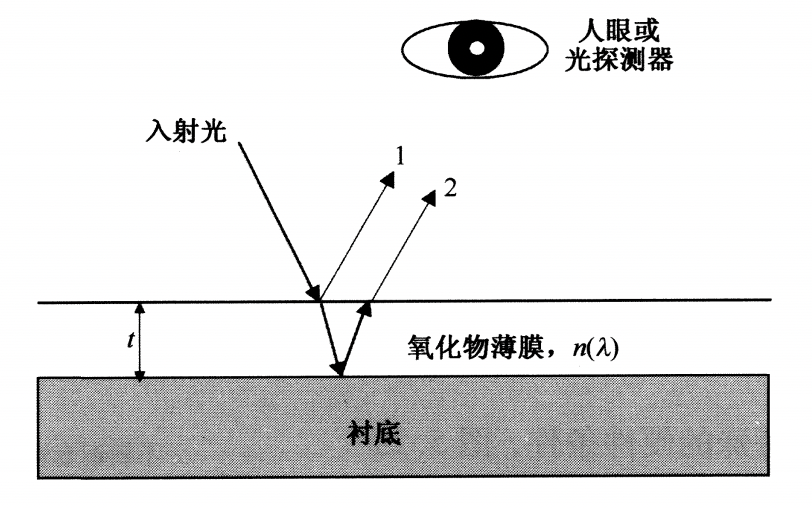


下表在测量薄膜厚度时是非常方便的工具。虽然现在的IC生产都不再使用表,但该表仍用于快速估计氧化层厚度及查看有无明显的非均匀性。
如果将具有一层较厚氧化层的晶圆放入氢氟酸溶液中,氢氟酸将会刻蚀二氧化硅。将晶圆缓慢拉出后,氧化层将会因刻蚀的时间不同而厚度不同,晶圆的颜色也不同。这样可以制作出色彩呈周期性改变的晶圆,即所谓的彩虹晶圆。
要准确测量二氧化硅的厚度就必须使用光反射光谱仪,它能够测量不同波长的光被反射后的强度,再通过光的波长和反射强度之间的关系将薄膜的厚度计算出来。
对于栅氧化层,击穿电压和固定电荷的测量非常重要。通过在氧化层上沉积一层图形化的导电层就可以形成所谓的金属-氧化物-半导体电容,通过这个电容就可以测量出击穿电压和固定电荷。当施加了偏压后,通过金属氧化物半导体电容对电压的关系或C-V曲线就可以获得硅-二氧化硅界面的固定电荷分布。如果增加偏压直到二氧化硅击穿为止,就能够测量出击穿电压的数值。结合250摄氏度的高温测试可以通过热应力加速元器件发生故障的时间,从而可以预测元器件的寿命。下图为C-V测量系统的说明图。
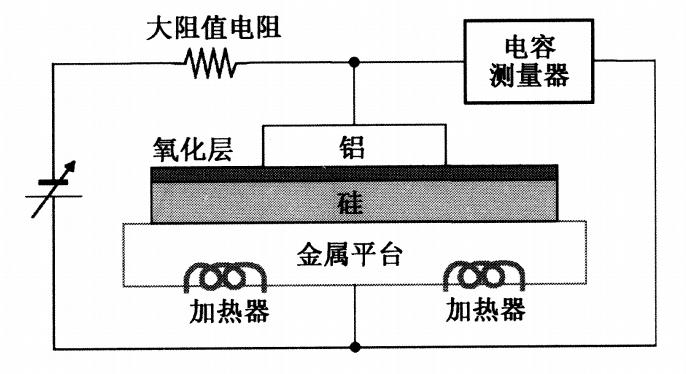
审核编辑:汤梓红
-
氧化物半导体甲烷敏感元件详解2018-10-24 0
-
太原市高压氧化避雷器现货2019-08-29 0
-
超高压氧化皮清洗机可有效去除钢坯表面的氧化皮2020-10-05 881
-
超高压氧化皮清洗机可定制出多种多样的功能2021-03-02 801
-
超高压氧化皮清洗机组件中最重要的是什么2021-03-02 537
-
超高压氧化皮清洗机的优势是什么,显效快且成本低2020-10-05 375
-
超高压氧化皮清洗机的原理是怎样的,它有什么优势2020-10-05 1408
-
超高压氧化皮清洗机的特点都有哪些2021-03-02 553
-
超高压氧化皮清洗机是什么,它都有哪些特点2020-10-05 495
-
超高压氧化皮清洗机对热轧钢厂的作用有多大2020-10-05 712
-
超高压氧化皮清洗机的特点是什么2020-10-05 353
-
超高压氧化皮清洗机将成为除磷方法的主流2021-03-02 456
-
超高压氧化皮清洗机选择离心泵的好处是什么2021-03-02 564
-
超高压氧化皮清洗机选择离心泵的优势是什么2020-10-05 641
-
半导体的8大工艺之氧化工艺2021-05-28 10252
全部0条评论

快来发表一下你的评论吧 !

