

单晶圆系统的多晶硅沉积方法
制造/封装
描述
单晶圆系统也能进行多晶硅沉积。这种沉积方法的好处之一在于能够临场进行多晶硅和钨硅化物沉积。DRAM芯片中通常使用由多晶硅-钧硅化物形成的叠合型薄膜作为栅极、局部连线及单元连线。临场多晶硅/硅化物沉积过程可以节省钨硅化物沉积之前,去除多晶硅层上的表面氧化层过程和表面清洗步骤,这些步骤都是传统的高温炉多晶硅沉积和CVD钨硅化物工艺所必需的。使用多晶硅-钨硅化物整合系统可以使产量明显增加。如下图所示,单晶圆的多晶硅沉积反应室与单晶圆外延硅沉积反应室类似。下图所示是一个整合了多晶硅和钙硅化物的沉积系统,或称为多晶硅化物系统。

在整合多晶硅化物系统中,晶圆从装载系统中载入,然后利用机械手臂将晶圆从转换室送入多晶硅反应室。多晶硅沉积之后,再将晶圆由多晶硅反应室取出转送到钨硅化物进行沉积,这个过程经过处于真空状态的转换室。当多晶硅化物沉积完成 后,机器手臂将再次取出晶圆送到冷却室。冷却室内的氮气将晶圆的热量带走,最后机器手臂将晶圆放在装载系统中的塑胶晶圆盒内准备卸载。
对于先进的dram芯片,多晶硅、硅化钨、钙氮化和钨(多晶硅/ WSL/WN/W)堆积是常用的栅/数据线;钨氮化物、钙(WN/W)堆积被用于位线。最先进的DRAM芯片采用埋数据线 (BWL)技术,它采用TiN/W堆积于阵列晶体管的栅极和数据线;多晶硅/WSi“/ WN/W置于位线和外围晶体管的栅电极。
单晶圆的多晶硅沉积主要在10〜200 Torr的低压下采用硅烷化学反应进行,沉积时的温度为550 -750摄氏度,沉积速率可高达2000 A/mino干式清洁系统中通常使用HC1移除沉积在 反应室内壁上的多晶硅薄膜,这将有助于减少微粒物的产生。
01氮化硅沉积
氮化硅是一种致密的材料,在IC芯片上广泛用于扩散阻挡层。硅局部氧化形成过程中,用氮化硅作为阻挡氧气扩散的遮蔽层(见下图)。因为氮化硅的研磨速率比未掺杂的硅玻璃低,因此浅槽隔离形成中,氮化硅也作为化学机械研磨(CMP)的停止层(见下图)。
氮化硅也可以用于形成侧壁空间层、氧化物侧壁空间层的刻蚀停止层或空间层。一般情况下,在金属沉积之前,电介质层(PMD)掺磷硅玻璃或硼磷玻璃沉积过程时,将首先沉积氮化硅层作为掺杂物的扩散阻挡层,从而可以防止硼或磷穿过超薄栅氧化层进入硅衬底造成元器件损伤。氮化硅阻挡层也可以作为自对准工艺的刻蚀停止层(见下图)。
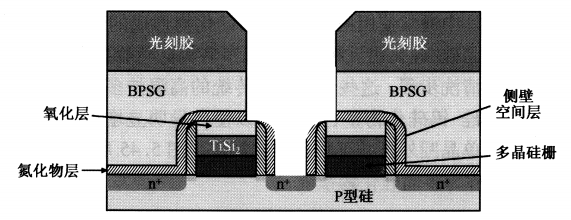
这些氮化物可以通过LPCVDI艺形成。对于扩散阻挡层氮化物,先进的IC芯片制造考虑热积存问题,使用等离子体增强化学气相沉积(PECVD),因为PECVD反应需要的温度明显低于LPCVDO ,一些先进的CMOS集成电路芯片使用氮化应变,对PMOS和NMOS沟道形成应变。对于双轴应变技术,采用PECVD氮化物的压应力形成PMOS沟道压缩应变,利用LPVCD 的拉应力形成NMOS拉伸应变沟道。
审核编辑:汤梓红
-
太阳能电池片、IC级硅片,太阳能电池片、单晶硅片2010-10-31 0
-
厂家求购废硅片、碎硅片、废晶圆、IC蓝膜片、头尾料 大量收购单晶硅~多晶硅各种废硅2010-10-31 0
-
厂家求购废硅片、碎硅片、废晶圆、IC蓝膜片、头尾料 ***大量收购单晶硅~多2010-10-31 0
-
低温多晶硅的工作原理是什么?2019-09-18 0
-
FZ多晶硅24吨2020-01-20 0
-
单晶硅与多晶硅的区别2009-03-04 4256
-
硅单晶(或多晶)薄膜的沉积2009-03-09 7263
-
光伏技术:单晶硅与多晶硅的区别2012-10-19 10068
-
多晶硅太阳电池比较单晶硅太阳电池的优点介绍2017-11-13 2680
-
多晶硅生产流程是什么_单晶硅与多晶硅的区别2017-12-18 58573
-
多晶硅和单晶硅哪个好2019-04-11 63493
-
区分单晶硅和多晶硅电池板的方法2020-11-24 1178
-
单晶硅和多晶硅的区别2023-06-12 4320
全部0条评论

快来发表一下你的评论吧 !

