

 全球IC封装基板行业市场规模分析
全球IC封装基板行业市场规模分析
电子说
描述
随着技术发展,IC的线宽不断缩小,集成度稳步提高,IC封装逐步向着超多引脚、窄节距、超小型化方向发展。20世纪90年代中期,一种以球栅阵列封装(Ball Grid Array,简称BGA)、芯片尺寸封装(Chip Scale Package,简称CSP)为代表的新型IC高密度封装形式问世,从而产生了一种新的封装载体——封装基板。
在高阶封装领域,封装基板已取代传统引线框架,成为芯片封装中不可或缺的一部分,不仅为芯片提供支撑、散热和保护作用,同时为芯片与PCB母板之间提供电子连接,起着“承上启下”的作用;甚至可埋入无源、有源器件以实现一定系统功能。封装基板在HDI板的基础上发展而来,是适应电子封装技术快速发展而向高端技术的延伸,作为一种高端的PCB,封装基板具有高密度、高精度、高性能、小型化及薄型化等特点。
根据Prismark数据,2021年全球PCB行业产值为804.49亿美元,同比增长23.4%,预计2021-2026年全球PCB行业的复合增长率为4.8%。下游应用中,通讯占比32%,计算机占比24%,消费电子占比15%,汽车电子占比10%,服务器占比10%。 从产品结构来看,IC封装基板和HDI板虽然占比不高,分别占比17.6%和14.7%,但却是主要的增长驱动因素。
2021年全球IC封装基板行业整体规模达141.98亿美元、同比增长39.4%,已超过柔性板成为印制电路板行业中增速最快的细分子行业。2021年中国IC封装基板(含外资厂商在国内工厂)市场规模为23.17亿美元、同比增长56.4%,仍维持快速增长的发展态势。
预计2026年全球IC封装基板、HDI板的市场规模将分别达到214.35/150.12亿美元,2021-2026年的CAGR分别为8.6%/4.9%。预计2026年中国市场IC封装基板(含外资厂商在国内工厂)市场规模将达到40.19亿美元,2021-2026年CAGR为11.6%,高于行业平均水平。
封装基板与传统PCB的不同之处在于两大核心壁垒:加工难度高、投资门槛高。从产品层数、厚度、线宽与线距、最小环宽等维度看,封装基板未来发展将逐步精密化与微小化,而且单位尺寸小于150*150mm,是更高端的PCB,其中线宽/线距是产品的核心差异,封装基板的最小线宽/线距范围在10~130μm,远远小于普通多层硬板PCB的50~1000μm。
按照应用领域的不同,封装基板分为存储芯片封装基板、微机电系统封装基板、射频模块封装基板、处理器芯片封装基板和高速通信封装基板等,主要应用于移动智能终端、服务/存储等。按封装工艺的不同,封装基板分为引线键合封装基板(WB)和倒装封装基板(FC)等,使用不同封装工艺与封装技术生产的封装基板应用领域不同。引线键合(WB)使用细金属线,利用热、压力、超声波能量为使金属引线与芯片焊盘、基板焊盘紧密焊合,实现芯片与基板间的电气互连和芯片间的信息互通,主要应用于射频模块、存储芯片、微机电系统器件封装;
倒装(FC)采用焊球连接芯片与基板,即在芯片的焊盘上形成焊球,然后将芯片翻转贴到对应的基板上,利用加热熔融的焊球实现芯片与基板焊盘结合,该封装工艺已广泛应用于CPU、GPU及Chipset等产品封装。将封装工艺与封装技术结合起来,又可将封装基板分为不同类型。
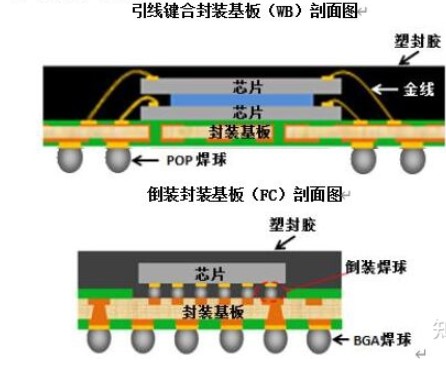
目前全球封装基板厂商主要分布在日本、韩国和中国台湾,根据Prismark和集微咨询数据,2020年封装基板市场格局较为分散,中国台湾厂商欣兴电子/南亚电路/景硕科技/日月光材料占比分别为15%/9%/9%/4%,产品主要有WB和FC封装基板;日本厂商揖斐电/新光电气/京瓷占比分别为11%/8%/5%,产品主要为FC封装基板;韩国厂商三星电机/信泰电子/大德电子占比分别为10%/7%/5%,产品主要为FC封装基板。按照FC基板材质又分为BT载板和ABF载板。
BT树脂全称为“双马来酰亚胺三嗪树脂”,由日本三菱瓦斯公司研发,虽然BT树脂专利期已过,但三菱瓦斯公司在BT树脂研发和应用方面仍处于全球领先地位,BT树脂主要生产厂商是三菱瓦斯和日立化成。BT树脂具备高耐热性(Tg)、抗湿性、低介电常数(Dk)和低散失因素(Df)等多种优势,但是由于具有玻纤纱层,较ABF材质的FC基板更硬,且布线较麻烦,雷射钻孔的难度较高,无法满足细线路要求,但可以稳定尺寸,防止热胀冷缩而影响线路良率,因此BT材质多用于对于可靠度要求较高的网络芯片及可程式逻辑芯片。
目前,BT载板多用于手机MEMS芯片、通信芯片、内存芯片、射频芯片、指纹识别芯片等产品,随着LED芯片的快速发展,BT载板在LED芯片封装上的应用也在快速发展。 ABF材料是由Intel主导研发的材料,用于导入Flip Chip等高阶载板的生产。ABF是一种低热膨胀系数、低介电损耗的热固性薄膜,相比于BT基材,ABF材质可做线路较细、适合高脚数高传输的IC,多用于CPU、GPU、FPGA、ASIC等高运算性能芯片。ABF作为增层材料,铜箔基板上面直接附着ABF就可以作线路,也不需要热压合过程。
早期ABF载板应用在电脑、游戏机的CPU居多,随著智能手机崛起和封装技术改变,ABF产业曾陷入低潮,但在近年网络速度提升与技术突破,高效能运算新应用浮上台面,ABF需求再次放大。从产业的趋势来看,ABF基材可以跟上半导体先进制程的发展,达到细线路、细线宽/线距的要求,未来市场成长潜力可期。
审核编辑:汤梓红
-
2015年中国RFID行业市场规模将达373亿元2014-04-16 0
-
未来5年无线充电设备市场规模将达135亿,你看好吗?2016-12-08 0
-
【亚派·趋势】2017年全球智能电网市场规模或超208亿美元2018-01-24 0
-
我国激光仪器产业现状:市场规模达上百亿元2018-02-09 0
-
5G建设光模块市场规模预测2020-03-24 0
-
物联网市场规模扩大对无线模组有哪些影响2021-02-02 0
-
2025年全球汽车连接器市场规模将达194.52亿美元?2023-05-22 0
-
2018年智能家居市场规模预计将达1300亿2016-06-20 1231
-
探讨智能安防行业市场规模及发展趋势2018-09-01 4505
-
全球机器人的市场规模逐年扩大2019-08-20 501
-
全球游戏市场规模持续增长,预计2020年市场规模增至1960亿美元2020-06-16 5815
-
2022年,中国智能照明行业市场规模约为431亿元2020-09-04 4525
-
全球显微镜市场规模将进一步扩大,市场规模已经达24亿美元2021-01-13 4220
-
全球安防视频监控设备市场规模分析2022-11-09 1214
-
2023年全球射频前端市场规模预测分析2022-12-09 1473
全部0条评论

快来发表一下你的评论吧 !

