

CMOS集成电路的双阱工艺简析
描述
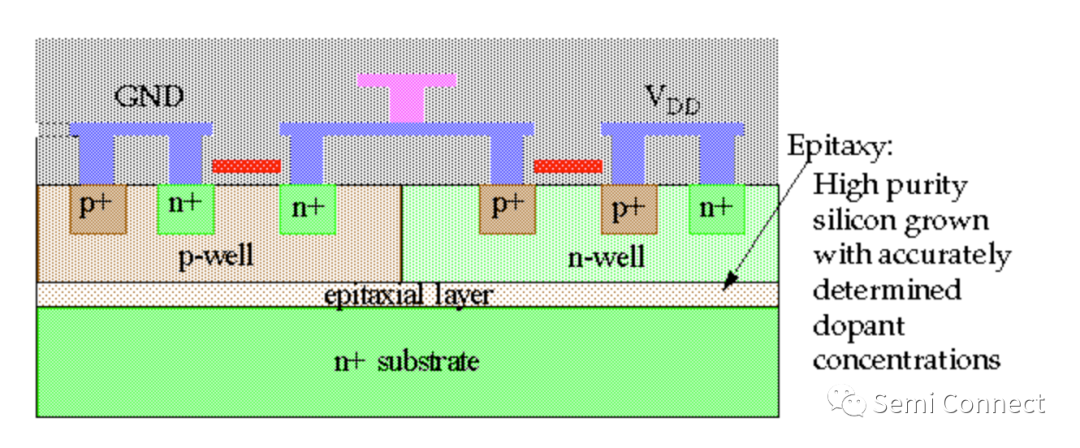
CMOS 集成电路的基础工艺之一就是双阱工艺,它包括两个区域,即n-MOS和p-MOS 有源区,分別对应p阱和N阱,如图所示。
在进行阱注入时,产业内的主流技术多数采用倒掺杂技术来调节晶体管的电学特性,即首先采用高能量、大剂量的离子注入,注入的深度约为 1um,注入区域与阱相同,随后通过大幅降低注入能量及剂量,控制注入深度和掺杂剖面。阱的注入掺杂不仅可以调节晶体管的阈值电压,也可以解决CMOS 电路常见的一些问题,如闩锁效应和其他可靠性问题。
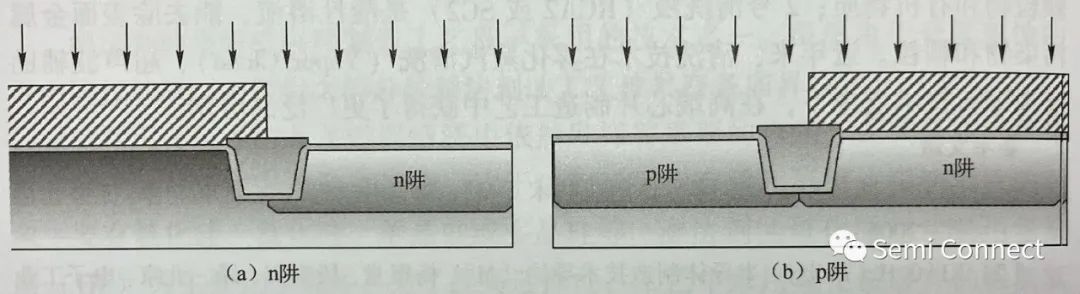
双阱 CMOS 工艺是当前集成电路的标准工艺之一,它最初是在 n-MOS工艺和 p-MOS 工艺的基础上发展起来的。
早期的双阱 CMOS 工艺没有高能量大剂量的注入,只是用中能量和中剂量离子注入n阱和p阱的区域,然后热退火形成独立的n阱和p阱。
随着离子注入技术的发展,高能量大剂量的注入不再成为离子注入的难题,并且高能量大剂量的注入形成的倒置阱效果很明显,所以才逐步形成现在的标准双阱工艺。
双阱工艺常见的基本制造步骤是先制作n阱,包括牺牲氧化层生长,n阱区域光刻,n阱注入,然后退火;p阱的形成与其类似。
确定双阱工艺的基本条件是确保器件电学特性满足要求,包括阱之间的击穿电压、有效的电学隔离、避免闩锁效应、合适的阈值电压等。
另外,衬底材料的掺杂情况也对阱的形成条件有很大影响。
审核编辑:刘清
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
CMOS射频集成电路分析与设计2015-10-21 0
-
CMOS集成电路使用时的技术要求2018-12-13 0
-
浅谈TTL电路和CMOS电路性能与特点2019-03-02 0
-
模拟CMOS集成电路设计资料分享2019-03-13 0
-
COMS工艺制程技术与集成电路设计指南2019-03-15 0
-
怎么采用标准CMOS工艺设计RF集成电路?2019-08-22 0
-
CMOS数字集成电路是什么?CMOS数字集成电路有什么特点?2021-06-22 0
-
TTL集成电路与CMOS集成电路元件比较2021-07-26 0
-
关于TTL集成电路与CMOS集成电路看完你就懂了2021-09-28 0
-
集成电路与MCU简析2021-11-01 0
-
TTL集成电路和CMOS电路有哪些区别2021-11-02 0
-
CMOS集成电路的性能及特点有哪些?2009-11-30 1221
-
CMOS 集成电路使用操作准则2009-11-30 834
-
CMOS集成电路制造工艺的详细资料说明2019-07-02 2980
-
集成电路制造工艺有哪几种?2023-05-06 4609
全部0条评论

快来发表一下你的评论吧 !

