

SiC功率器件和模块!
电源/新能源
描述
SiC(碳化硅)是一种由硅(Si)和碳(C)组成的化合物半导体材料。表1-1显示了每种半导体材料的电气特性。SiC具有优异的介电击穿场强(击穿场)和带隙(能隙),分别是Si的10倍和3倍。此外,可以在很宽的范围内实现对器件制造所需的p型和n型的控制。因此,SiC被认为是有望超越硅极限的功率器件材料。SiC具有多种多型(晶体多晶型),并且每种多型显示不同的物理特性。对于功率器件,4H-SiC被认为是理想的,其单晶4英寸到6英寸之间的晶圆目前已量产。
由于SiC的高介电击穿场强约为Si的10倍,因此高600V到几千V的击穿电压功率器件可以制造具有更高的漂移层杂质浓度和与Si器件相比更薄的厚度。大部分高击穿电阻元件电压功率器件就是这个漂移层的电阻。因此,SiC可以实现具有非常高的击穿电压器件单位面积导通电阻低。与Si相比,单位面积的漂移层电阻理论上可以降低到1/300相同的击穿电压。使用Si,少数载流子器件(双极器件)包括IGBT(绝缘栅双极晶体管)主要用于解决与较高击穿电压相关的导通电阻增加的问题。
然而,它们遭受较大的开关损耗,并且由于高频驱动器产生的热量而限制了高频驱动。开关损耗。相比之下,使用SiC,可以通过多数载流子器件(肖特基势垒)实现高击穿电压二极管和MOSFET),它们是高速器件结构。因此,所有三个特点,即“高击穿电压”,可以同时实现“低导通电阻”和“高速”。外,它的带隙大约是Si的3倍,使功率器件能够以更高的温度(尽管由于热量的限制,目前保证温度约为150°C至175°C封装的电阻可靠性,随着封装的进步,可以实现200°C以上的保证温度未来的技术)。
2.1设备结构及特点
使用SiC,可以使用肖特基势垒二极管(SBD)结构实现1,200 V以上的高击穿电压二极管(向上到大约200 V与Si基SBD)。因此,如图2-1所示,通过替换目前流行的高速,可以显着降低恢复损失带SBD的PN结二极管(FRD:快速恢复二极管)。这有助于提高电源效率,通过高频驱动实现线圈等无源元件的小型化和降噪。它们的应用主要是功率因数校正(PFC)电路和二次侧整流桥,并扩展到EV、电源的车载充电器太阳能发电用空调、服务器电源、空调等。
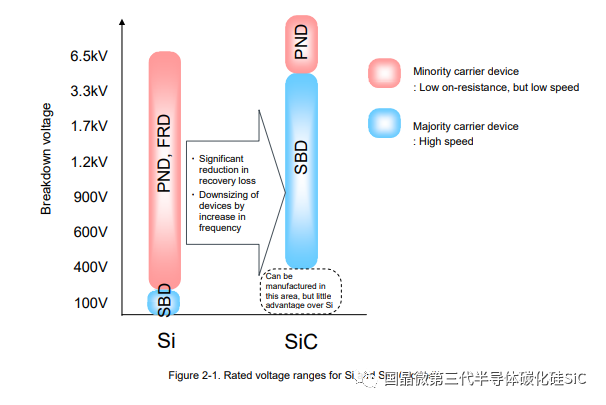
目前,ROHM的产品阵容中列出了击穿电压为650 V、1,200 V和1,700 V的SBD。SiC SBD的上升电压略小于1 V,类似于Si FRD。上升电压由高度决定肖特基势垒,通常可以通过设计较低的势垒高度来降低。但是,两者之间存在权衡关系反向偏置条件下的上升电压和漏电流随着势垒高度的降低而增加。在里面ROHM的第二代SBD,工艺创新成功将上升电压降低了约0.15 V将漏电流和恢复性能保持在与传统产品相同的水平。此外,在第三代SBD中,通过结合JBS(结势垒肖特基)进一步降低了VF和漏电流第二代SBD的结构和低VF工艺。特别是,VF在高温下显着降低。温度依赖性与Si FRD不同,显示VF因工作电阻增加而增加随着温度的升高。它们可以安全地并联使用,因为不太可能发生热失控。
在第二代SBD中,采用了一种简单的结构,其中肖特基金属仅附着在漂移层上,称为纯肖特基结构。然而,由于漂移层的电阻值在较高的当正向浪涌电流流过时,自发热限制了电流,从而产生了使峰值浪涌的趋势当前的IFSM比Si FRD更小。在没有旁路二极管的PFC电路中,启动时的浪涌电流和其他情况可能会损坏SBD。
因此,第三代SBD采用了JBS结构,将IFSM特性提高了约2从第二代开始。由于在JBS结构的肖特基界面上制作了微型PN结二极管,当大电流流过时,空穴通过PN结注入,减少了漂移层电阻的增加。到期的由于它们对浪涌电流的高耐受性,它们可以在没有旁路二极管的情况下安全地用于PFC电路。
审核编辑:汤梓红
-
全SiC功率模块介绍2018-11-27 0
-
SiC功率元器件的开发背景和优点2018-11-29 0
-
搭载SiC-MOSFET和SiC-SBD的功率模块2019-03-12 0
-
SiC功率模块的特征与电路构成2019-03-25 0
-
SiC功率器件概述2019-05-06 0
-
浅析SiC功率器件SiC SBD2019-05-07 0
-
SiC功率器件SiC-MOSFET的特点2019-05-07 0
-
何谓全SiC功率模块?2018-05-17 13602
-
SiC功率器件模块应用笔记2021-04-20 945
-
何谓全SiC功率模块2023-02-08 733
-
瞻芯电子SiC功率半导体产品技术提供一站式芯片解决方案2023-05-25 1218
-
TMC2023-车规级功率半导体论坛剧透丨SiC在NEV中的创新型应用2023-06-27 613
-
车规级功率模块封装的现状,SiC MOSFET对器件封装的技术需求2023-10-27 612
全部0条评论

快来发表一下你的评论吧 !

