

陶瓷封装技术及三大主要封装材料介绍
电子说
描述
集成电路密度和功能的提高推动电子封装的发展。随着现代微电子技术的创新,电子设 备向着微型化、集成化、高效率和高可靠性等方向发展,电子系统总体的集成度提高,功率密度也同步升高。电子元件长期在高温环境下运转会导致其性能恶化,甚至器件被破坏。因此,有效的电子封装需要不断提高封装材料的性能,并将电子线路布线合理化,使得电子元件在不受环境影响的同时,实现良好的散热,帮助电子系统保持良好的稳定性。
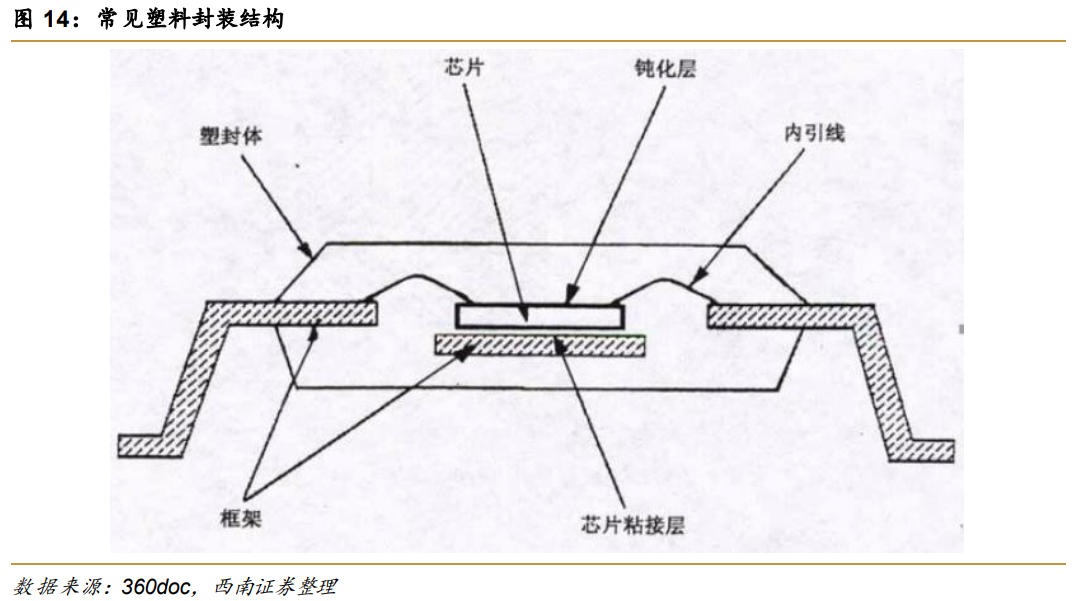
电子封装一般可按封装结构、封装形式和材料组成分类。从封装结构来看,主要包括了 基板布线、层间介质和密封材料基板,基板分为刚性板和柔性板,层间介质分为有机聚合物) 和无机(氧化硅、氮化硅和玻璃)两种起到保护电路、隔离绝缘和防止信号失真等作用。密封材料当前主要为环氧树脂,占整个电子密封材料的 97%以上,环氧树脂成本低、产量大、 工艺简单。从封装形式来看,可分为气密封装和实体封装。气密封装是指腔体内在管芯周围 有一定气体空间与外界隔离,实体封装指管芯周围与封装腔体形成整个实体。从材料组成分来看,主要分为金属基、陶瓷基和塑料基封装材料。

电子封装基本分类,数据来源:《电子封装材料的研究现状及趋势》
陶瓷封装在高致密封装中具有较大发展潜力。陶瓷封装属于气密性封装,主要材料有 Al2O3、AIN、BeO 和莫来石,具有耐湿性好、机械强度高、热膨胀系数小和热导率高等优 点。金属封装的主要材料包括 Cu、Al、Mo、W、W/Cu 和 Mo/Cu 合金等,具有较高的机械强度、散热性能优良等优点。塑料封装主要使用的材料为热固性塑料,包括酚醛类、聚酯类、 环氧类和有机硅类,具有价格低、质量轻、绝缘性能好等优点。此外,电子封装还常用四大 复合材料,分别为聚合基复合材料(PMC)、金属基复合材料(MMC)、碳/碳复合材料(CCC) 和陶瓷基复合材料(CMC)。

三大主要封装材料
对于集成电路等半导体器件来说,封装基板需要满足以下六点要求:
(1)高热导率,器件产生的热量需要通过封装材料传播出去,导热良好的材料可使芯片免受热破坏;
(2)与芯 片材料热膨胀系数匹配,由于芯片一般直接贴装于封装基板上,两者热膨胀系数匹配会降低芯片热应力,提高器件可靠性;
(3)耐热性好,满足功率器件高温使用需求,具有良好的热稳定性;
(4)绝缘性好;
(5)机械强度高,满足器件加工、封装与应用过程的强度要求;
(6)价格适宜,适合大规模生产及应用。
六大优势促使陶瓷封装成为主流电子封装。陶瓷基封装材料作为一种常见的封装材料, 相对于塑料封装和金属封装的优势在于:
(1)低介电常数,高频性能好;
(2)绝缘性好、可靠性高;
(3)强度高,热稳定性好;
(4)热膨胀系数低,热导率高;
(5)气密性好,化学性 能稳定;
(6)耐湿性好,不易产生微裂现象。 典型电子封装材料性能对比

封装工艺形式多样,适配各类应用需求。我们以光模块的封装为例,TOSA 和 ROSA 的主要封装工艺包括 TO 同轴封装、蝶形封装、COB 封装和 BOX 封装。TO 同轴封装多为 圆柱形,具有体积小、成本低、工艺简单的特点,适用于短距离传输,但也存在散热困难等缺点。蝶形封装主要为长方体,设计结构复杂,壳体面积大,散热良好,适用于长距离传输。COB 即板上芯片封装,将芯片附在 PCB 板上,实现小型化、轻型化和低成本等,BOX封装 属于一种蝶形封装,用于多通道并行。此外,其余常见的封装方式包括双列直插封装(DIP)、 无引线芯片载体(LCC)等等。

TO 同轴封装激光器示意图

蝶形封装激光器示意图
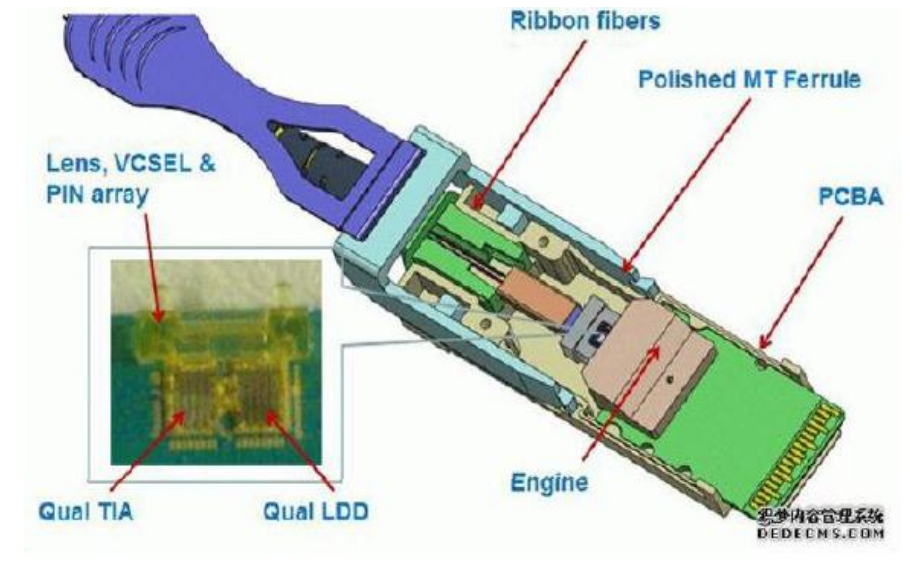
COB 封装收发器示意图
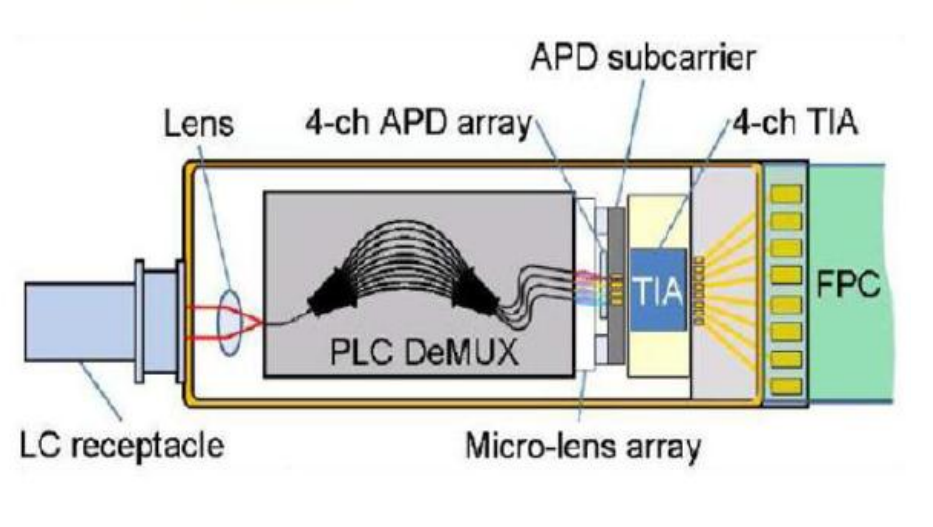
BOX 封装接收器示意图
他常见封装方式简介
| 封装方式 | 简称 | 简介 |
| 晶体管外形封装 | TO封装 | 插装型封装之一,由一个TO管座和一个TO管帽组成。TO管座作为封装元件的底座并为其提供电源,而管帽则可以实现平稳的光信号传输。这两个元件形成了保护敏感元器件的密封封装。 |
| 双列直插式封装 | DIP | 插装型封装之一,引脚从封装两侧引出,可以直接焊在有DIP结构的芯片插座上,或焊在有相同焊孔数的焊位中。其特点是可以很方便地实现PCB板的穿孔焊接,和主板有很好的兼容性,封装材料有塑料和陶瓷两种。 |
| 插针网格阵列封装 | PGA | 插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基板。用于高速大规模逻辑LSI电路。一般有CPGA(陶瓷针栅阵列封装)以及PPGA(塑料针栅阵列封装)两种。 |
| 小外形封装 | SOP | 是一种表面贴装式封装,引脚从封装两侧引出呈海鸥翼状。常见的封装材料有:塑料、陶瓷、玻璃、金属等,目前已发展出TSOP、VSOP等多种形式。 |
| 带引脚芯片载体 | LCC | 表面贴装型封装之一,引脚从封装的四个侧面引出,是高速和高频IC用封装,按材料的不同又细分为PLCC(塑料封装)、CLCC(陶瓷封装)。 |
| 球栅阵列封装 | BGA | 表面贴装型封装之一,在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封又可以细分为PBGA、CBGA等 |
| 芯片级封装 | CSP | CSP封装可以让芯片面积与封装面积接近1:1的理想情况,与BGA封装相比,同等空间下CSP封装可以将存储容量提高三倍,具有体积小、输入/输出端数多以及电气性能好等优点。 |
| 板上芯片封装 | COB | 是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。COB是最简单的裸芯片贴装技术,但封装密度较差。 |
审核编辑:郭婷
-
集成电路芯片封装技术教程书籍下载2012-01-13 0
-
半导体封装的原材料有哪些?2015-11-26 0
-
陶瓷封装产品的6大优点2016-01-18 0
-
陶瓷封装和塑料封装哪个更好?优缺点对比更明显~2019-12-11 0
-
陶瓷封装基板——电子封装的未来导向2021-01-20 0
-
芯片荒半导体封装需求激增,斯利通陶瓷封装基板供不应求2021-03-31 0
-
为什么要选择陶瓷基板作为封装材料?2021-04-19 0
-
8引线陶瓷封装类型规格(C8)2021-04-22 401
-
电子封装之陶瓷封装介绍2022-07-25 8965
-
IC产业链中的陶瓷封装工艺流程2022-08-31 4496
-
陶瓷封装SiP腔体结构介绍2023-02-10 2966
-
FemtoClock NG 陶瓷封装 XO 和 VCXO 订购信息2023-03-16 131
-
陶瓷封装基板在微波器件中的应用研究2023-06-29 487
全部0条评论

快来发表一下你的评论吧 !

