

半导体先进封装市场简析(2022)
描述
以系统应用为出发点,各种技术进行异质整合的先进封装技术持续演进。先进封装也称为高密度先进封装HDAP(High Density Advanced Package)。 采用了先进的设计思路和先进的集成工艺、缩短引线互连长度,对芯片进行系统级封装的重构,并且能有效提高系统功能密度的封装。现阶段的先进封装是指:倒装焊(FlipChip)、晶圆级封装(WLP)、2.5D封装(Interposer、RDL)、3D封装(TSV) 与传统封装相比,先进封装的应用范围不断扩大,根据Yole数据,预计到 2026 年将占到整个封装市场的 50% 以上。半导体先进封装市场简析(2022)”报告从半导体先进封装发展背景、半导体先进封装定义、半导体先进封装市场结构及规模、半导体先进封装产业链图谱、半导体先进封装产业竞争格局进行分析。







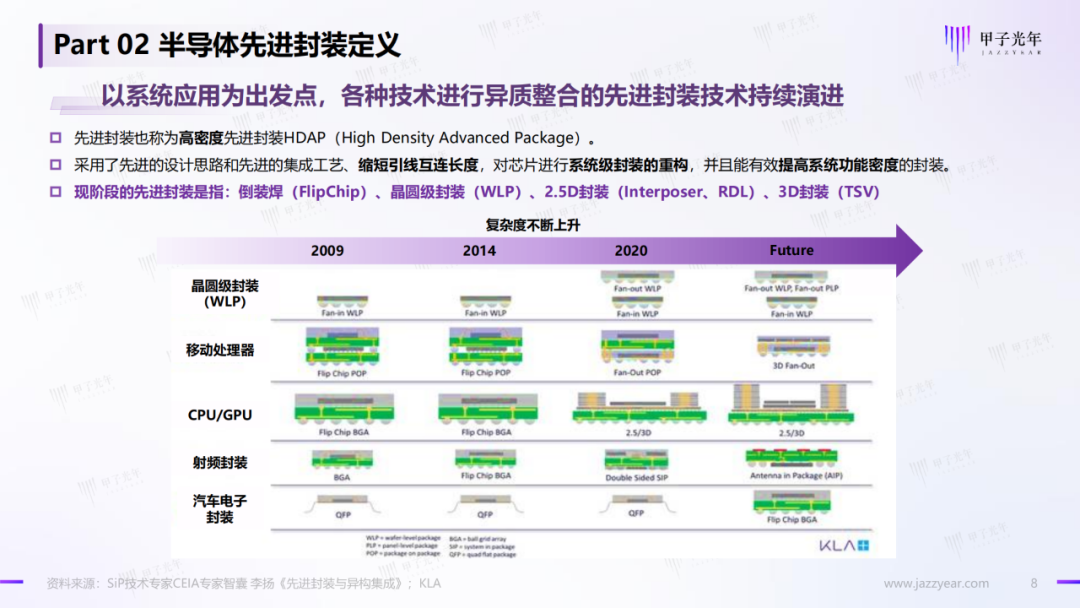





审核编辑 :李倩
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
国产设备如何立足半导体市场2008-08-16 0
-
半导体库存水位上涨 半导体市场回暖趋势明显2012-06-12 0
-
全球半导体市场进入供大于求的局面2013-01-30 0
-
招聘半导体封装工程师2015-02-10 0
-
我国半导体封装业发展状态和方略2018-08-29 0
-
浅析化合物半导体技术2019-06-13 0
-
半导体材料市场构成分析2021-01-22 0
-
全球功率半导体市场格局:MOSFET与IGBT模块2022-11-11 0
-
半导体芯片的制作和封装资料2023-09-26 0
-
国内首条先进半导体封装测试示范产线启动2019-04-17 7550
-
国内最近的三条半导体新闻首条先进半导体封装测试示范产线启动2019-04-20 5116
-
芯和半导体参加“半导体制造与先进封测论坛”并发表演讲2022-11-01 1404
-
先进封装已经成为半导体的“新战场”2023-06-16 219
-
半导体先进封装技术2024-02-21 411
全部0条评论

快来发表一下你的评论吧 !

