

等离子体刻蚀工艺简介
描述
金属刻蚀
铝刻蚀可以使用多种不同的酸,其中最普遍的混合液是以磷酸(H3P04,80%)、醋酸(CH3COOH,5%)、硝酸(HN03,5%)和水(H20,10%)所组成的混合物。45乜时,纯铝的刻蚀速率大约为3000A/mino铝刻蚀的机制和硅刻蚀类似:HN0使铝氧化并形成铝的氧化物,而H3PO4会溶解A12O3,氧化和氧化物溶解这两个过程同时进行。
先进IC生产中,铝图形化的刻蚀不再使用湿法过程,湿式过程只用来测试PVD铝薄膜的质量,但有一些小公司和大学实验室仍使用这种工艺。
先进半导体制造中最普遍使用的金属湿法刻蚀是在镍金属硅化物形成后的镍剥除(见下图)。一般使用双氧水(H2O2)和硫酸(H2SO4)形成1:1混合液选择性刻蚀掉镍金属,这样可以使二氧化硅和硅化镍保持完整。这种刻蚀过程和其他金属湿式刻蚀类似。当H2O2氧化金属镍形成NiO时,H2SO4与Ni()2反应形成可溶解的NiSO4。
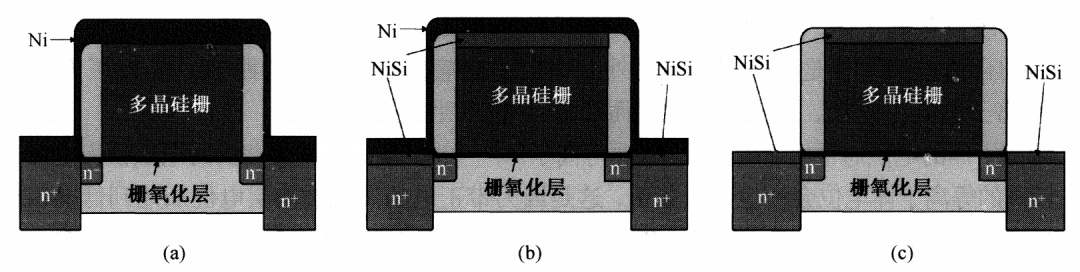
醋酸(CH3COOH;浓度为4%〜10%的水溶液,也就是醋)是一种腐蚀性和易燃液体,具有强烈的醋味。直接接触醋酸会引起化学灼伤。高浓度的醋酸气体会导致咳嗽、胸痛、反胃和呕吐。过氧化氢(H2O2)是一种氧化剂,直接接触会造成皮肤和眼睛的刺激和灼伤。高浓度H2O2气体会造成鼻子和咽喉严重不适。
H2O2很不稳定且在储藏时会自行分解。硫酸(H2SO4)具有腐蚀性,直接接触会造成皮肤灼伤,即使是稀释后的硫酸也会引起皮肤疹。高浓度的硫酸气体会造成皮肤、眼睛和肺的严重化学灼伤。
等离子体(干法)刻蚀工艺
等离子体刻蚀简介
干法刻蚀工艺使用气态化学刻蚀剂与材料产生反应来刻蚀材料并形成可以从衬底上移除的挥发性副产品。等离子体产生促进化学反应的自由基,这些自由基能显著增加化学反应的速率并加强化学刻蚀。等离子体同时也会造成晶圆表面的离子轰击,离子轰击不但能物理地从表面移除材料,而且能破坏表面原子的化学键,并显著提高刻蚀的化学反应速率。这也是为什么一般干法刻蚀都是等离子体刻蚀的缘故。
20世纪80年代后,当图形尺寸小于3am时,等离子体刻蚀逐渐取代湿法刻蚀成为所有图形化刻蚀的技术。湿法刻蚀的等向性刻蚀轮廓无法达到小的几何图形需求。由于离子轰击会伴随等离子体的存在,所以等离子体刻蚀是一个非等向性刻蚀过程,它的横向刻蚀深度和CD损失远比湿法刻蚀小。下表是湿法和干法刻蚀对照表。

等离子体刻蚀基本概念
等离子体为一种带有等量正电荷和负电荷的离子化气体,由离子、电子和中性的原子或分子组成。等离子体中三个重要的碰撞为离子化碰撞、激发-松弛碰撞和分解碰撞。这些碰撞分别产生并维持等离子体,造成气体辉光放电并产生增强化学反应的自由基。
平均自由程(MFP)是一个粒子与另外一个粒子碰撞前移动的平均距离。降低压力将增加MFP和离子的轰击能量,同时也能散射而形成垂直的刻蚀轮廓。
等离子体的电位通常比电极高,因为当等离子体产生时,质量小且移动快的电子使得电极带负电。较高的等离子体电位会产生离子轰击,这是因为带正电的离子被鞘层电位加速到低电位电极上。电容双耦型等离子体中,增加射频功率能增加离子轰击的流量和能量,同时也能增加自由基的浓度。
由于刻蚀是一种移除过程,因此必须在较低压力下进行。长平均自由程有助于离子轰击和副产品的移除。某些刻蚀反应室也使用磁场线圈产生磁场以增加低压下(小于100mTorr)的等离子体密度。作为一种移除工艺,等离子体刻蚀比PECVD需要更多的离子轰击。因此在一般的刻蚀中,晶圆都被放置在较小面积的电极上利用自偏压获得更强的离子轰击。
低压下维持高密度等离子体是刻蚀和CVD工艺过程的需要,然而一般使用的电容耦合型等离子体源无法产生高密度等离子体。感应式耦合型等离子体(ICP)与电子回旋共振(ECR)等离子体源已被开发并应用在IC制造中。经过使用分开的偏压射频系统,ICP和ECR系统能独立控制流量和离子轰击能量。
审核编辑:刘清
-
PCB多层板等离子体处理技术2013-10-22 0
-
PCB电路板等离子体切割机蚀孔工艺技术2017-12-18 0
-
PCB板制作工艺中的等离子体加工技术2018-09-21 0
-
【转帖】干法刻蚀的优点和过程2018-12-21 0
-
微波标量反射计可测量大范围的等离子体密度2019-06-10 0
-
等离子体光谱仪的原理是什么?2019-10-09 0
-
低温等离子体废气处理系统2022-04-21 0
-
TDK|低温等离子体技术的应用2022-05-17 0
-
等离子体应用2022-05-18 0
-
中微等离子体刻蚀设备Primo AD-RIE(TM)运抵中芯国际2012-03-22 1106
-
中微推出电感耦合等离子体刻蚀设备用于批量生产存储芯片和逻辑芯片前道工序2018-04-18 2137
-
中微自研5纳米等离子体刻蚀机经台积电验证2018-12-29 0
-
中微发布了第一代电感耦合等离子体刻蚀设备2020-04-22 4175
-
半导体制造之等离子工艺2022-11-15 2872
全部0条评论

快来发表一下你的评论吧 !

