

如何区分HBT、PHMET和MESFET
模拟技术
描述
LNA的应用方向
PHMET是继MESFET之后最适合用于低噪放设计的管子。FET中的主要噪声源是热杂散,主要是由于管子的通道中的载流子的随机运动造成的。载流子的随机运动导致了电流的不规则变化,由此而产生了噪声。栅极和通道之间存在的耦合电容,使得总噪声是由栅极噪声减去漏极噪声得到。这是FET管子独具的特点,使得其具有优异的低噪声特性。
为了得到一个最优的噪声特性,可以通过两个方法:一个是降低由电阻引入的噪声源(这个和器件本身的特性有很大关系),另外一个尽可能的提高电流增益的介质频率ft。第二个方法需要在器件设计的时候考虑最大的跨导、最小的栅极电容,以及合适的偏置电路。
通常来说,在Idss/10的条件下可以得到最小的噪声系数。虽然这种情况下MESFET和HEMT所需要的偏置会有差别,但是HMET的Ids的范围要比MESFET更宽。
最大增益和最小噪声系数所对应的偏置通常是不同的甚至是相互矛盾的,因此必须要在两者之间做折中的设计。HEMT的Ids的范围更广,因此在设计增益和噪声系数都考虑到的电路时候,选择范围更广,两者的影响相对较小。
高增益往往需要器件在设计的时候充分考虑在通道的下面应用异质结或者其他形式的缓冲区,最大限度地减小载流子的注入、减小输出电导。
高掺杂的应用为HBT打开了更广的应用场景,能够应用在一些宽带、低噪声的场景中。有针对噪声特性的研究数据表明了,PHMET能够提供比MESFET更小的偏置电流敏感性vs噪声性能。
InP基的HEMT能够提供性能极好的低噪声特性。InP的器件通常也是光电领域最优的选择,在光电领域通常需要考虑兼容InP的光器件、工作频率超过40GHz。下图显示了不同材料、不同管子工作频率vs噪声系数的关系。
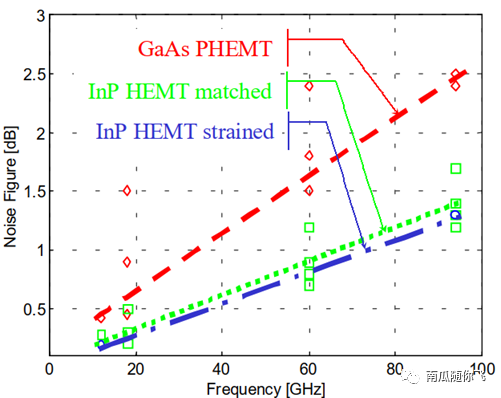
从图中可以看到InP的HEMT采用了晶格匹配和应变设计的方案下,90GHz对应的噪声系数在1.2dB左右。
HBT在低频段的噪声通常比较小。通过优化设计偏置电路能够减小管子的非线性性带来的影响,这样可以在变频的时候获得更好的频率特性。同时HBT的振荡器也可以实现很小的相位噪声。
PA的应用方向
功放的关键指标包括了1dB压缩点、饱和功率、三阶交调、PAE,相比于低噪声放大器要考虑的指标更多。设计功放最成熟的方案就是采用MESFET,但是并不是功放设计的最优的方案,特别是当工作频率逐渐变高的时候。在高频工作情况下,对栅极的长度要求越小、通道的厚度越薄。高掺杂浓度能够保证Ids的性能,进一步降低击穿功率。
尽管有这些限制,在文献【1】中提出了一种MESFET,栅极外围大小600um,工作频率为18GHz,0.53W/mm的功率特性。
文献【2】中提出了一个中MESFET,在Al2O3上利用GaAs制备了0.3um的栅极,在工作频率8GHz下,PAE为89%,增益为9.6dB,0.12W/mm的输出功率,3v的偏置电压Vds。
下图总结了HEMT、MESFET、HBT的功率特性。
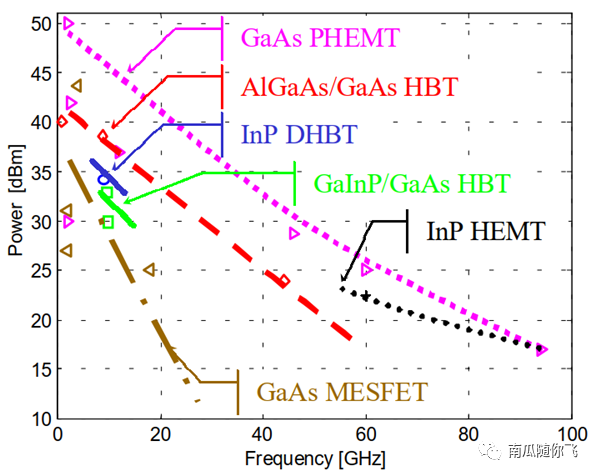
从图中可以看到AlGaAs\\GaAs的 HEMT相比于MESFET在高频率下的功率增益性能更优。
但是这些器件因为导带的不连续性,使得器件本身受限于载流子密度ns(1012cm-3),进一步限制了电流和功率。
尽管这样,在文献【3】中还是提出了一种HEMT,栅长86.4mm,频率2.1GHz,功率100W。
通过增加异质结通道和减小导带的不连续性能够进一步的提高器件的功率性能。
- 增加异质结通道的方法能够提高总的载流子密度,同时又能够保证单通道相同的密度下避免击穿。
- 减小导带的不连续性可以利用PHEMT的方案,InxGa1-xAs材料提到了GaAs,来构建通道,其中x通常取值0.2。通道厚度为150Å PHEMT的载流子密度通常在4×1012cm-3,因此可以得到超过1A/mm的电流。文献【4】通过这种方法,在工作频率44.5GHz,栅长1800um的PHMET,功率为0.44W/mm.
另外,在InP的衬底上面制备HEMT也能够提高载流子密度,进而提高电流Ids。同时InP的衬底能够提供更好的热导率,但是从工艺成熟角度、成本优势方面来看,InP的优势要比GaAs弱很多。
很多功率器件都采用了PHEMT,从技术的角度来看,未来可以通过采用双凹槽和不对称凹槽进一步提高PHEMT性能。
另外,InP的HEMT因为InGaAs的禁带宽度较小,导致了其击穿电压受到限制。通过采用InGaAs-InP复合的方式来构建通道能够一定程度上改善这个问题。
回退功率PHMET对于高线性度的PHEMT来说是一个非常重要的指标。对于HBT来说, 它在线性度方面有更好的优势,HBT在一个合适的PAE下的输入功率下,能够保证优异的线性度。
HBT在面向功率应用的小型化、高效率芯片方面有较好的优势。尽管相对于PHEMT在工艺成熟度上有一定的弱势,但是它能够提供更高的击穿电压、更好的阈值电压一致性以及指数性的转移特性。
很重要的一点需要考虑的是散热的问题,不管是自身的发热还是由于旁边的器件发热传导。工作在连续波还是工作在脉冲模式下都有所不同,但是这样的区别在FET器件中并不是特别明显。
文献【5】中提出的大信号模型的HBT,考虑了散热效应,得到了一个较好的实验结果。热稳定级联 (TSC) HBT与传统 HBT 相比,升温效应更低,同时提供更高的增益。
其他方法还包括用于从芯片顶部散热的热分流器,但这些方法通常会增加技术成本。
另外,InP的器件为高增益和高频的应用提供了很好的解决方案。因其在高频谐波的电流消除,使得这一类的器件非常适合于高线性度的设计。但是其成本往往是GaAs或者其他器件的好几倍,在面向市场化应用的时候往往局限在一些对成本敏感性较低的方向。
高频特性
PHEMT的高频特性较好,很适合用在注入毫米波频段,在高频下其增益特性、噪声以及功率特性都能保持较好的性能。
下图表示了不同的管子的频率特性。随着应用频段向毫米波频段发展,如5G、卫星通信、雷达、导引头等民用或军用方向,PHEMT的应用也将不断增加。
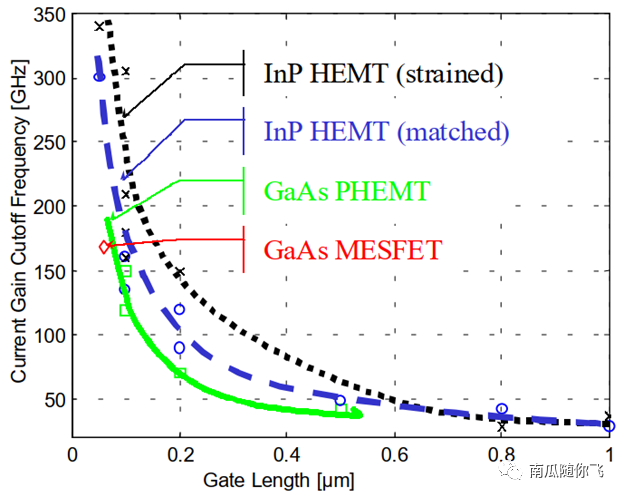
InP的HEMT在面向高频化的应用有更好的优势,在毫米波频段下,能够保持较低的噪声的同时有较高的增益。基于GaAs和InP的HBT虽然也能够较好地工作在较高频段,例如fmax=250GHz,但是相对于HEMT的频率还是要低了很多。
可靠性
可靠性也是选择管子的一个重要参考指标。MESFET、PHEMT的稳定性较好,HBT随着技术的发展在稳定性方面也得到了较大的发展。
与管子可靠性相关的因素典型的有:
- FET封装时的氢扩散,这会导致阈值电压Vth变化。
- 由于半导体通道中肖特基栅极金属(如Ti/Pt/Au)的交散而引起的栅极下沉也会导致Vth位移,可以通过插入金属(如Mo)在一定程度上进行控制。
PHEMT的可靠性在很多应用方向都不错,相比之下InP的HEMT在这方面就要差上一个数量级。这可能是因为供体材料变化相关的热稳定性有关。
也是选择管子的一个重要参考指标。MESFET、PHEMT的稳定性较好,HBT随着技术的发展在稳定性方面也得到了较大的发展。
在HBT中观察到基极-发射极结变化,这是由于基极掺杂剂扩散和缺陷形成对器件工作区域至关重要,直接导致了增益随时间的变化。
AlGaAs/GaAs的HBT的寿命与工作电流密度成平方反比。从温度相关的测试中得到的激励能力要明显低于1.5V。这意味着首先需要降低工作电流密度和控制器件温度,这两者都会阻碍器件在电路中的使用。通过采用更大的器件尺寸来补偿这种效应是不可取的,因为这将降低器件阻抗,使得匹配电路能难实现。材料和工艺的提升使得结节在120℃的温度下能够保证长达109个小时的可靠性。
参考文献:
[1] G. Gaquière et al., IEEE Trans. on ED, Vol. 42, February 1995, pp. 209-214
[2] T. Jenkins et al., GaAs IC Symposium, Atlanta, GA, 1998, pp.259-262
[3] S. Goto, GaAs IC Symposium, Atlanta, GA, Nov. 1998, pp. 77-80
[4] P. Smith et al, IEEE MTT-S Digest, 1994, pp. 809-812
[5] S. H. Shu et al., Topical Workshop on Heterostructure Microelectronics for Information Systems Applications, Shonan Village, Japan, August 1998
-
Evaluating the IBM43RF0100 SiGe HBT for CDMA Driver Applications at 1.9 GHz2009-05-12 0
-
MESFET集成电路应用-概述2009-08-20 0
-
MESFET 大信号特性2013-05-26 0
-
LS HBT模型改善了GaAs和InP技术的收集器传输时间2019-08-02 0
-
MOSFET、MESFET、MODFET有何区别2022-01-25 0
-
LPS25HBT设计外壳的边界条件是什么?2023-02-03 0
-
MAX11014, MAX11015 RF MESFET放大2008-12-20 755
-
MESFET集成电路应用2011-10-28 647
-
SiCOI MESFET的特性分析2012-02-22 678
-
半导体合格测试报告:MESFET-A(QTR:2013-00244)2021-04-21 377
-
半导体合格测试报告:MESFET-D(QTR:2013-00256)2021-04-24 367
-
半导体合格测试报告:MESFET-B(QTR:2013-00245)2021-05-08 425
-
半导体合格测试报告:MESFET-F(QTR:2013-00247)2021-05-09 339
-
GaAs双栅MESFET的PSPICE直流模型2021-09-18 491
全部0条评论

快来发表一下你的评论吧 !

