

易于实现且全面的3D堆叠裸片器件测试方法
描述
当裸片尺寸无法继续扩大时,开发者开始考虑投入对 3D 堆叠裸片方法的研究。考虑用于 3D 封装的高端器件已经将当前的可测试性设计 (DFT) 解决方案推向了极限。
如果设计人员已经几乎无法平衡工具运行时间、片上面积需求、向量数量和测试时间,他们如何在 3D 器件上去实现 DFT 呢?
3D IC 测试简介
几种设计趋势相结合,显著增加了 IC 测试生成所需的计算资源。首先是设计规模和复杂性的增长。与此同时,可用于 2D 封装测试访问的 I/O 更少了。
这些因素也导致测试覆盖率、良率、功耗和互连测试要求承受巨大压力。3D 裸片堆叠和封装是改进系统级封装技术的重要一步。3D 裸片堆叠有多种方法,但它们的共同目标是使用尺寸更小且良率高的裸片进行垂直堆叠。这种策略缓解了大型 2D 或 2.5D 器件的许多测试挑战。
在对 3D 堆叠中组装的裸片进行晶圆探针测试时,建议采用高质量的已知良好裸片 (KGD) 测试。KGD 测试通常包括除裸片间互连测试以外的所有封装测试。
然后,封装测试需要进行裸片间 (D2D) 互连测试并重新运行 KGD 测试,以确保封装和组装期间没有引入任何缺陷。每个级别的 3D 测试都需要进行故障诊断,包括完整的封装级堆叠层诊断。
在本文中,我们详细介绍了一种灵活可扩展、易于实现且全面的 3D IC DFT 解决方案。
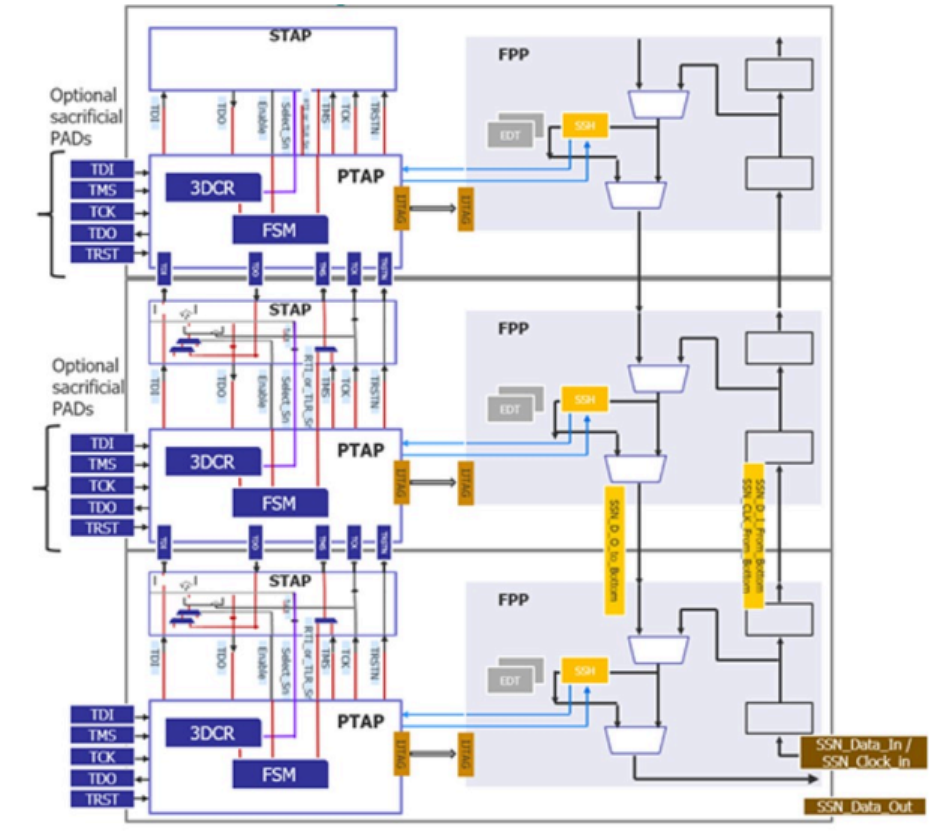
图 1:Tessent 3D DFT 解决方案概述
审核编辑:刘清
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
世界首款 BeSang 3D芯片诞生2008-08-18 0
-
裸眼3D***领域开启新纪元2012-07-31 0
-
裸眼3D显示技术原理2012-08-17 0
-
裸眼3D显示专家2012-08-17 0
-
OSRAM 的 Multi CHIPLED 成就了优质的裸眼3D LED显示器2013-11-18 0
-
3D PCB封装库2015-08-06 0
-
AD6中建立器件简易3D模型的方法2016-11-30 0
-
裸眼3D智能手机壳怎么用?2017-12-27 0
-
AD+Solidworks配合=3D模型相关问题2018-07-12 0
-
TI如何融入3D打印机技术2018-09-11 0
-
3D混合制造技术介绍2019-07-08 0
-
3D显示技术的发展现状及未来趋势2020-11-27 0
-
介绍一种裸眼3D单芯片的解决方案2021-06-01 0
-
如何去实现246Echarts - 3D曲面的源代码呢2021-12-20 0
-
裸眼3D显示应用2022-11-07 0
全部0条评论

快来发表一下你的评论吧 !

