

浅谈QFN成熟封装技术
电子说
描述
经过多年积累,长电科技目前可为全球客户提供多样化的封装技术解决方案,包括Lead Frame打线封装、Laminate打线封装、fcBGA倒装封装、fcCSP倒装封装、SiP系统级封装、WLCSP/eWLB/ECP等扇入型/扇出型晶圆级封装、PoP堆叠封装、2.5D/3D芯片堆叠封装、以及XDFOI Chiplet系列晶圆级封装等技术。
在持续发力先进封装技术的同时,长电科技也不断推动传统封装技术的先进化,使其满足日益多元化的应用需求。
以四方扁平无引脚(QFN)封装为例,作为一种基于引脚框架的塑封芯片级封装(CSP),长电科技QFN可为客户提供对尺寸、重量以及热性能和电气性能具有高要求的解决方案。QFN的电气连接是通过位于元件底部的焊盘连接到PCB表面实现的。QFN封装已被证明可成功用于许多应用,例如无线手机、电源管理、模拟基带和蓝牙设备。长电科技的QFN和双扁平无引线(DFN)封装产品包括QFNs、QFNp、VQFN、WQFN、UQFN、XQFN、QFNp-dr和QFNs-mr。
长电科技针对QFN后道可以采用冲压或封装成品切割方式。冲压分离是在封装流程的最后把塑封过的封装体通过冲压的方式从整条框架上分离出来,而以阵列式排布的封装体可以通过封装体切割的方式在最终的切割工序里把单颗的元器件分离出来。
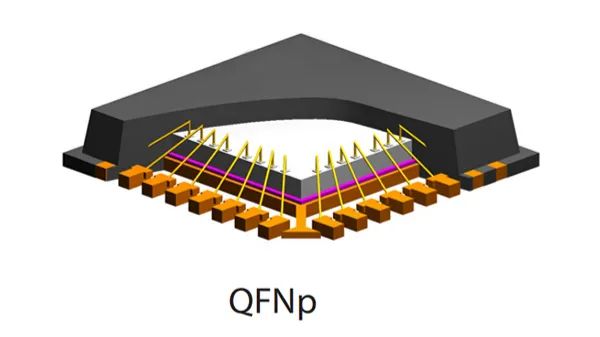
QFNp是一种通过冲压方式分离的封装方式,具有薄、轻的外形和出色的散热性能。QFNp提供比传统引线框架封装更紧凑、性能更高且更具成本效益的解决方案,尤其适用于移动和手持应用。
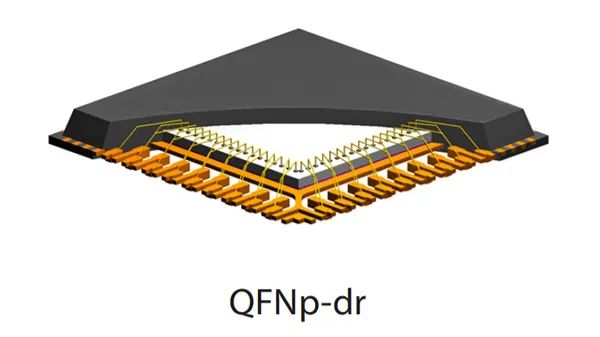
QFNp-dr是一种冲压方式的双排封装,具有在更小的面积中可显著增加I/O引脚数量。提高QFNp-dr性能的关键是在其具有两排交错I/O的引线框架设计中带有裸露芯片焊盘的引脚用于芯片接地和改进的热性能。
封装切割方式的多排QFN(QFNs-mr)封装是通过切割形成的封装体并呈现出正方形或者长方形的LGA形式。通过使用切割制造工艺,在相同的封装尺寸中可以以多层形式为客户提供更多I/O数量。
技术亮点
冲压或者成品切割方式
产品封装尺寸从1.0×1.3mm到12×12mm
引脚数量从4到156
引脚间距:0.40、0.50、0.65和0.80mm
提供引脚数量、引脚间距定制化
产品封装厚度:0.45、0.55、0.75、0.85和0.90mm
提供金线或铜线键合
多晶片(die)封装
提供JEDEC定义的多种厚度选择(V、W、U、X)
产品重量减少33%(16L TSSOP vs. 16L QFN)
产品尺寸占用电路板面积减少50%(16L TSSOP vs. 16L QFN)
✦
长电科技拥有持续优化的量产解决方案,依托全员参与,持续改善的方针,不断提升技术水平,从而提升客户产品开发速度,助力其市场开拓。
审核编辑 :李倩
-
QFN32封装下载2008-05-14 0
-
QFN封装库全集 (protel封装)2007-06-01 8043
-
QFN封装2006-04-01 1933
-
四侧无引脚扁平封装(QFN),四侧无引脚扁平封装(QFN)是2010-03-04 3950
-
QFN封装的特点有哪些?2010-03-04 1801
-
QFN封装技术入门知识2011-09-06 2760
-
甚薄型QFN封装技术2018-01-10 5247
-
qfn封装怎么焊接_qfn封装焊接教程2018-01-10 97912
-
qfn封装形态封装尺寸图_qfn封装的特点2018-01-11 124144
-
QFN封装是什么?有什么特点?2018-08-23 59877
-
QFN封装应该怎么焊接?2021-02-20 7976
-
浅谈QFN封装工艺流程2023-04-19 3864
-
宇凡微QFN20封装介绍,QFN20封装尺寸图2023-07-17 1511
-
什么是QFN封装?手动焊接QFN封装方式2024-01-13 2980
全部0条评论

快来发表一下你的评论吧 !

