

浅谈封装测试工艺及封装形式发展
制造/封装
描述
粘划片方式有向下、向上两种模式,对芯片表面及背面的崩齿(缺损)有影响。
高度:芯片背面Si屑、崩齿的情况有影响。

封装形式的发展

SGNEC现有封装形式

SGNEC组立发展过程

组立流程

划片工艺

从设备上区分有:金刚石划片和激光划片两种。由于激光划片设备昂贵,金刚石划片是目前较为流行的。
半切作业流程
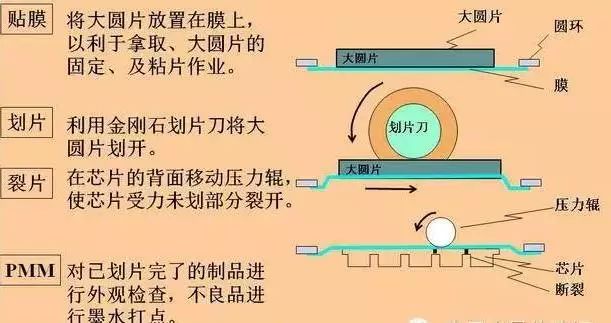
全切作业流程

划片刀

划片外观检查
划伤:划伤是由于芯片表面接触到异物:如镊子,造成芯片内部的AI布线受到损伤或造成短路,而引起的不良。
缺损:缺损是由于芯片的边缘受到异物、或芯片之间的撞击,造成边缘缺损,有可能破坏AL布线或活性区,引起不良。
崩齿:由于大圆片为Si单晶体,在划片时就不可避免的形成崩齿,崩齿的大小与划片刀的种类有关,崩齿过大造成缺损。
粘污:粘污就是异物附在芯片表面,如:Si屑,会造成内部的短路等。
扩散:在扩散工序产生的不良,如:图形不完整等不良,也要在PMM工序予以去除。
划片参数
型号:崩齿、划伤、裂纹本身的寿命。
转速:缺损、崩齿。
速度:划片轨迹、崩齿、缺损。
方式:粘划片方式有向下、向上两种模式,对芯片表面及背面的崩齿(缺损)有影响。
高度:芯片背面Si屑、崩齿的情况有影响。
粘片工艺

封共晶合金法示意图

银浆粘片示意图
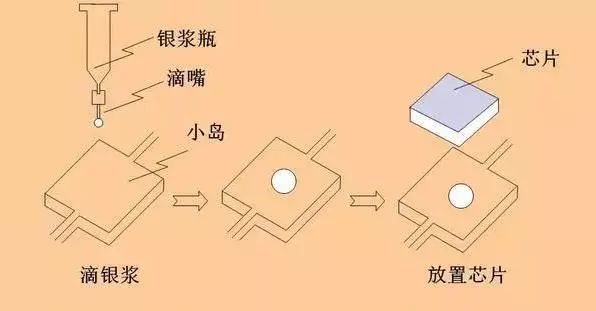
胶带粘片示意图
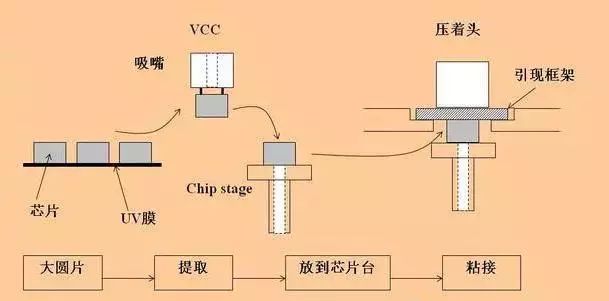
芯片的提取
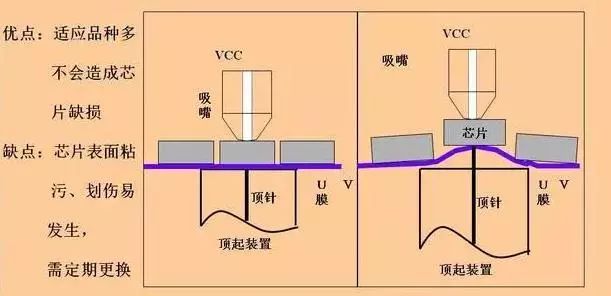
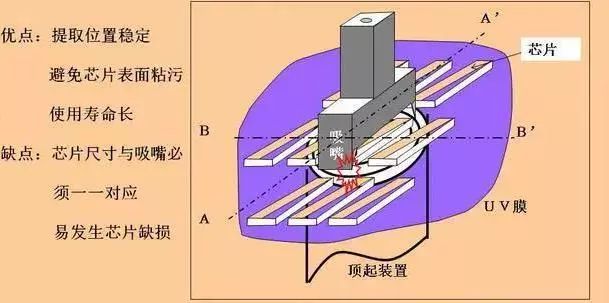
粘片的工艺控制
①粘片的位置:使键合识别稳定。
②银浆饱和度:保证粘片的强度。
③粘片机械度:芯片的固着强度。
④芯片外基准:粘污,划伤,缺损。
⑤芯片的方向:在芯片胶带的接着强度。
键合工艺原理
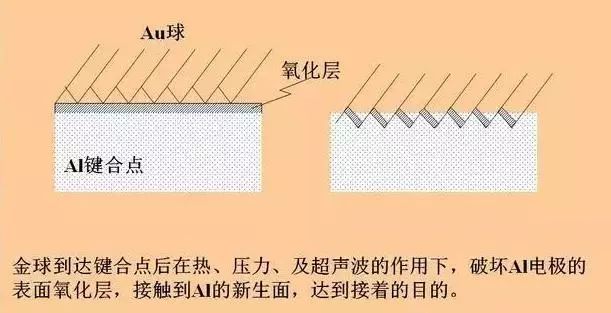
键合工艺的控制
金球压着径
金球压着厚度
金线高度
金线拉断强度
金球剥离强度
键合主要不良项目
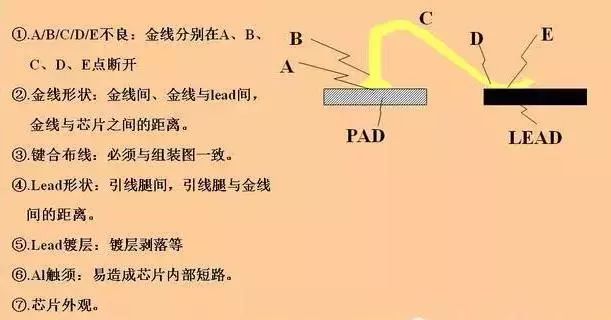
包装入库
包装的主要目的:保证运输过程中的产品安全,及长期存放时的产品可靠性。因此对包装材料的强度、重量、温湿度特性、抗静电性能都有一定的要求。
编辑:黄飞
-
#硬声创作季 #集成电路 集成电路制造工艺-08.3.3封装技术-封装技术的发展水管工 2022-10-17
-
芯片封装测试流程详解ppt2012-01-13 0
-
芯片封装测试工艺教程教材资料2012-01-13 0
-
芯片的封装发展2012-05-25 0
-
芯片封装测试需要哪些知识和测试工具?2013-12-08 0
-
分析MOS管的封装形式2018-11-14 0
-
先进封装技术的发展趋势2018-11-23 0
-
LED的封装形式和工艺等问题的解析2017-10-19 551
-
IC封装测试工艺流程2020-10-10 7731
-
封装测试工艺教育资料2021-04-08 671
-
详解半导体封装测试工艺2023-05-31 1142
-
半导体芯片封装测试工艺流程 封装工艺的主要流程是什么2023-07-19 1720
-
半导体封装测试工艺详解2023-08-17 886
-
芯片封装测试有技术含量吗?封装测试是干嘛的?2023-08-24 2936
全部0条评论

快来发表一下你的评论吧 !

