

三维封装技术介绍
描述
三维封装技术是指在二维封装技术的基础上,进一步向垂直方向发展的微电子组装技术。三维封装的形式主要分为填埋型三维封装、有源基板型三维對装和叠层型三维封装。
填埋型三维封装是将元器件填埋在基板多层布线内,或者填埋、制作在基板内部,以达到实现系统集成、功能模块化的一种新型封装方式。有源基板型三维封装采用硅圆片集成技术,在制作基板时,先采用一般半导体集成电路制作方法进行一次元器件集成化,形成有源基板;然后再实施多层布线,并将表面组装元件与表面组装器件贴在最上层,从而实现有源基板型三维封装。
叠层型三维封装是将两个或多个裸芯片或已经封装的芯片在垂直方向上、下多层互连,然后再进行封装形成三维结构。三维封装(引线键合与倒装芯片)如下图所示。
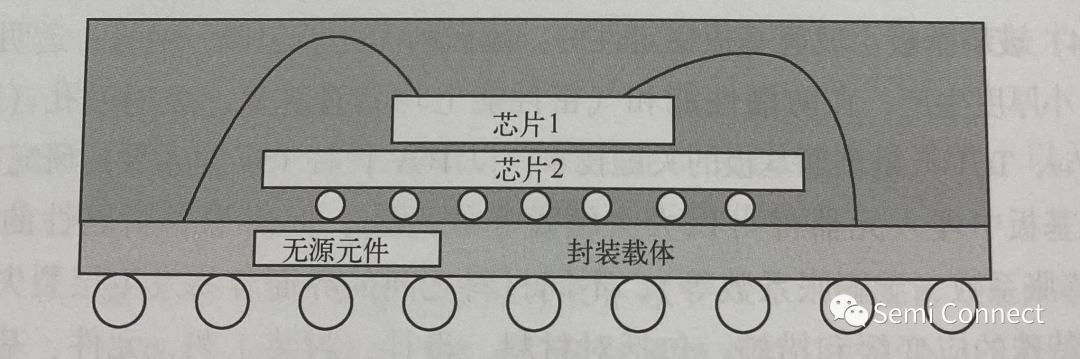
与传统的二维封装技术相比,三维封装技术具有提高封装密度、减小封装尺寸、提高信号传输速度、降低功耗和噪声、实现产品多功能化等特点。
三维互连的方法主要包括引线键合、倒装芯片、硅通孔(TSV)、薄膜导线等。其中,ISV 技术可实现芯片与芯片之间垂直方向上的互连,不需要引线键合,可以有效缩短互连线长度,减小信号传输延迟和损失,提高信号传输速度
在三维封装中,由于封装密度增加、体积减小,造成热流密度大幅度提高.因此如何解决散热问题成为重中之重。一般可以通过使用低热阻基板和高热传性能封装材料、使用冷却方法为三维器件降温,在叠层元件之间使用导热通孔将内部的热量散至表面的方法来解决散热问题。
另外,在基板内埋人热膨账系数不同的芯片会产生更为复杂的应力,需要采取特殊的应变缓和措施,因此应该对设计、封装工艺、元件、基板的结构变化、封裝设备、测量及检查、返修及元件的三维布置等进行综合研究开发。
2014 年,三维封装技术已经应用于内存芯片封装(包括大容量内存芯片堆叠)和高性能芯片的消费电子产品中。到了2015年,三维封装技术已经开始应用于一些高端的 CPU、GPU 及网络芯片中。现在,三维扇出 (苹果处理器)和采用硅通孔的三维集成(包括因像传感器、指纹传感器)器件均已实现量产。
随着三维封装技术的不断提高,轻薄化、高密度是未来的重要发展方向。未来,这一先进的封装技术将被广泛应用于各个领城,包括尖端科技产品和众多消费类电子产品等。
审核编辑:刘清
-
世界级专家为你解读:晶圆级三维系统集成技术2011-12-02 0
-
面向新兴三维视频应用的技术研究与开发2012-07-31 0
-
三维逆向工程的成果及应用案例2016-03-02 0
-
三维触控技术突破“二向箔”的束缚2016-12-19 0
-
三维快速建模技术与三维扫描建模的应用2018-08-07 0
-
广西扫描服务三维检测三维扫描仪2018-08-29 0
-
三维设计应用案例2019-07-03 0
-
三维产品动画设计价值2019-08-24 0
-
Handyscan三维扫描仪对户外大型灯箱三维扫描解决方案2020-07-15 0
-
三维立体数字沙盘是是什么?2020-08-28 0
-
晶圆级三维封装技术发展2020-12-28 0
-
三维内存的概念2021-01-29 0
-
江西南昌三维动画制作的优势2021-04-19 0
-
上海黄浦三维媒体动画技术2021-06-30 0
-
无人机三维建模的信息2021-09-16 0
全部0条评论

快来发表一下你的评论吧 !

