

金属封装工艺介绍
描述
金属封装工艺是指采用金属外壳作为封装壳体或底座,在其内部安装芯片或基板并进行键合连接,外引线通过金属-玻璃(或陶瓷)组装工艺穿过金属外壳,将内部元件的功能引出、外部电源信号等输人的一种电子封工艺。
金属外壳常采用钢、铜、铝、柯伐合金等材料,表面电镇一定厚度的镍层或镍-金层,其良好的封装气密性可以保护芯片不妥外界环境因素的影响。金属封装主要用于各类集成电路、微波器件等产品,具有良好的兼容性,使用灵活方便
金属封装典型形式如下图所示。
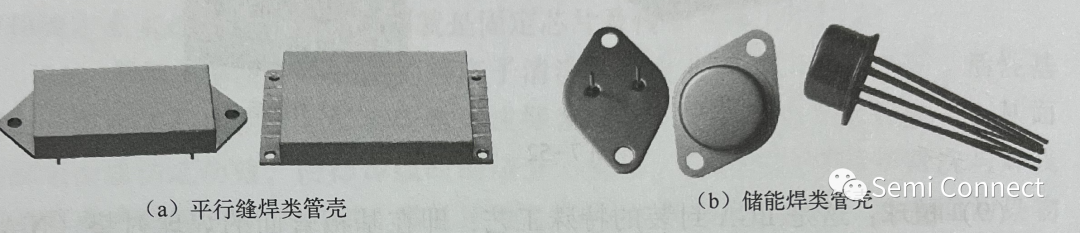
金属封装的典型工艺流程如下:

(1)装配:将PCB/陶瓷基板、芯片、贴片元件等,用环氧胶黏结或合金焊料焊按等方式装配固化于金属外壳腔体内部,起到固定元器件、保护芯片、方便后续键合引线等作用。
(2)键合:在腔体内部的,芯片、元件与外引脚之间,根据封装设计使用不同规格的金丝或(硅)铝丝等进行键合连接,起电气连接作用。常用的键合工艺包括金丝球焊键合工艺、(硅)铝线超声楔形键合工艺等。
(3)封装:利用平行缝焊、合金焊料熔封、储能焊等工艺将金属外壳的壳体或底座与管帽或盖板无断点、无缝地缝焊起来,将内部(元器件)与外界环境隔绝,使其免受外部水汽或其他气体的影响。通常在惰性气体或真空环境下进行密封,以保证腔体内部气氛处于稳定受控的状态。
(4)打标:将产品的型号、批号、编号等信息标识在金属外壳主表面,方便器件型号、批次等的识别区后期追湖。常用工艺有油墨印刷、激光打标等。
(5)检漏:按照不同的试验条件,对密封后的管壳进行粗、细检漏,剔除不合格品。程序上要求先进行细检漏,后进行粗检漏。细检漏试验种类包括示踪气体氦(He)细检漏、放射性同位素细检漏、光学细检漏等。粗检漏试验种类包括碳氟化合物粗检漏、染料浸透粗检漏、增重粗检漏、光学粗检漏等。
审核编辑:刘清
-
芯片封装工艺详细讲解2016-06-16 0
-
pcb封装工艺大全2012-03-14 0
-
【PCB封装工艺】低温低压注塑2018-01-03 0
-
505nm、785nm、808nm、940nm激光二极管TO56 封装、 500mW 100mw2023-05-09 0
-
芯片封装工艺流程-芯片封装工艺流程图2008-05-26 7429
-
“封装工艺员”课程详细介绍2010-11-16 699
-
新型封装工艺介绍2011-12-29 979
-
高可靠功率器件金属封装外壳的技术改进2017-09-12 507
-
IGBT功率模块封装工艺介绍2022-06-17 2347
-
半导体集成电路金属封装常用类型有哪些?2023-01-30 1410
-
IC封装工艺介绍2023-04-10 234
-
红外探测器金属、陶瓷和晶圆级封装工艺对比2022-10-13 1877
-
半导体后封装工艺及设备2023-07-13 657
-
简单介绍硅通孔(TSV)封装工艺2023-11-08 2640
-
金属陶瓷胶黏剂封装工艺及可靠性研究2024-03-05 152
全部0条评论

快来发表一下你的评论吧 !

