

硅晶片的酸基蚀刻:传质和动力学效应
电子说
描述
引言
抛光硅晶片是通过各种机械和化学工艺制备的。首先,硅单晶锭被切成圆盘(晶片),然后是一个称为拍打的扁平过程,包括使用磨料清洗晶片。通过蚀刻消除了以往成形过程中引起的机械损伤,蚀刻之后是各种单元操作,如抛光和清洗之前,它已经准备好为设备制造。
硅晶片的化学蚀刻是通过将晶片浸入蚀刻剂中来完成的,蚀刻剂传统上是硝酸1HF和氢氧化钾稀释剂或氢氧化钾腐蚀性溶液的酸性混合物。本文讲述了腐蚀性晶体蚀刻的各种研究,并重点关注了酸基蚀刻剂的输运和动力学效应。
实验与讨论
实验在两种不同的设置中进行。大多数实验使用图1a所示的装置进行。在高压下与可选的氮气一起注入蚀刻器。当氮被选择性地引入时,它会在液体中保持良好的混合,并且部分以气泡的形式存在。图1b所示的另一个实验装置也被用于一些单晶片实验。在酸混合物浴中,可以以不同的转速蚀刻单个晶片。
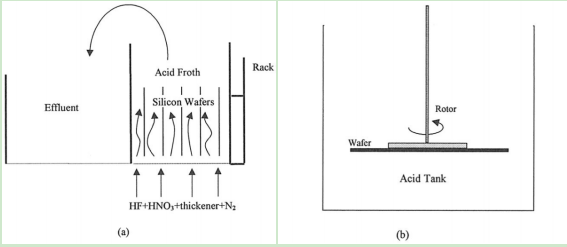 图1:(a)蚀刻硅晶片的实验组件,(b)不同转速下单晶片蚀刻的实验装置
图1:(a)蚀刻硅晶片的实验组件,(b)不同转速下单晶片蚀刻的实验装置
光滑抛光硅片的表面轮廓如图2a所示。从图中可以看出,在设备的分辨率范围内没有检测到表面不规则现象。抛光晶圆的LSP(图2b)没有显示出表面不规则性。然后,这些抛光的晶片在HF1硝酸磷酸的混合物中以5rpm的速度蚀刻。
很明显,表面的不规则性是由表面上形成的气泡引起的。随着晶片转速的增加,表面剪切强度和混合强度均有所增加。然而,非常强烈的气体喷射是不可取的,因为它可能通过降低有效传质电阻导致动力学影响条件,或通过过度的外部气泡覆盖导致蚀刻率下降。(江苏英思特半导体科技有限公司)
 图2:(a)光滑抛光晶圆的表面轮廓,光滑抛光硅片的(b) LSP
图2:(a)光滑抛光晶圆的表面轮廓,光滑抛光硅片的(b) LSP
结论
粗糙硅片是一个以平均粗糙度f为特征的峰谷场。在受传质影响的系统中,由于局部传质电阻的差异,峰处的蚀刻速率高于谷处的蚀刻速率。因此,在存在耐传质抗性的情况下,就会发生化学抛光。英思特利用所提出的现象学模型和实验数据,解释了抛光效率(实际抛光速率与最大可能抛光速率的比值)与有效传质阻力与运动阻力比值的关系。
蚀刻反应的气体产物形成了固有的气泡,掩盖了硅片表面的局部位置,这导致了表面的不规则性,这可以用气泡掩蔽效应来解释。气泡脱离表面的影响,以及气泡和高频通过传质膜的传输,这些都是一个有效的传质电阻。在没有过度气泡掩蔽效应的情况下,抛光效率随有效传质阻力与动力学电阻之比而提高,达到最佳状态,然后降低。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护。
-
电力拖动系统的动力学课件2008-11-19 0
-
[下载]想了解多体动力学软件吗?有教程分享及免费试用下载2009-03-24 0
-
基于多体系统动力学的空气悬架大客车平顺性试验仿真研究2009-12-02 0
-
四旋翼飞行器的动力学建模及PID控制2015-06-20 0
-
汽车系统动力学长篇大论2017-11-01 0
-
Agitek功率放大器在压电双晶片动力学研究中的应用2018-01-03 0
-
晶片边缘蚀刻机及其蚀刻方法2018-03-16 0
-
Aigtek高压放大器在压电双晶片动力学研究中的应用2018-11-07 0
-
气体动力学在流量测量电子技术中的应用介绍2021-04-01 0
-
飞行器动力学参数在线辨识EKF算法实验流程2021-08-27 0
-
分布式驱动电动汽车的动力学控制有哪几种类型?常见问题是什么?2021-08-30 0
-
热分析动力学2009-12-01 598
-
硅晶片的酸刻蚀实验分析2022-03-08 669
-
硅晶片的化学刻蚀和动力学效应2022-04-15 715
-
基于车辆动力学模型的横向控制2023-11-15 295
全部0条评论

快来发表一下你的评论吧 !

