

中图测量仪器适配芯片制造生产线,助力半导体行业发展
描述
近年来,面对持续高涨的芯片需求,半导体行业生产迎来了高难度挑战——对芯片工艺要求更精细,从5nm到3nm,甚至是2nm。“先进封装”的提出,是对技术的新要求,也是对封装工艺中材料和设备的全新考验。
芯片身上布控着几千万根晶体管,而晶体管越小,可放置的晶体管越多,性能也将越高。芯片的进化就是晶体管变小的过程。晶体管密度更大、占用空间更少、性能更高、功率更低,但挑战也越来越难以克服。小尺寸下,芯片物理瓶颈越来越难以克服。尤其在近几年,先进节点走向10nm、7nm、5nm......白光3D轮廓测量仪适配芯片制造生产线,致力于满足时下半导体封装中晶圆减薄厚度、晶圆粗糙度、激光切割后槽深槽宽的测量需求,助力半导体行业发展。
W1白光3D轮廓测量仪X/Y方向标准行程为140*100mm,满足晶圆表面大范围多区域的粗糙度自动化检测、镭射槽深宽尺寸、镀膜台阶高、弹坑等微纳米级别精度的测量。

台阶高精确度:0.3%
台阶高重复性:0.08 % 1σ
纵向分辨率:0.1nm
RMS重复性:0.005nm
横向分辨率(0.5λ/NA):0.5um~3.7um
特点:粗糙度测量、弹坑测量、测量尺寸6英寸以下。
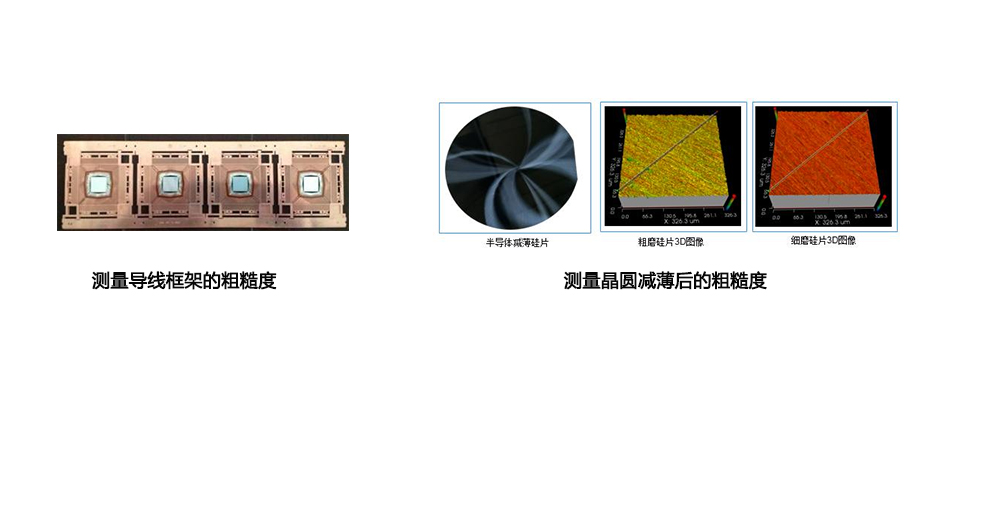
W3白光3D轮廓测量仪X/Y方向标准行程为300*300mm,超大规格平面、兼容型12英寸真空吸附盘能检测12寸及以下尺寸的Wafer;气浮隔振设计&吸音材质隔离设计,确保仪器在千级车间能有效滤除地面和声波的振动干扰,稳定工作;自动化测量半导体晶圆。

半导体领域专项功能
1.同步支持6、8、12英寸三种规格的晶圆片测量,一键即可实现三种规格的真空吸盘的自动切换以配适不同尺寸晶圆;
2.具备研磨供以后减薄片的粗糙度自动测量功能,一键可测量数十个小区域的粗糙度求取均值;
3.具备划片工艺中激光镭射开槽后的槽道深宽轮廓数据测量功能,可以一键实现槽道深宽相关的面和多条剖面线的数据测量与分析;
4.具备晶圆制造工艺中镀膜台阶高度的测量,覆盖从1nm~1mm的测量范围,实现高精度测量。
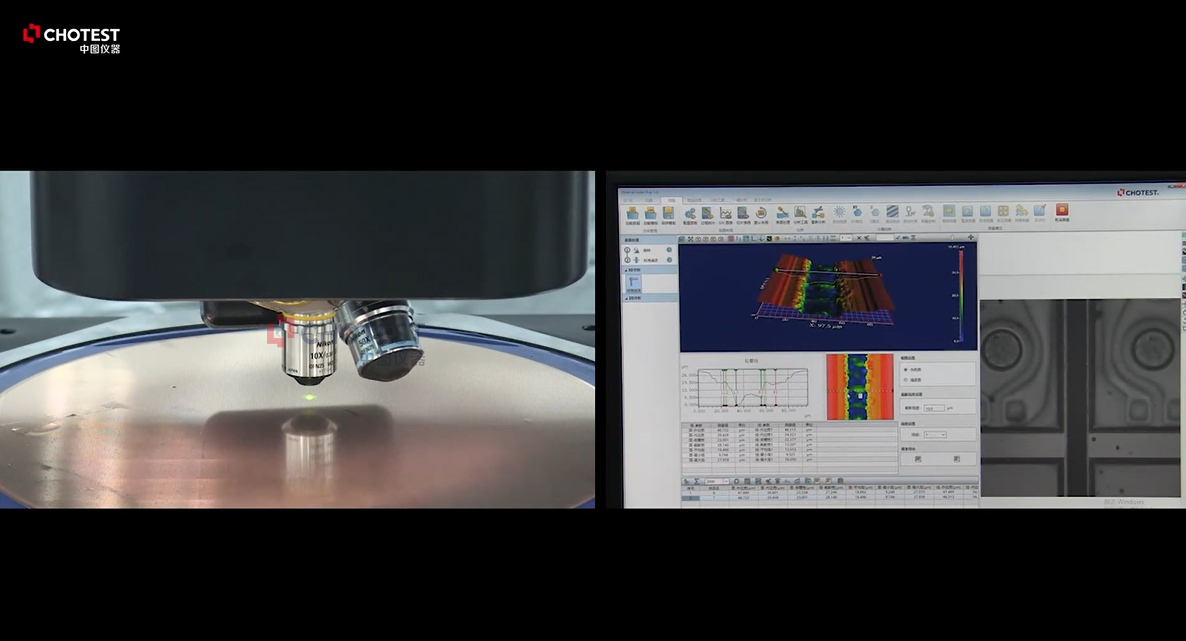 W3白光3D轮廓测量仪测量12英寸硅晶圆
W3白光3D轮廓测量仪测量12英寸硅晶圆
-
标题:群“芯”闪耀的半导体行业2008-09-23 0
-
基于Petri网与遗传算法的半导体生产线建模与优化调度2010-05-04 0
-
对大功率半导体器件的需求将推动测试测量仪器的发展2013-04-25 0
-
影像测量仪的发展与点评2016-01-27 0
-
通信测量仪器2018-01-29 0
-
电子测量仪器的分类和误差2018-02-26 0
-
半导体生产行业检测仪器远程在线式尘埃粒子计数器2020-12-08 0
-
我国电子测量仪器工业发展历程2021-04-15 0
-
测量仪器的原理及制作2012-07-06 3028
-
电子测量仪器的原理_电子测量仪器的优点_电子测量仪器有哪些2017-12-12 7186
-
电子测量仪器原理与使用2021-03-18 1235
-
先进的尺寸测量仪器有哪些?2022-10-24 3661
-
智能影像测量仪器助力新型工业化2023-06-21 305
-
白光3D轮廓测量仪适配芯片制造生产线,助力半导体行业发展2022-12-19 402
全部0条评论

快来发表一下你的评论吧 !

