

【博捷芯】划片机的两种切割工艺
描述
划片工艺:根据晶圆工艺制程及对产品需求的不同,一片晶圆通常由几百至数万颗小芯片组成,业内大部分晶圆的Dice之间有着40um-100um不等的间隙区分,此间隙被称为切割道,而圆片上99%的芯片都具有独立的性能模块(1%为边缘dice,具备使用性能),为将小芯片分 离成单颗dice,就需要使用切割工艺对圆片进行切割(Die Sawing)。目前,业内主要切割工艺有两种:刀片切割和激光切割。
刀片切割: 刀片在设备主轴高速运转带动下,刀片上的金刚石颗粒将工作盘上的晶圆从切割街区进行击穿,并在刀片”碎屑口袋”与切割冲洗水
的作用下,将产品碎屑及时移除,避免造成背面硅粉渗透及附着表面造成的品质异常。
激光切割:激光切割主要作用是开槽, 开完槽之后就用刀片进行切穿,激光切割对刀片切割起到补充的作用,主要应用于超薄晶圆切割。
划片机:划片机作为半导体芯片后道工序的加工设备,用于晶圆的划片、分割或开槽等微细加工,切割的质量与效率直接影响到芯片的质量和生产成本。划片机种类分为砂轮划片机与激光划片机,分别对应刀片切割工艺与激光切割工艺。
砂轮划片机是综合了水气电、空气静压高速主轴、精密机械传动、传感器及自动化控制等技术的精密数控设备。其特点为切割成本低、效率高,适用于100um以上的较厚晶圆的切割,是当前主流切割方式。
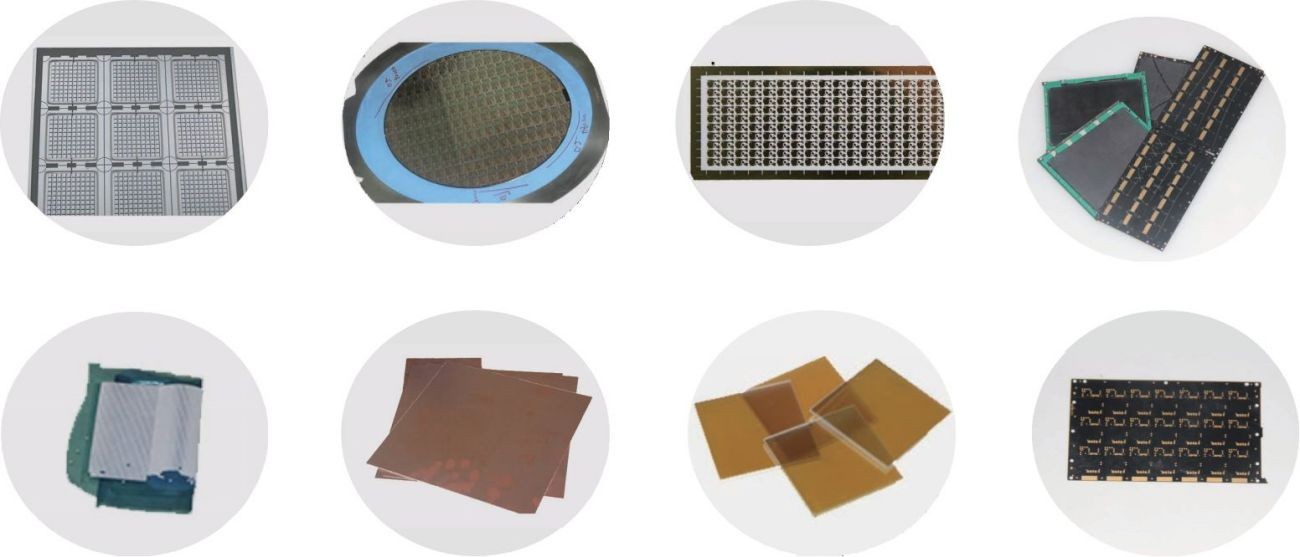
激光划片机是利用高能激光束照射在工件表面,使被照射区域局部熔化、气化、从而达到划片的目的。其特点为切割精度高、切割速度快,盱100μm以下的较薄晶圆的切割。激光切割机己推出20余年,约占整个划片机市场的20%左右。
随着集成电路超大规模化的发展趋势,器件的设计原则开始追求微细化,在提高元件工作速度的同时,减小芯片的面积,其对划片机的工艺要求越发精细化。目前晶圆的线宽已经发展到5μm以下,甚至达到1μm左右,晶圆上集成电路的排布愈发密集,对于切割精度的要求大大提升。当前激光切割技术不断向高功率、高精度的方向发展,新型全自动激光划片机陆续被制造,对于切割效率和切割精度都能兼顾,未来有望持续发展。
-
博捷芯划片机,实现了国产化替代!填充国内半导体加工设备空缺博捷芯半导体 2023-03-14
-
博捷芯BJCORE划片机 99进口氧化铝陶瓷基板切割 工艺应用篇博捷芯半导体 2023-12-14
-
博捷芯高精密划片机工艺应用篇 PCB板切割 FPC切割 BT板切割博捷芯半导体 2023-12-14
-
GPP二极管、可控硅的激光划片工艺2008-05-26 0
-
切割耗材与代工2009-08-07 0
-
激光用于晶圆划片的技术与工艺2010-01-13 0
-
苏州天弘激光推出新一代激光晶圆划片机2010-01-13 0
-
如何做晶圆切割(划片),晶圆切割的工艺流程2020-12-24 15696
-
什么是划片工艺?划片工艺有哪些?2023-04-04 2884
-
陆芯半导体晶圆划片机行业介绍及切割工艺2022-05-26 1577
-
陆芯精密切割——精密划片机的切割刀如何选用?2022-04-25 4169
-
陆芯半导体-精密划片机切割工艺案例应用2022-06-21 542
-
博捷芯精密划片机行业介绍及工艺比较2022-11-09 6287
-
博捷芯:晶圆切割提升晶圆工艺制程,国产半导体划片机解决方案2023-06-05 9272
-
博捷芯划片机半导体封装的作用、工艺及演变2023-06-09 685
全部0条评论

快来发表一下你的评论吧 !

