

蚀刻技术蚀刻工艺及蚀刻产品简介
描述
关键词:氢能源技术材料,耐高温耐酸碱耐湿胶带,高分子材料,高端胶粘剂
引言:蚀刻(etching)是将材料使用化学反应或物理撞击作用而移除的技术。蚀刻技术可以分为湿蚀刻(wet etching)和干蚀刻(dry etching)两类。最早可用来制造铜版、锌版等印刷凹凸版,也广泛地被使用于减轻重量(Weight Reduction)仪器镶板,铭牌及传统加工法难以加工之薄形工件等的加工;经过不断改良和工艺设备发展,亦可以用于航空、机械、化学工业中电子薄片零件精密蚀刻产品的加工,特别在半导体制程上,蚀刻更是不可或缺的技术。
蚀刻
原理:通常所指蚀刻也称光化学蚀刻(photochemical etching),指通过曝光制版、显影后,将要蚀刻区域的保护膜去除,在蚀刻时接触化学溶液,达到溶解腐蚀的作用,形成凹凸或者镂空成型的效果。工艺流程:曝光法:工程根据图形开出备料尺寸-材料准备-材料清洗-烘干→贴膜或涂布→烘干→曝光→ 显影→烘干-蚀刻→脱膜→OK。网印法:开料→清洗板材(不锈钢其它金属材料)→丝网印→蚀刻→脱膜→OK。蚀刻优版:采用喷墨打印技术将抗腐蚀墨水打印到材料表面,再经过固化(一般是用光固化也有用热固化)即可获得抗腐蚀层然后可以进行下一步化学腐蚀或者电腐蚀。
蚀刻要注意的问题:减少侧蚀和突沿,提高蚀刻系数。侧蚀产生突沿。通常印制板在蚀刻液中的时间越长,(或者使用老式的左右摇摆蚀刻机)侧蚀越严重。侧蚀严重影响印制导线的精度,严重侧蚀将使制作精细导线成为不可能。当侧蚀和突沿降低时,蚀刻系数就升高,高的蚀刻系数表示有保持细导线的能力,使蚀刻后的导线接近原图尺寸。电镀蚀刻抗蚀剂无论是锡-铅合金,锡,锡-镍合金或镍,突沿过度都会造成导线短路。因为突沿容易断裂下来,在导线的两点之间形成电的桥接。
提高板子与板子之间蚀刻速率的一致性:在连续的板子蚀刻中,蚀刻速率越一致,越能获得均匀蚀刻的板子。要达到这一要求,必须保证蚀刻液在蚀刻的全过程始终保持在最佳的蚀刻状态。这就要求选择容易再生和补偿,蚀刻速率容易控制的蚀刻液。选用能提供恒定的操作条件和对各种溶液参数能自动控制的工艺和设备。通过控制溶铜量,PH值,溶液的浓度,温度,溶液流量的均匀性(喷淋系统或喷嘴以及喷嘴的摆动)等来实现。
提高整个板子表面蚀刻速率的均匀性:板子上下两面以及板面上各个部位的蚀刻均匀性是由板子表面受到蚀刻剂流量的均匀性决定的。蚀刻过程中,上下板面的蚀刻速率往往不一致。一般来说,下板面的蚀刻速率高于上板面。因为上板面有溶液的堆积,减弱了蚀刻反应的进行。可以通过调整上下喷嘴的喷啉压力来解决上下板面蚀刻不均的现象。蚀刻印制板的一个普遍问题是在相同时间里使全部板面都蚀刻干净是很难做到的,板子边缘比板子中心部位蚀刻的快。采用喷淋系统并使喷嘴摆动是一个有效的措施。更进一步的改善可以通过使板中心和板边缘处的喷淋压力不同,板前沿和板后端间歇蚀刻的办法,达到整个板面的蚀刻均匀性。
提高安全处理和蚀刻薄铜箔及薄层压板的能力:在蚀刻多层板内层这样的薄层压板时,板子容易卷绕在滚轮和传送轮上而造成废品。所以,蚀刻内层板的设备必须保证能平稳的,可靠地处理薄的层压板。许多设备制造商在蚀刻机上附加齿轮或滚轮来防止这类现象的发生。更好的方法是采用附加的左右摇摆的聚四氟乙烯涂包线作为薄层压板传送的支撑物。对于薄铜箔(例如1/2或1/4盎司)的蚀刻,必须保证不被擦伤或划伤。薄铜箔经不住像蚀刻1盎司铜箔时的机械上的弊端,有时较剧烈的振颤都有可能划伤铜箔。
减少污染的问题
铜对水的污染是印制电路生产中普遍存在的问题,氨碱蚀刻液的使用更加重了这个问题。因为铜与氨络合,不容易用离子交换法或碱沉淀法除去。所以,采用第二次喷淋操作的方法,用无铜的添加液来漂洗板子,大大地减少铜的排出量。然后,再用空气刀在水漂洗之前将板面上多余的溶液除去,从而减轻了水对铜和蚀刻的盐类的漂洗负担。
蚀刻工艺
把未被抗蚀剂掩蔽的薄膜层除去,从而在薄膜上得到与抗蚀剂膜上完全相同图形的工艺。在集成电路制造过程中,经过掩模套准、曝光和显影,在抗蚀剂膜上复印出所需的图形,或者用电子束直接描绘在抗蚀剂膜上产生图形,然后把此图形精确地转移到抗蚀剂下面的介质薄膜(如氧化硅、氮化硅、多晶硅)或金属薄膜(如铝及其合金)上去,制造出所需的薄层图案。刻蚀就是用化学的、物理的或同时使用化学和物理的方法,有选择地把没有被抗蚀剂掩蔽的那一部分薄膜层除去,从而在薄膜上得到和抗蚀剂膜上完全一致的图形。 刻蚀技术主要分为干法刻蚀与湿法刻蚀。
干法刻蚀主要利用反应气体与等离子体进行刻蚀;湿法刻蚀主要利用化学试剂与被刻蚀材料发生化学反应进行刻蚀。在半导体制造中有两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀。干法刻蚀是把硅片表面曝露于气态中产生的等离子体,等离子体通过光刻胶中开出的窗口,与硅片发生物理或化学反应(或这两种反应),从而去掉曝露的表面材料。干法刻蚀是亚微米尺寸下刻蚀器件的最重要方法。而在湿法腐蚀中,液体化学试剂(如酸、碱和溶剂等)以化学方式去除硅片表面的材料。湿法腐蚀一般只是用在尺寸较大的情况下(大于3微米)。湿法腐蚀仍然用来腐蚀硅片上某些层或用来去除干法刻蚀后的残留物。
基本工艺要求 理想的刻蚀工艺必须具有以下特点:①各向异性刻蚀,即只有垂直刻蚀,没有横向钻蚀。这样才能保证精确地在被刻蚀的薄膜上复制出与抗蚀剂上完全一致的几何图形;②良好的刻蚀选择性,即对作为掩模的抗蚀剂和处于其下的另一层薄膜或材料的刻蚀速率都比被刻蚀薄膜的刻蚀速率小得多,以保证刻蚀过程中抗蚀剂掩蔽的有效性,不致发生因为过刻蚀而损坏薄膜下面的其他材料;③加工批量大,控制容易,成本低,对环境污染少,适用于工业生产。
蚀刻工艺的分类
1、湿法刻蚀
这是传统的刻蚀方法。把硅片浸泡在一定的化学试剂或试剂溶液中,使没有被抗蚀剂掩蔽的那一部分薄膜表面与试剂发生化学反应而被除去。例如,用一种含有氢氟酸的溶液刻蚀二氧化硅薄膜,用磷酸刻蚀铝薄膜等。这种在液态环境中进行刻蚀的工艺称为“湿法”工艺,其优点是操作简便、对设备要求低、易于实现大批量生产,并且刻蚀的选择性也好。但是,化学反应的各向异性较差,横向钻蚀使所得的刻蚀剖面呈圆弧形。这不仅使图形剖面发生变化,而且当稍有过刻蚀时剖面会产生如图中的虚线,致使薄膜上图形的线宽比原抗蚀剂膜上形成的线宽小2墹x,并且墹x随过刻蚀时间迅速增大。这使精确控制图形变得困难。湿法刻蚀的另一问题,是抗蚀剂在溶液中,特别在较高温度的溶液中易受破坏而使掩蔽失效,因而对于那些只能在这种条件下刻蚀的薄膜必须采用更为复杂的掩蔽方案。
对于采用微米级和亚微米量级线宽的超大规模集成电路,刻蚀方法必须具有较高的各向异性特性,才能保证图形的精度,但湿法刻蚀不能满足这一要求。
2、干法刻蚀
70年代末研究出一系列所谓干法刻蚀工艺。干法刻蚀有离子铣刻蚀、等离子刻蚀和反应离子刻蚀三种主要方法。
① 离子铣刻蚀:低气压下惰性气体辉光放电所产生的离子加速后入射到薄膜表面,裸露的薄膜被溅射而除去。由于刻蚀是纯物理作用,各向异性程度很高,可以得到分辨率优于 1微米的线条。这种方法已在磁泡存储器、表面波器件和集成光学器件等制造中得到应用。但是,这种方法的刻蚀选择性极差,须采用专门的刻蚀终点监测技术,而且刻蚀速率也较低。
② 等离子刻蚀:利用气压为10~1000帕的特定气体(或混合气体)的辉光放电,产生能与薄膜发生离子化学反应的分子或分子基团,生成的反应产物是挥发性的。它在低气压的真空室中被抽走,从而实现刻蚀。通过选择和控制放电气体的成分,可以得到较好的刻蚀选择性和较高的刻蚀速率,但刻蚀精度不高,一般仅用于大于4~5微米线条的工艺中。
③ 反应离子刻蚀:这种刻蚀过程同时兼有物理和化学两种作用。辉光放电在零点几到几十帕的低真空下进行。硅片处于阴极电位,放电时的电位大部分降落在阴极附近。大量带电粒子受垂直于硅片表面的电场加速,垂直入射到硅片表面上,以较大的动量进行物理刻蚀,同时它们还与薄膜表面发生强烈的化学反应,产生化学刻蚀作用。选择合适的气体组分,不仅可以获得理想的刻蚀选择性和速度,还可以使活性基团的寿命短,这就有效地抑制了因这些基团在薄膜表面附近的扩散所能造成的侧向反应,大大提高了刻蚀的各向异性特性。反应离子刻蚀是超大规模集成电路工艺中很有发展前景的一种刻蚀方法。
现代化的干法刻蚀设备包括复杂的机械、电气和真空装置,同时配有自动化的刻蚀终点检测和控制装置。因此这种工艺的设备投资是昂贵的。
干法刻蚀也可以根据被刻蚀的材料类型来分类。按材料来分,刻蚀主要分成三种:金属刻蚀、介质刻蚀、和硅刻蚀。介质刻蚀是用于介质材料的刻蚀,如二氧化硅。接触孔和通孔结构的制作需要刻蚀介质,从而在ILD中刻蚀出窗口,而具有高深宽比(窗口的深与宽的比值)的窗口刻蚀具有一定的挑战性。硅刻蚀(包括多晶硅)应用于需要去除硅的场合,如刻蚀多晶硅晶体管栅和硅槽电容。金属刻蚀主要是在金属层上去掉铝合金复合层,制作出互连线。
刻蚀也可以分成有图形刻蚀和无图形刻蚀。有图形刻蚀采用掩蔽层(有图形的光刻胶)来定义要刻蚀掉的表面材料区域,只有硅片上被选择的这一部分在刻蚀过程中刻掉。有图形刻蚀可用来在硅片上制作多种不同的特征图形,包括栅、金属互连线、通孔、接触孔和沟槽。无图形刻蚀、反刻或剥离是在整个硅片没有掩模的情况下进行的,这种刻蚀工艺用于剥离掩模层(如STI氮化硅剥离和用于制备晶体管注入侧墙的硅化物工艺后钛的剥离)。反刻是在想要把某一层膜的总的厚度减小时采用的(如当平坦化硅片表面时需要减小形貌特征)。光刻胶是另一个剥离的例子。总的来说,有图形刻蚀和无图形刻蚀工艺条件能够采用干法刻蚀或湿法腐蚀技术来实现。为了复制硅片表面材料上的掩膜图形,刻蚀必须满足一些特殊的要求。包括几方面刻蚀参数:刻蚀速率、刻蚀剖面、刻蚀偏差、选择比、均匀性、残留物、聚合物、等离子体诱导损伤、颗粒玷污和缺陷等。刻蚀是用化学或物理方法有选择的从硅片表面去除不需要的材料的过程。刻蚀的基本目标是在涂胶的硅片上正确的复制掩模图形。有图形的光刻胶层在刻蚀中不受腐蚀源显著的侵蚀。这层掩蔽膜用来在刻蚀中保护硅片上特殊区域而选择性的刻蚀掉未被光刻胶保护的区域如图1。在通常的CMOS工艺流程中刻蚀都是在光刻工艺之后进行的如图2。从这一点来说,刻蚀可以看成在硅片上复制所想要的图形的最后主要图形转移工艺步骤。
蚀刻工艺产品介绍


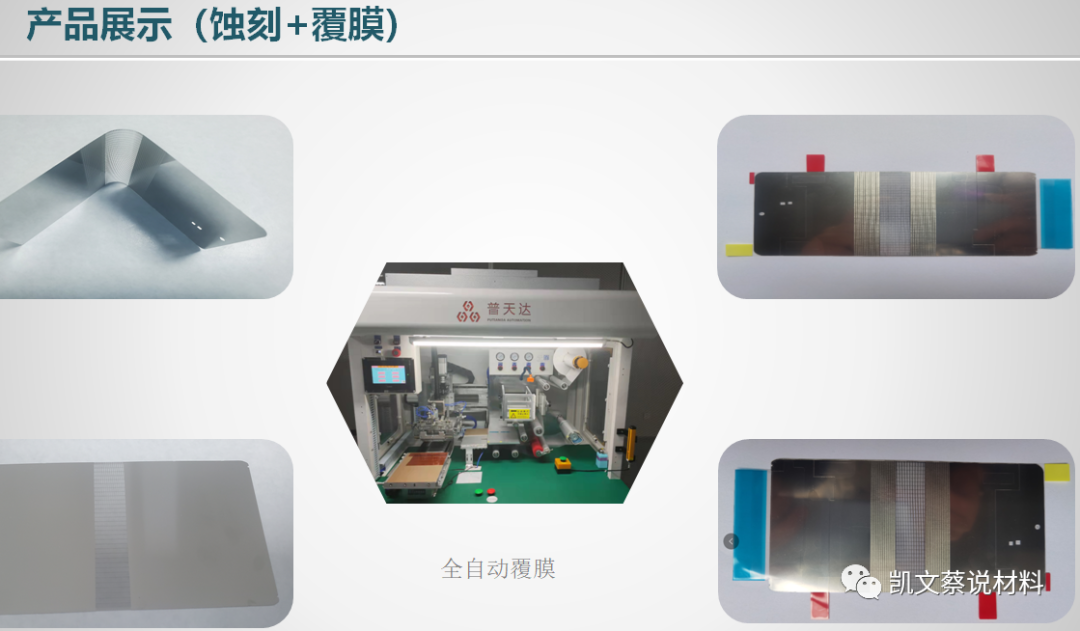


-
在PCB外层电路中什么是蚀刻工艺?2017-06-23 0
-
【AD问答】关于PCB的蚀刻工艺及过程控制2018-04-05 0
-
PCB线路板外层电路的蚀刻工艺详解2018-09-13 0
-
详谈PCB的蚀刻工艺2018-09-19 0
-
PCB外层电路的蚀刻工艺2018-11-26 0
-
PCB蚀刻工艺质量要求2020-03-03 0
-
湿法蚀刻工艺2021-01-08 0
-
PCB蚀刻工艺原理_pcb蚀刻工艺流程详解2018-05-07 41809
-
PCB线路板外层电路制作的蚀刻工艺解析2019-07-10 2883
-
PCB板蚀刻工艺说明2020-07-12 3223
-
关于湿法蚀刻工艺对铜及其合金蚀刻剂的评述2022-01-20 2065
-
蚀刻工艺 蚀刻过程分类的课堂素材4(上)2022-08-08 860
-
什么是金属蚀刻和蚀刻工艺?2023-03-20 4290
-
如何实现PCB蚀刻工艺中的均匀性呢?有哪些方法?2023-08-10 1365
-
电偶腐蚀对先进封装铜蚀刻工艺的影响2024-02-21 213
全部0条评论

快来发表一下你的评论吧 !

