

AMB通用技术问题—翘曲及其解决方案
描述
问题描述
AMB陶瓷覆铜基板是一个复合结构:铜箔/焊料/陶瓷/焊料/铜箔,不同材料之间的CTE、杨氏模量、导热性能也存在差异。

在IGBT/SiC功率模块的封装制程中,尤其芯片烧结、散热器焊接或塑封,同时有热参数、压力参数及其他材料CTE的条件影响, 会导致AMB覆铜陶瓷基板产生翘曲,进而产生一些通用问题,例如焊接空洞、塑封分层,严重情况下甚至产生陶瓷开裂等问题。
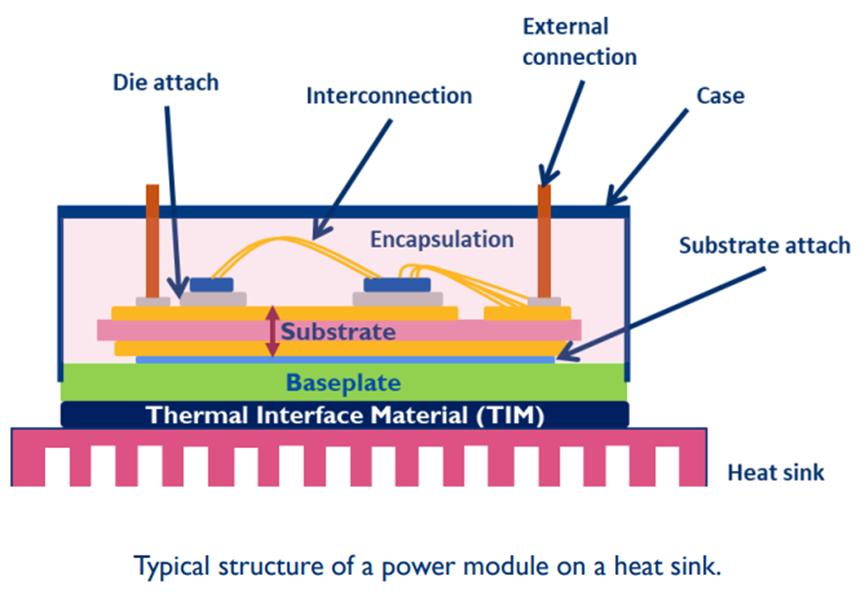
AMB通用技术问题-翘曲
翘曲机理 ►
复合材料结构的翘曲机理:不同材料属性各异,其模量、强度、热膨胀系数差异很大,复合之后会存在明显的各向异性。复合材料结构的翘曲变形主要是由烧结反应过程中的残余应力引起,而残余应力又是由组分材料的热膨胀不匹配、多层结构线性收缩不一致引起的。

AMB翘曲示意图
AMB翘曲T0状态主要受三大因素影响——线路排布、材料组合、AMB单片尺寸。在客户端焊接、烧结及塑封制程中,图形面与非图形面的铜材不论是体积还是Layout上必然存在差异,导致在受热过程中释放差异性应力,进而导致AMB翘曲。
威斯派尔解决方案►
1. 图形设计优化或者反馈
2. 烧结工艺保证(烧结工艺参数、特制烧结治具等);成品翘曲度保证(样品初制承诺0.65%,具体以客户图纸为准)
3. Winspower实验室实验模拟(以客户温度曲线为基础,平台模拟翘曲)
威斯派尔实验室目前拥有由研发团队搭建的测试平台,参考客户端封装的工艺参数,可以模拟分析AMB的翘曲形态及翘曲数据,将内部的测试数据与客户端测试数据相结合后,技术团队分享最优的解决方案:铜减薄、调整铜面积、调整材料组合、Dimpling设计等,并快速提供样品给客户。
撰文:Stefan
来源 : 威斯派尔
审核编辑:刘清
全部0条评论

快来发表一下你的评论吧 !

