

功率二极管碰撞电离区位置与漂移区电阻率的关系
模拟技术
描述
(1)电阻率25Ω.cm
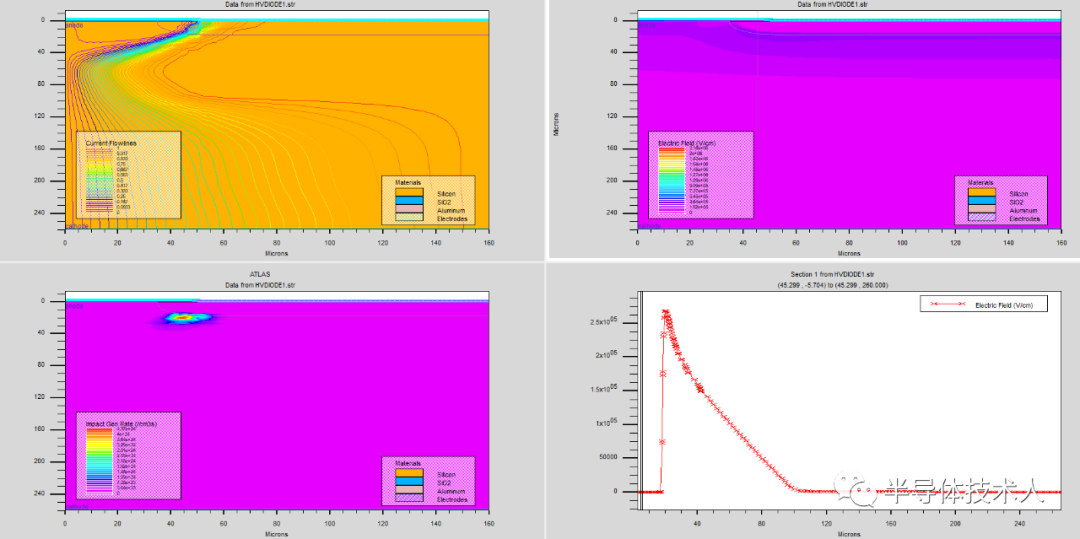
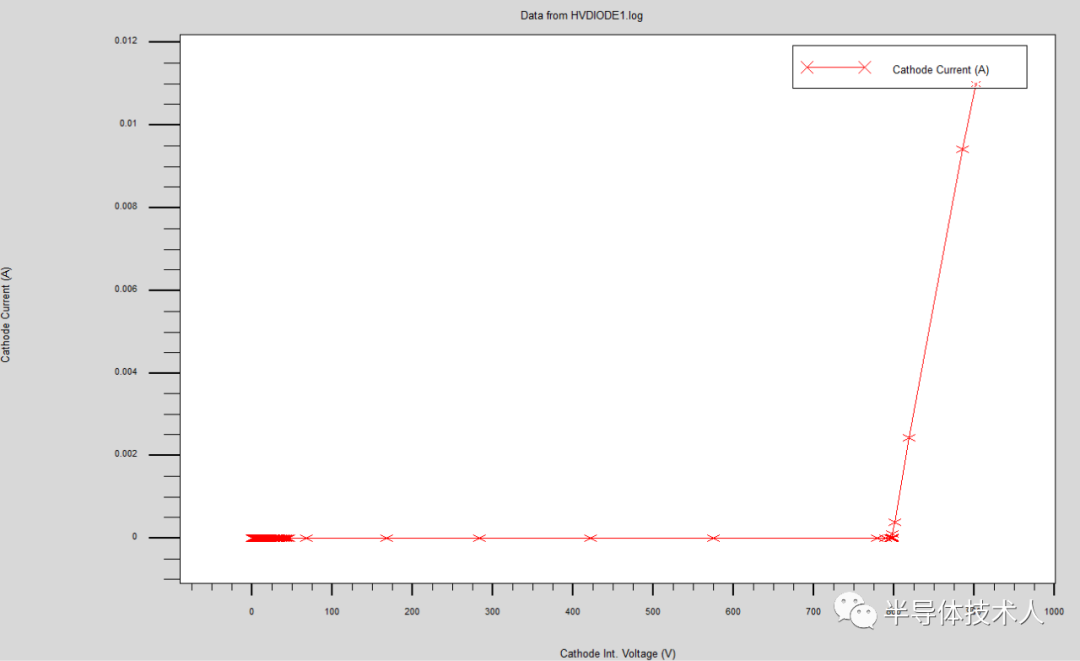

(2)电阻率50Ω.cm
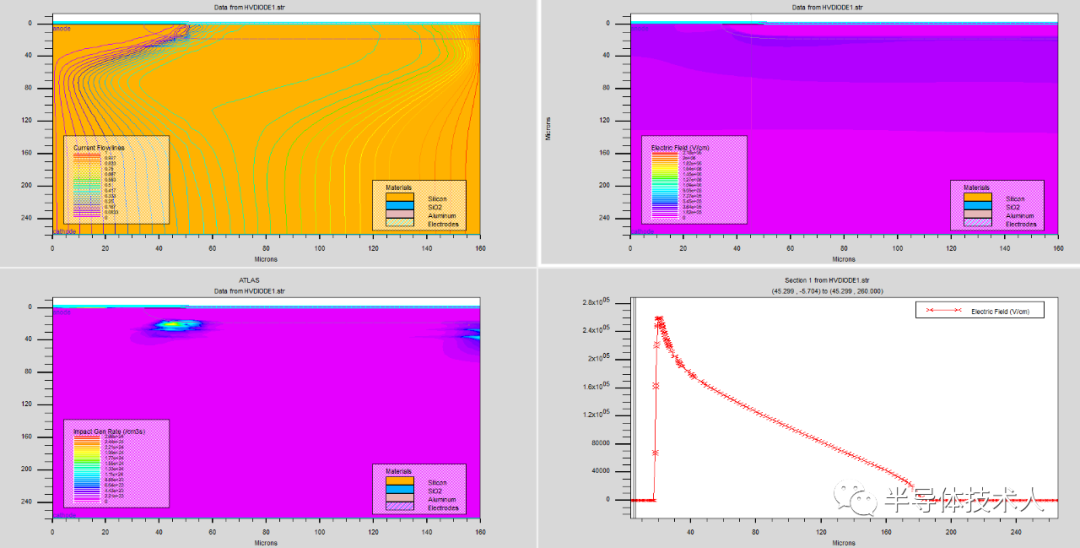
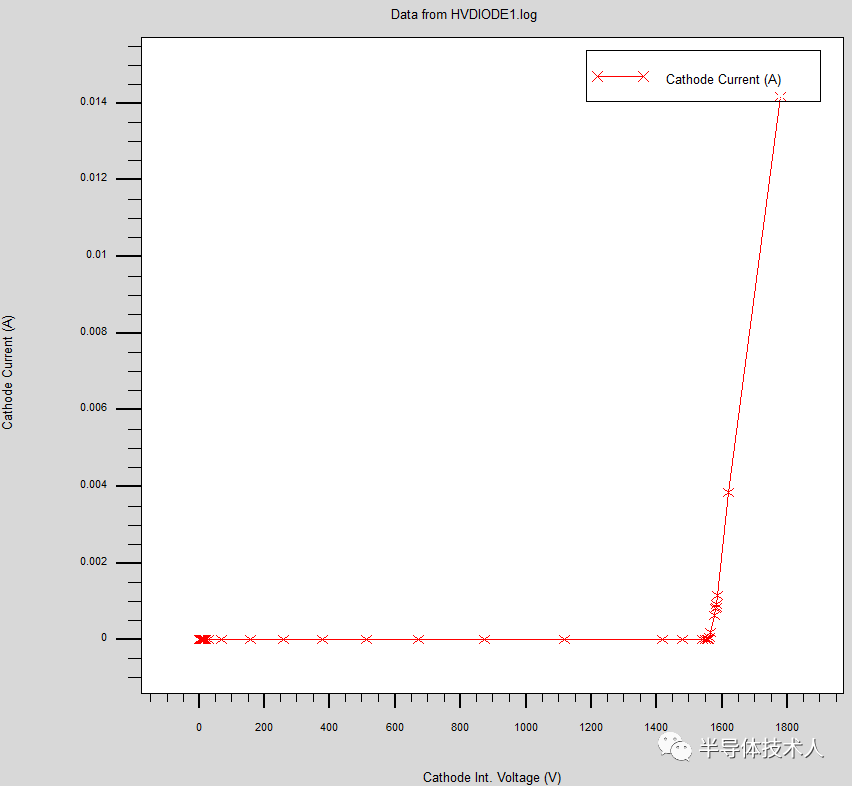

(3)电阻率100Ω.cm
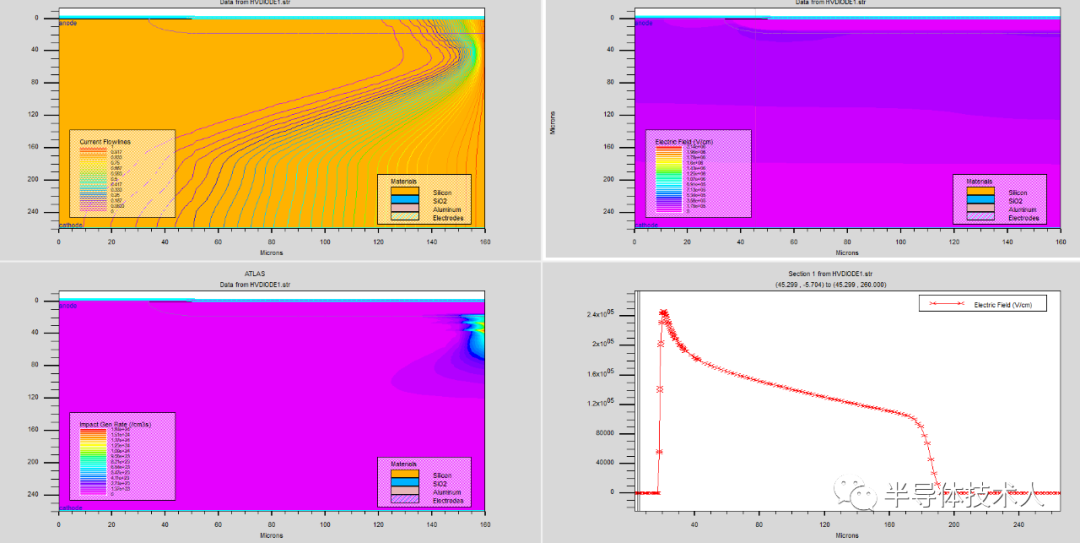
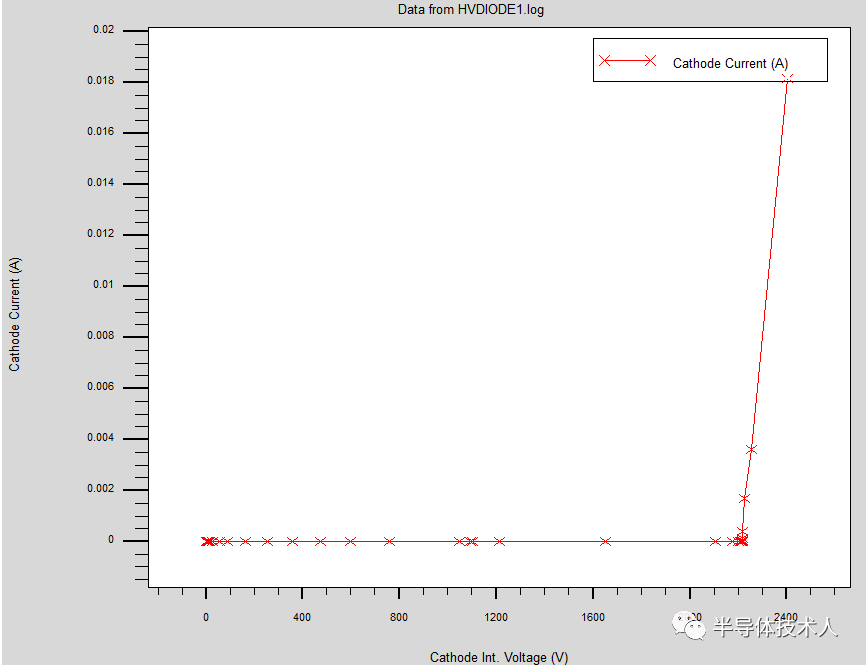

######################################################
1 高压整流二极管结构参数:
首先利用TCAD半导体器件仿真软件建立高反压整流二极管结构,如图1所示。由PN结理论可知,高反压整流二极管要承受高的反向击穿电压,PN结其中的一侧必须为低掺杂。当反向击穿电压指标要求一定时,P+N型结构相比于N+P型结构,所需的高阻层厚度更薄。
根据实际电参数指标要求,在25℃室温情况下,当测试电流IR=5μA时,器件反向重复峰值电压(VRRM)需高于1200V。为保证器件结构设计的可靠性,对击穿电压指标考虑10%的裕量,即击穿电压设计目标值为1320V。图2为仿真得到的N型单晶硅电阻率对器件击穿电压的影响,在仿真过程中,衬底少子寿命为10μs,高阻N型区厚度为180μm,P+区表面浓度为5E19cm-3,结深为10.5μm。当N型单晶硅电阻率大于45Ω.cm时,器件击穿电压约为1400V,满足设计要求。图3为仿真得到的高阻N型单晶硅厚度对器件击穿电压的影响。
在仿真过程中,衬底少子寿命为10μs,原始单晶硅电阻率为45Ω.cm,P+区表面浓度为5E19cm-3,结深为10.5μm。当高阻N型单晶硅厚度≥90μm时,器件击穿电压约为1350V,满足设计要求。器件基本结构参数选择为:原始N型单晶硅片晶向为<111>,少子寿命为10μs,单晶硅电阻率为45Ω.cm。利用三重扩散工艺制备得到N+/N结构,N+衬底砷杂质扩散深度为160μm,砷表面浓度为5E19cm-3;高阻N型区厚度为100μm;阳极区硼扩散表面浓度为5E19cm-3,硼扩散结深为变量,变化范围为1.5~13.5μm。
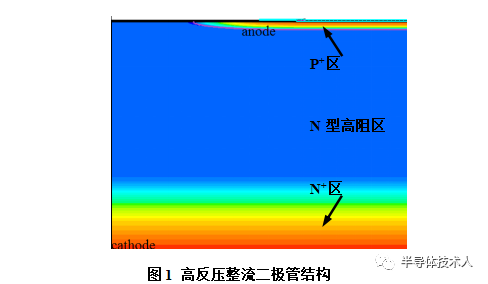
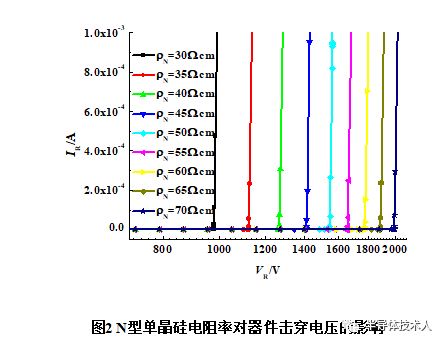
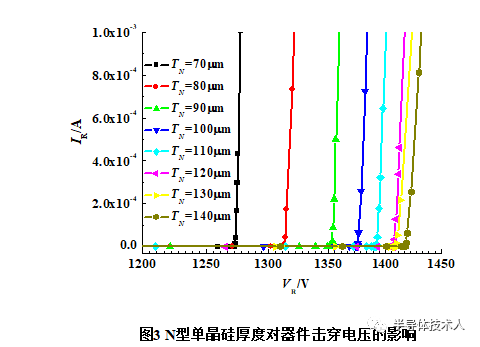
-
晶体二极管及应用电路2009-08-21 0
-
稳压二极管如何使用2012-07-12 0
-
分享肖特基二极管与电路的特性关系2018-10-18 0
-
碳化硅(SiC)肖特基二极管的特点2019-01-11 0
-
浅析功率型肖特基二极管的结构类型2019-02-12 0
-
发光二极管原理2019-06-13 0
-
pin二极管电阻的温度性能主要依赖于二极管结电容的大小2019-06-25 0
-
高压二极管的正向电阻和反向电阻2019-10-12 0
-
基于碰撞电离率的平行平面结和晶闸管的研究2019-10-30 0
-
基于碰撞电离率模型的Miller公式S参数拟合2019-10-30 0
-
二极管正向电流与正向电阻关系的应用?2021-01-22 0
-
稳压二极管怎么看功率2021-11-12 0
-
齐纳二极管是如何工作的?如何测试齐纳二极管?2023-02-02 0
-
如何区分硅二极管和锗二极管?2023-02-07 0
-
瞬态抑制二极管TVS的工作原理?2023-10-20 0
全部0条评论

快来发表一下你的评论吧 !

