

六氟化硫等离子体的热反应离子蚀刻
电子说
描述
引言
众所周知,微机电系统(MEMS)严重依赖于集成电路制造中使用的材料,例如单晶硅。然而,由于金属、玻璃和压电陶瓷的特殊性质,这些材料在MEMS中的使用正在迅速增加。
钛、钽、铌和钼通常被归类为稀有金属,它们中的一些具有特殊的特性,例如生物相容性、耐腐蚀性和高韧性。这些特性使得这些金属可应用于MEMS的各个领域,此外,这使得这些难以蚀刻的材料的深度反应离子蚀刻变得有吸引力。
为了使基于微量金属的MEMS成为传统硅基器件有竞争力的替代物,我们必须实现高蚀刻速率、高掩模选择性和高纵横比。氯气的使用是使我们能够实现高蚀刻速率的替代方法。
实验与讨论
为了克服不挥发反应产物的问题,我们必须提高这些反应产物的温度。基于这一想法,英思特提出了一种简单的热反应离子刻蚀(TRIE)方法。在TRIE中,通过在常规反应离子蚀刻(RIE)系统的阴极上放置自加热台来增加蚀刻速率,选择性地且快速地增加衬底的温度。
图1显示了专门设计的蚀刻阶段(自加热阶段)的概念示意图。当等离子体被激活时,该平台暴露于离子轰击,并接收来自离子轰击、射频(RF)功率和等离子体热辐射的能量。载物台的低热容确保这些能量迅速提高中间部分的温度。
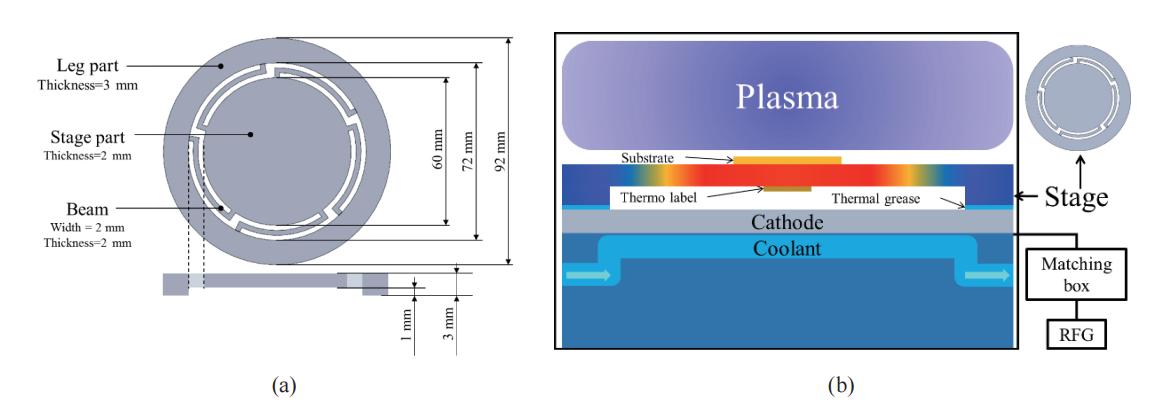
图1:蚀刻阶段概念图
图2展示出了从实验结果获得的温度分布和加热特性的模拟结果的例子。图2(a)显示载物台的温度可以在仅仅10分钟内升高到大约521K。如图2(b)所示,台的中间部分的温度范围从525到529K。温度的均匀性足以进行处理。

图2:特殊设计的自热级的热响应
我们测量了RIE或TRIE处理前后镍的高度,以及RIE或TRIE处理后少量金属的处理部分的深度,以计算平均蚀刻速率和选择性。实验得出,TRIE的蚀刻速率随着工作台的温度而变化,并且在10分钟内变为大约0.6 m/min,这比使用常规RIE获得的蚀刻速率高三倍。TRIE的选择性可以在30分钟内达到约29的值,这比常规RIE达到的值高得多。
英思特研究发现TRIE中Ti、Mo和Nb的蚀刻速率比RIE的蚀刻速率高得多,Ta和Ti-6Al-4V的蚀刻速率略高于RIE的蚀刻速率。尽管TRIE对各种微量金属的作用不同,但它确实大大提高了这些材料的蚀刻速率。
由TRIE工艺产生的底切可以通过调节温度和RF功率来减少,并且蚀刻表面和侧壁粗糙度可以通过添加氩气和/或C4F8气体来减少。少量添加原子(Al 6%,V 4 %)使钛合金难以蚀刻,因为AlF3的沸点很高。然而,并不是所有这些次要金属的腐蚀速率的差异都可以简单地用反应产物沸腾温度的差异来解释。在钼的情况下,还必须考虑蚀刻产物的化学种类和结合能。
结论
英思特对新设计的自加热平台的热响应进行了评估,研究结果表明,即使不使用电感耦合等离子体源,也可以使常规RIE系统更加有效。对钛、钛合金、钼、钽和铌的蚀刻特性进行了评估,结果表明该方法可以大大提高这些次要金属的蚀刻速率和掩模选择性。然而,在次要金属的蚀刻表面和侧壁形状方面仍然存在一些问题,因此,需要进一步优化,例如改善表面粗糙度等。
审核编辑:汤梓红
-
等离子体除烟装置 #等离子体 #电源涐只能静静旳看着沵 2022-07-13
-
放电等离子体极紫外光源中的主脉冲电源2010-04-22 0
-
PCB多层板等离子体处理技术2013-10-22 0
-
PCB电路板等离子体切割机蚀孔工艺技术2017-12-18 0
-
PCB板制作工艺中的等离子体加工技术2018-09-21 0
-
微波标量反射计可测量大范围的等离子体密度2019-06-10 0
-
等离子体光谱仪的原理是什么?2019-10-09 0
-
comsol电化学燃烧电池,等离子体,光电年会2019-12-10 0
-
低温等离子体废气处理系统2022-04-21 0
-
TDK|低温等离子体技术的应用2022-05-17 0
-
等离子体应用2022-05-18 0
-
等离子体蚀刻和沉积问题的解决方案2022-05-19 1736
-
真空等离子清洗机的制造商正在引入氧和氢等离子体来蚀刻石墨烯2022-06-21 461
-
铝等离子体蚀刻率的限制2023-06-27 389
全部0条评论

快来发表一下你的评论吧 !

