

3D封装结构与2.5D封装有何不同?3D IC封装主流产品介绍
制造/封装
描述
2.5D封装和3D IC封装都是新兴的半导体封装技术,它们都可以实现芯片间的高速、高密度互连,从而提高系统的性能和集成度。但是它们之间也存在一些差异和异同点。
1、3D 结构与 2.5D 有何不同?
首先,2.5D封装和3D IC封装的互连方式有所不同。2.5D封装是通过TSV转换板连接芯片,而3D IC封装是将多个芯片垂直堆叠在一起,并通过直接键合技术实现芯片间的互连。
在 2.5D 结构中,两个或多个有源半导体芯片并排放置在硅中介层上,以实现极高的芯片到芯片互连密度。
在 3D 结构中,有源芯片通过芯片堆叠集成,以实现最短的互连和最小的封装尺寸。
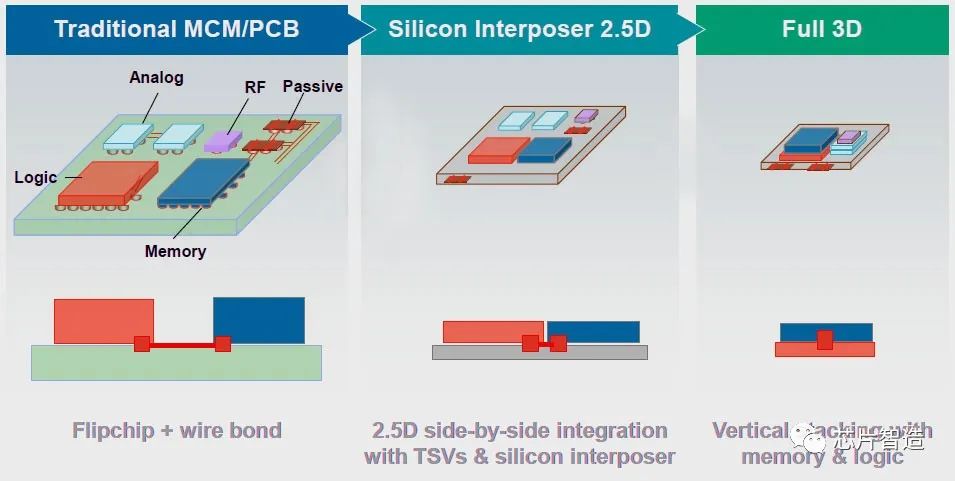
其次,2.5D封装和3D IC封装的制造工艺也有所不同。2.5D封装需要制造硅基中介层,并且需要进行微影技术等复杂的工艺步骤;而3D IC封装需要进行直接键合技术等高难度的制造工艺步骤。
此外,2.5D封装和3D IC封装在应用场景和性能方面也有所不同。2.5D封装通常应用于高性能计算、网络通信、人工智能、移动设备等领域,具有较高的性能和灵活的设计;而3D IC封装通常应用于存储器、传感器、医疗器械等领域,具有较高的集成度和较小的封装体积。
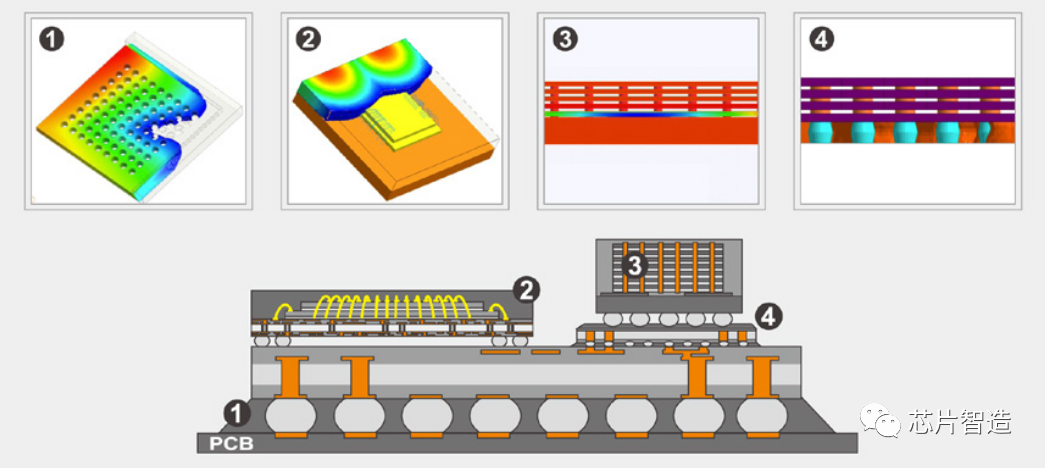
2、2.5D封装主流产品介绍
英特尔的EMIB
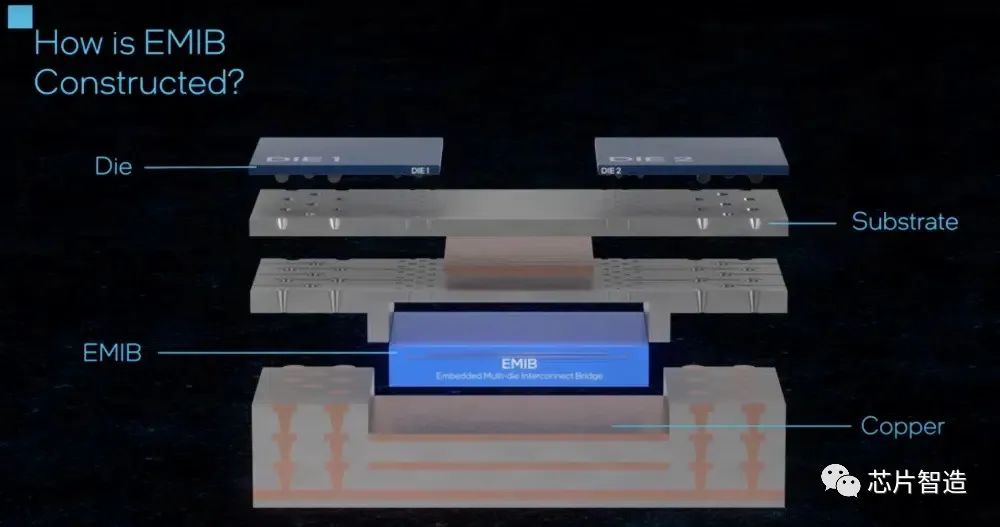
英特尔的EMIB 概念与2.5D封装类似,但与传统2.5D封装的区别在于没有TSV。也正因如此,EMIB技术具有封装良率正常、无需额外工艺、设计简单等优点。
台积电的CoWoS技术
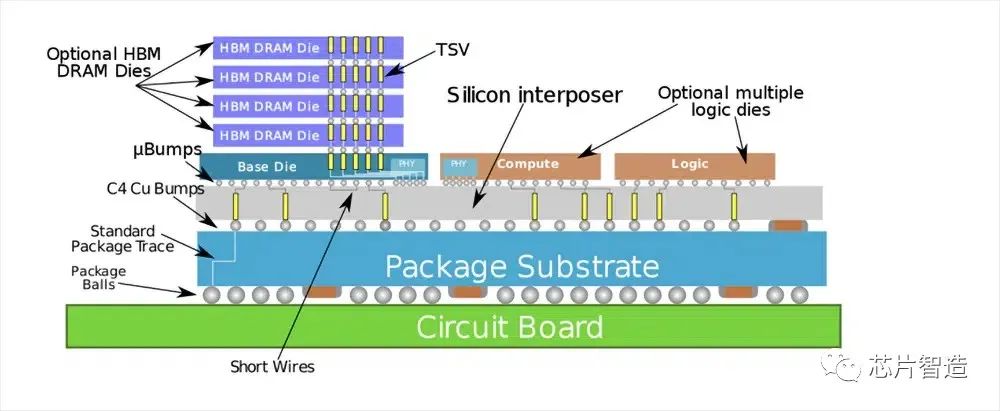
台积电的CoWoS技术
台积电的CoWoS技术也是一种2.5D封装技术。根据中介层的不同,可分为三类。一是CoWoS_S(使用Si衬底作为中介层),二是CoWoS_R(使用RDL作为中介层),三是CoWoS_L(使用小芯片(Chiplet)和RDL作为中介层)。
三星的先进封装包括四种解决方案:I-Cube、X-Cube、R-Cube和H-Cube。其中,三星的I-Cube属于2.5D套餐。
3、3D IC封装主流产品介绍
台积电SoIC技术
台积电的SoIC技术属于3D封装,是wafer-on-wafer键合技术。SoIC技术采用TSV技术,可以实现非凸点键合结构,将许多不同性质的相邻芯片集成在一起。
SoIC 技术将同类和异构小芯片集成到单个类似 SoC 的芯片中,该芯片具有更小的尺寸和更薄的外形,可以单片集成到高级 WLSI(又名 CoWoS 和 InFO)中。新集成的芯片从外观上看是一颗通用SoC芯片,但内嵌了所需的异构集成功能。
英特尔的 Foveros 技术
从3D Foveros的结构来看,底部是封装基板,上面放置了一个底部芯片,作为有源中介层。中介层中有大量的TSV 3D硅通孔,负责连接上下焊球,让上层芯片和模块与系统其他部分进行通信。 三星的X-Cube 3D封装技术
使用 TSV 工艺,三星的 X-Cube 测试芯片已经能够将 SRAM 层堆叠在逻辑层之上,并通过 TSV 将其互连。工艺是三星自己的7nm EUV工艺。
审核编辑:刘清
-
【原创&整理】Altium 常用3D设计封装库2013-04-03 0
-
3D 模型封装2013-12-27 0
-
带3D封装的PCB库2015-03-07 0
-
3d封装2015-06-22 0
-
3D PCB封装库2015-08-06 0
-
常用的3D封装库,你值得拥有2015-09-09 0
-
altium designer 3D封装库2015-11-07 0
-
带有3D的封装2015-11-27 0
-
画PCB 3D封装问题2016-07-12 0
-
Altium Designer 09的3D封装旋转的问题2017-07-20 0
-
allegro如何制作3D封装库2018-05-09 0
-
关于AD16的3D封装问题2019-05-10 0
-
史上最全AD封装库 3D封装库2019-09-20 0
-
如何让AD在3D显示下去除3D封装的显示?2019-09-23 0
-
AD16的3D封装库问题?2019-09-26 0
全部0条评论

快来发表一下你的评论吧 !

