

MEMS传感器的主要构造是怎样的呢?怎么造一颗MEMS传感器呢?
MEMS/传感技术
描述
用MEMS技术制造的新型传感器,就称为MEMS传感器。一般传感器的主要构造有敏感元件、转换元件、变换电路和辅助电源四部分组成。那么,MEMS传感器的主要构造是怎样的呢?
MEMS芯片和集成电路芯片是现代电子技术中重要的两种芯片类型。虽然它们在一些方面有共同之处,但在实际应用中,它们有一些明显的区别。集成电路芯片是电路和电子元件的集合,由大量的晶体管、电容、电阻和其他元件组成。它们广泛应用于计算机、手机、电视等消费类电子产品中,是电子设备的核心。
集成电路芯片制造技术越来越成熟,尺寸越来越小,功耗越来越低,性能越来越高。MEMS芯片是小型机电系统的集合,具有小型化、低功耗和多功能特点。MEMS芯片广泛应用于气压计、加速度计、陀螺仪、传感器等领域。MEMS芯片制造技术相对较新,需要更高的制造精度和技术成本,但它们可以实现微型化,使传感器和器件更加精简。
下面展示了一颗MEMS声学传感器典型的产品构造示意图,图中可以观察到MEMS传感器的构成:主要有MEMS芯片——用来感知信号,即相当于敏感元件;以及ASIC芯片——用来处理信号,即转换与变换元件。
MEMS芯片和ASIC芯片也是一个MEMS传感器中技术和价值含量最高的部分。
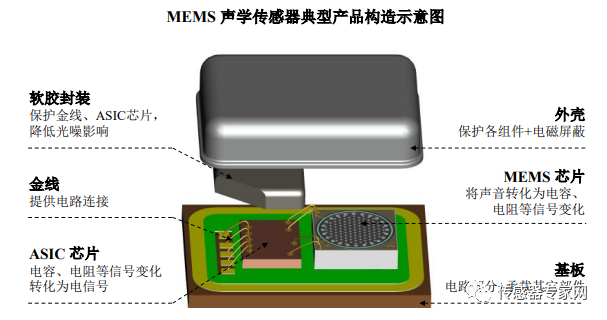
▲MEMS声学传感器构造图(来自歌尔微招股书)
那么,MEMS芯片与集成电路芯片有什么区别?
与集成电路一样,MEMS芯片广泛采用硅作为晶圆衬底材料,而基于集成电路制造的光刻、薄膜沉积、刻蚀、掺杂等单项工艺。
相比于集成电路芯片,MEMS芯片通过微机械结构控制物理现象并转换为电信号输出,能够实现机械与电子之间的互动。
普通集成电路芯片是在半导体晶体中,把一个电路中所需的晶体管、电阻、电容和电感等元件及布线互连一起,为了在一定面积的晶圆内塞入更多的晶体管等元件(这代表更强的性能),因此集成电路芯片追求更高的制程。
相比集成电路芯片,MEMS芯片包含了机械结构,实现机械与电子之间的互动,且微机电系统由尺寸为1至100微米的部件组成,一般微机电设备的通常尺寸在20微米到一毫米之间,相比集成电路芯片不需要追求制程的先进性,但更注重制造工艺的开发。
MEMS芯片有“一种产品一种工艺”的说法,目前没有一种统一的工艺能满足全部MEMS器件制造的需求,这也限制了MEMS传感器的量产和研发速度,因此通用MEMS工艺成为MEMS传感器芯片中的研发重点之一。
什么是ASIC芯片?MEMS传感器的ASIC芯片相比其他ASIC芯片有什么特别?
MEMS芯片负责感知信号,将测量量转化为电阻、电容等信号变化;ASIC芯片负责将电容、电阻等信号转换为电信号,其中涉及到信号的转换和放大等功能。
由于MEMS芯片的特殊性,其模拟输出量往往是十分微弱的或者有非常规的使用条件,通用的ASIC芯片无法达到其要求,常规的ASIC设计公司也无法设计出令MEMS传感器厂家满意的芯片。所以造成了MEMS行业普遍的“缺芯之痛”现象,这个“芯”指的就是MEMS专用的ASIC。因此,MEMS专用ASIC的设计是MEMS技术发展的关键共性技术。

MEMS芯片的主要制造工艺
MEMS工艺以成膜工序、光刻工序、蚀刻工序、键合工序等常规半导体工艺流程为基础。
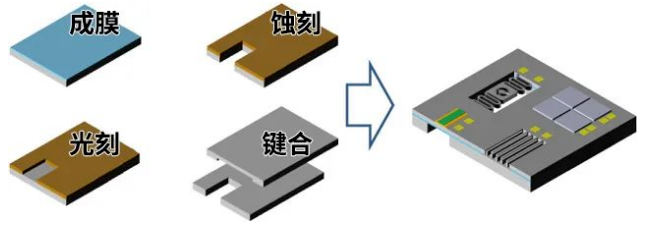
SOI晶圆
SOI是Silicon On Insulator的缩写,即绝缘衬底上的硅,该技术是在顶层硅和背衬底之间引入了一层埋氧化层。在MEMS中可以使用氧化膜层作为硅蚀刻的阻挡层,因此能够形成复杂的三维立体结构。
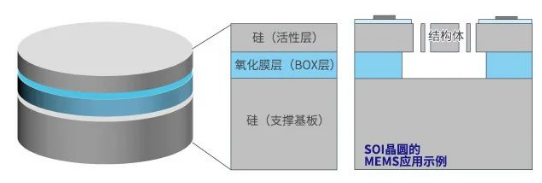
晶圆粘合/热剥离片工艺
通过使用支撑晶圆和热剥离片,可以轻松对薄化晶圆进行处理等。

晶圆键合
晶圆键合是晶圆级的封装技术,用于制造微机电系统(MEMS)、纳米机电系统(NEMS)、微电子学和光电子学,从而确保机械稳定且密封的封装。
晶圆键合工艺,是指通过温度、压力、电压等外部条件的作用,让两个衬底材料(如硅-硅或硅-玻璃等)形成足够的接触,最终通过相邻材料的界面之间形成的分子键作用力或化学键,将两个衬底材料结合为一体的技术。
晶圆键合大致分为“直接键合”、“通过中间层键合”2类。
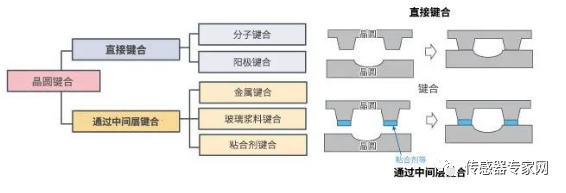
直接键合不使用粘合剂等,是利用热处理产生的分子间力使晶圆相互粘合的键合,用于制作SOI晶圆等。
通过中间层键合是借助粘合剂等使晶圆互相粘合的键合方法。
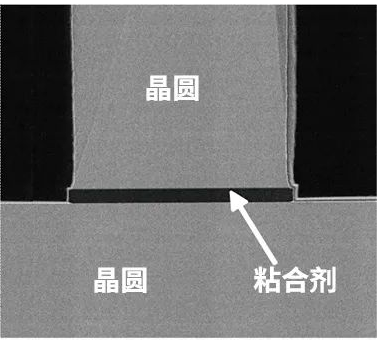
晶圆键合技术在半导体领域具有广泛应用,可以实现不同材料间的无缝连接,从而创造出更加复杂、高性能的器件。
MEMS芯片三种制造工艺
体微加工技术、表面微加工技术、LIGA技术等是MEMS制造的主要工艺,前两者目前应用最广、技术最成熟。
体微加工(Bulk Micromachining),是一种通过各向异性或各向同性刻蚀衬底的方法在硅衬底上制造各种机械结构器件的技术。其特点是设备简单、投资少,但只能做形状简单的器件,深宽比小的器件。是通过对硅材料的腐蚀得到的,消耗硅材料较多(有时称作减法工艺),而且只能以硅材料为加工对象。是指将硅衬底自上而下地进行刻蚀的工艺,这种技术通过各向异性或各向同性刻蚀衬底的方法在硅衬底上制造各种机械结构器件,包括湿法刻蚀和干法刻蚀,是制备具有立体结构的MEMS器件的重要方法。
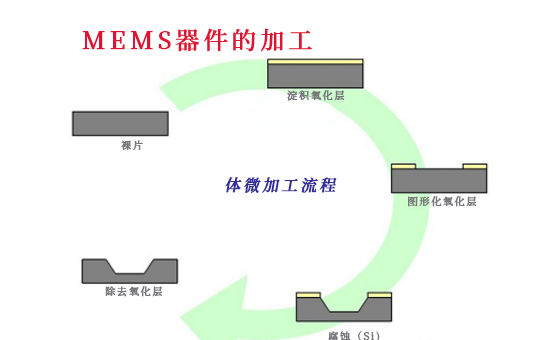
▲MEMS芯片体微加工流程
表面微加工(Surface Micromachining),涉及的主要技术包括薄膜淀积、光刻和刻蚀:薄膜淀积技术是指在衬底表面通过物理或化学方法沉积一层纳米级或微米级厚度的薄膜;光刻是一种将光学掩模版上的图形复制到衬底表面的工艺,即通过对光刻胶层进行有选择性的光源照射,改变胶层的化学性质,然后利用显影液溶解光刻胶上发生化学变化的可溶解区域得到图形的过程。
表面微加工技术通过在牺牲层薄膜上淀积结构层薄膜,再移除牺牲层释放结构层,从而达到结构可动的目的,其主要步骤包括淀积薄膜、光刻图形化、淀积牺牲层薄膜、牺牲层图形化、淀积机械结构层薄膜、机械结构层图形化、去除牺牲层(释放结构)表面微加工技术可以实现加工10μm厚度内的微结构,可以实现多层悬空结构,是MEMS加工工艺中不可替代的微加工技术,因其加工结构的特殊性而对器件的力学性质要求较高,并且需要解决粘连、残余应力、摩擦、驱动等问题。
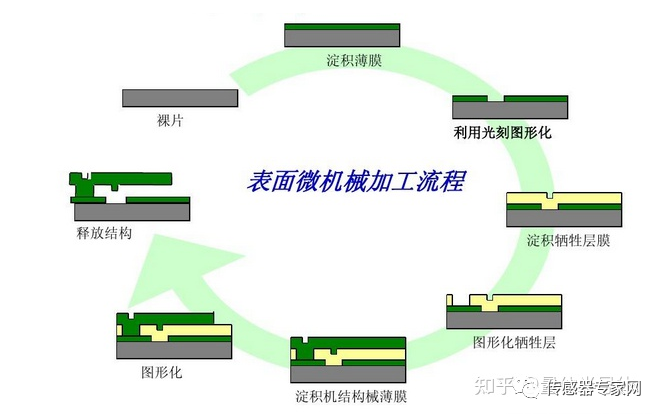
▲MEMS芯片表面微加工流程
LIGA工艺(光刻、电铸和模造)是德语光刻(Lithographie)、电镀(也称电铸)(Galvanoformung)和压模(Abformung)的简称。LIGA技术可加工金属、塑料等非硅材料,同时可加工深宽比大的零件,这是体微加工和表面微加工难以做到的。但该工艺要通过同步加速器辐射装置产生的高能射线作为主要的加工方法,设备昂贵,投资大。
LIGA四个工艺组成部分:LIGA掩模板制造工艺;X光深层光刻工艺;微电铸工艺;微复制工艺。
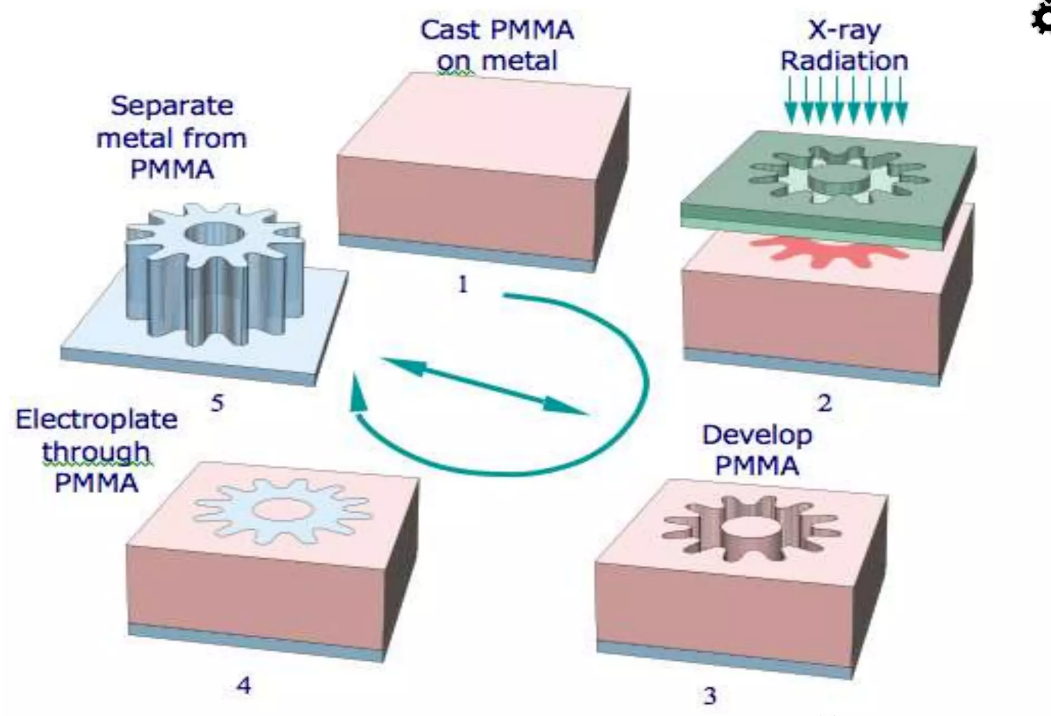
▲LIGA工艺流程
MEMS芯片中的湿法刻蚀和干法深刻蚀
硅的湿法各向异性刻蚀是最早开发的微加工技术,湿法刻蚀是利用被刻蚀材料与刻蚀溶液发生化学反应进行刻蚀,而干法深刻蚀是利用深反应离子刻蚀(DRIE)进行硅的各向异性刻蚀。
湿法刻蚀凭借其工艺简单、成本较低等优势在加速度传感器、压力传感器等器件中有着广泛的应用。最早的刻蚀技术是利用溶液与薄膜间所进行的化学反应,来去除薄膜未被光刻胶覆盖的部分,而达到刻蚀的目的。湿法刻蚀需要用到的材料和仪器有刻蚀溶液、反应器皿、控温装置、清洗机等,常用的各向异性刻蚀溶液为KOH溶液、四甲基氢氧化铵(TMAH)联氨的水溶液等。
干法深刻蚀以其高深宽比的特性,正在被越来越多地应用于体微加工技术,利用不同的刻蚀气体及保护气氛,干法刻蚀也可以刻蚀多晶硅、二氧化硅、金属等材料,具有极高的应用价值。目前,干法深刻蚀已经被广泛应用于微传感器、微执行器、微医疗器件等领域。
干法深刻蚀具有以下特点:刻蚀速率较高,比一般的湿法刻蚀速率的2~15倍;具有高深宽比,能够穿透整个硅片;被刻蚀材料的晶向对刻蚀结构基本无影响,能够刻蚀出任意形状的垂直结构;被刻蚀材料与阻挡材料的刻蚀选择比高,容易保护。干法深刻蚀是利用氟基化物六氟化硫(SF6)气体放电产生的等离子体进行刻蚀,同时利用保护气体把六氟化硫的各向同性刻蚀转变为各向异性刻蚀,由此实现深刻蚀。

硅深度蚀刻
集各向异性蚀刻和各向同性蚀刻的优点于一身的博世工艺技术已经成为了硅深度蚀刻的主流技术。
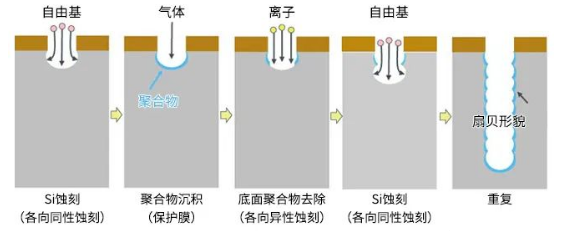
通过重复进行Si蚀刻⇒聚合物沉积⇒底面聚合物去除,可以进行纵向的深度蚀刻。
侧壁的凹凸因形似扇贝,称为“扇贝形貌”。
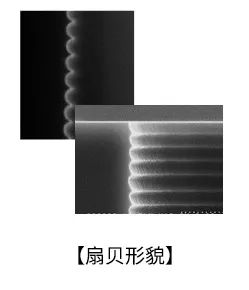
成膜
ALD是Atomic Layer Deposition(原子层沉积)的缩写,是通过重复进行材料供应(前体)和排气,利用与基板之间的表面反应,分步逐层沉积原子的成膜方式。
利用这种方式,只要有成膜材料可以通过的缝隙,就能以纳米等级的膜厚控制,在小孔侧壁和深孔底部等部位成膜,在深度蚀刻时的聚合物沉积等MEMS加工中形成均匀的成膜。
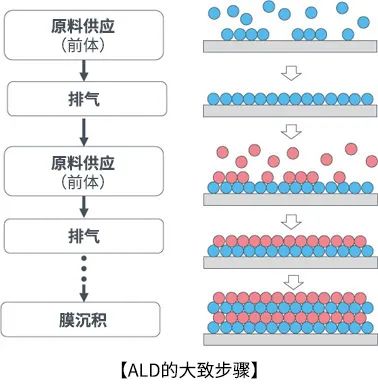
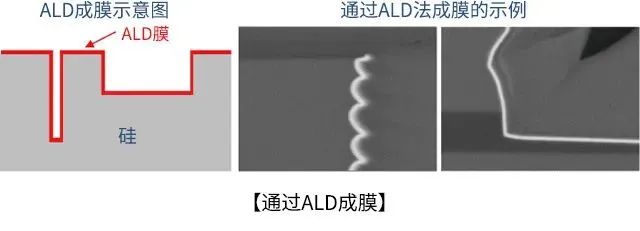
结语
MEMS传感器已经渗透到我们生活的方方面面,无论是智能手机还是汽车,从智能工厂到医疗设备,都离不开它们。据相关数据显示,利用MEMS技术制造的产品已经成为半导体传感器销售额的近四分之三。而在全球传感器总出货量中,MEMS器件更是占据了惊人的54%。这充分说明了MEMS技术的重要性和应用范围的广泛性。
MEMS芯片所需的半导体制造设备制程主要处于微米级,并不涉及到先进制程,目前,先进国家并没有禁止中国对于MEMS制造设备的获取。
MEMS,有望成为中国半导体的突破口!
审核编辑:刘清
-
MEMS传感器及其应用2012-08-14 0
-
MEMS传感器的分类2013-10-11 0
-
汽车电子MEMS传感器的应用2016-12-07 0
-
手机、可穿戴中的MEMS传感器2016-12-07 0
-
基于闭环MEMS的电容式惯性传感器设计2018-11-06 0
-
MEMS传感器四大应用领域详解2018-11-07 0
-
MEMS传感器概念和分类等基础知识详解2018-11-12 0
-
这些MEMS传感器分类你了解吗?2019-02-19 0
-
请问ADXL001MEMS传感器与传统压电式icp传感器有什么区别2019-03-05 0
-
汽车MEMS传感器的市场状况和主要厂商有哪些2020-05-20 0
-
MEMS传感器的主要应用领域2020-08-13 0
-
MEMS传感器的分类和应用领域有哪些?2020-12-03 0
-
MEMS传感器面临哪些挑战呢?如何去解决?2021-07-19 0
-
MEMS传感器焊接工艺2022-10-18 0
-
什么是MEMS芯片、MEMS传感器?2020-06-12 76027
全部0条评论

快来发表一下你的评论吧 !

