

基于HFSS的3D多芯片互连封装MMIC仿真设计
电子说
描述
作品概述
相对于传统平面型的金丝键合焊接的MMIC应用,三维(3D)多芯片互连封装MMIC以其高集成度、低损耗、高可靠性等性能优势,正逐步在先进电路与系统中得到应用。而3D封装引入的复杂电磁耦合效应,在传统MMIC仿真设计上并未包含。本设计基于HFSS,充分考虑实际封装寄生效应,建立了完整的3D多芯片互连精准模型,并给出了封装前后仿真结果对比分析。
仿真应用背景
平面型互连向3D集成互连发展
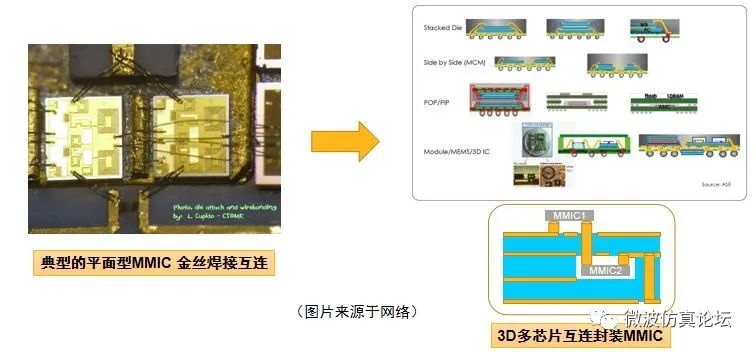
仿真结果分析、展示
本设计用两个MMIC 互连展示
考虑两种连接情形分别建模与仿真
Case1:平面型金丝键合仿真模型
Chip1和Chip2为两个滤波器芯片;
Chip1和Chip2通过金丝键合;
输入和输出微带线采用陶瓷基板。
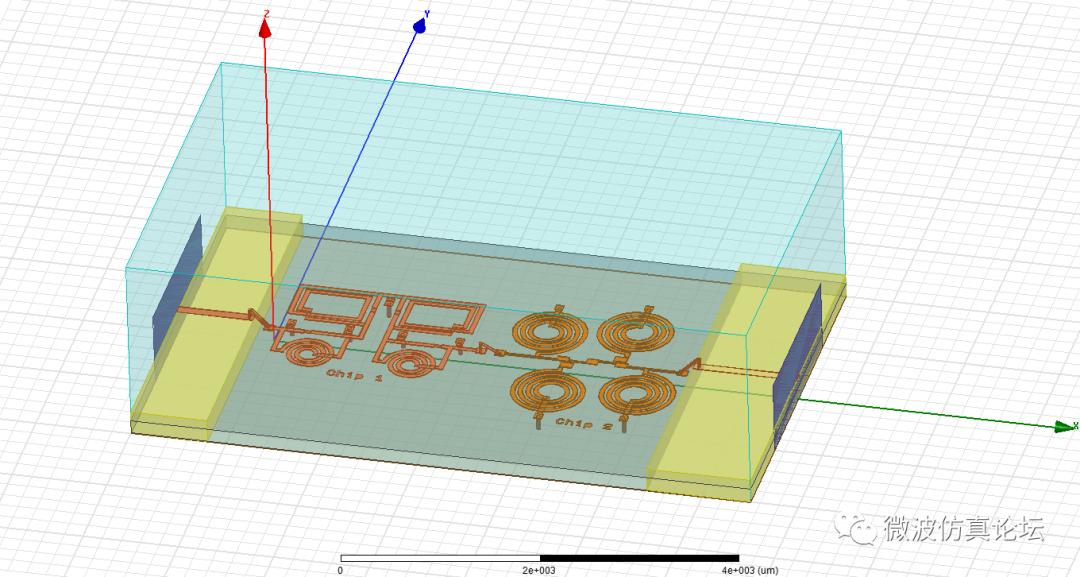
平面型金丝互连仿真模型
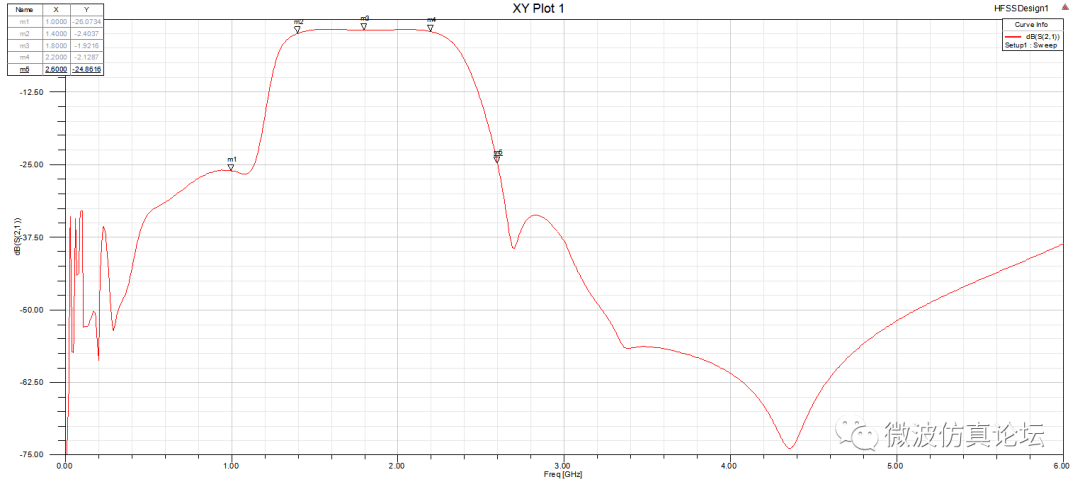
平面型金丝互连仿真结果
Case2:3D集成互连仿真模型
Chip1和Chip2,与Case1相同的两个滤波器芯片;
Chip1和Chip2通过通孔、铜柱或金球实现信号互连;
采用同样的陶瓷基板作为芯片的载体。
此处的空气腔高度设为100 μm。
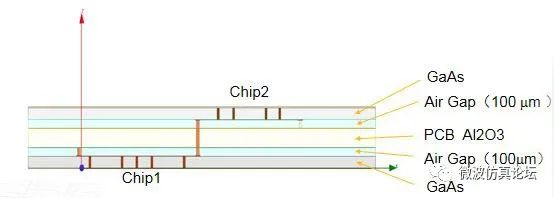
截面图
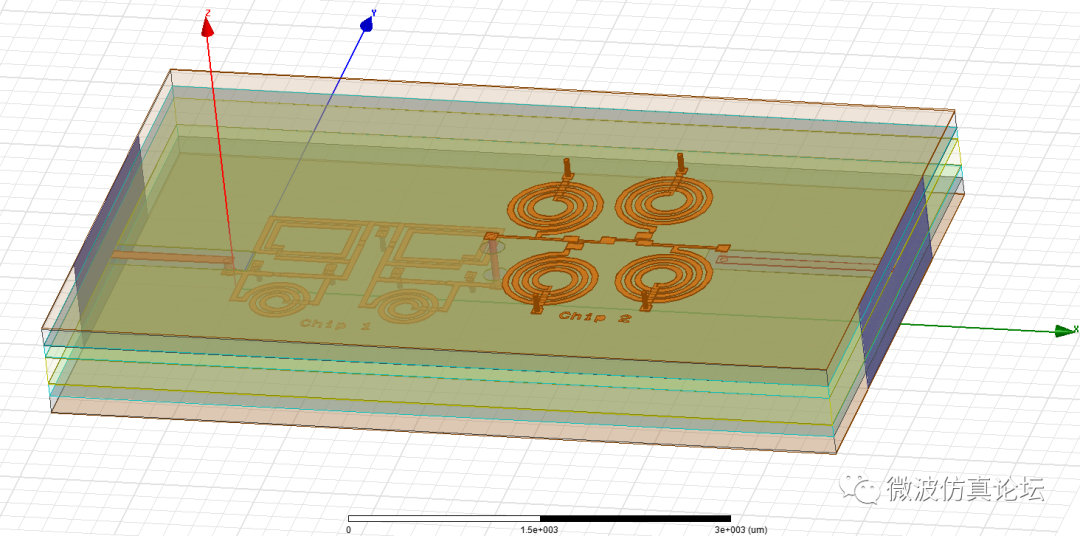
3D集成互连仿真模型
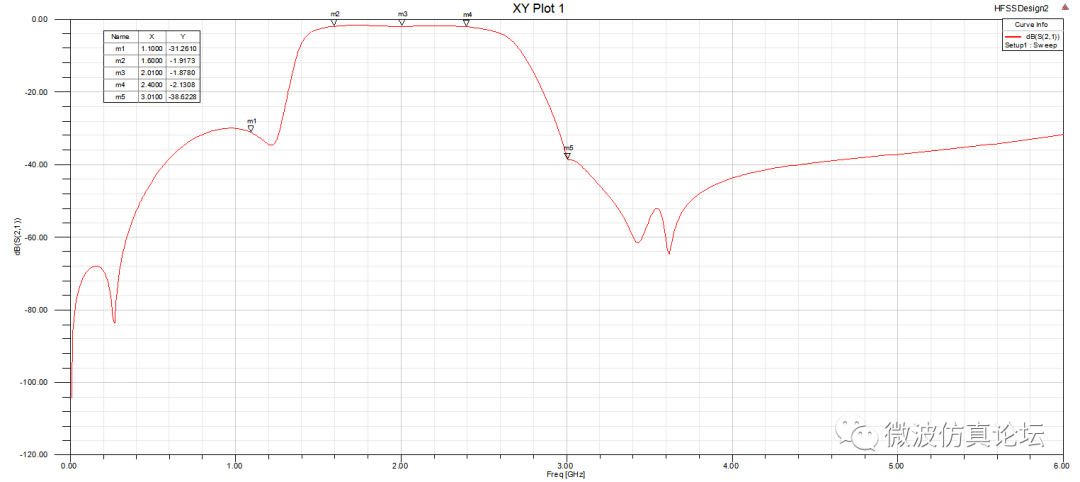
3D集成互连仿真结果
通带变为:1.6GHz~2.4GHz
原设计通带(Case1):1.4GHz~2.2GHz
频段偏移约10%。
小结
1,相较于平面型金丝互连,两个MMIC芯片3D集成互连之后,发生一定频偏,频带向高偏移约10%。
2,引起频偏可能的原因:
1) 3D集成的互连结构(通孔、铜柱、金球等)的寄生效应引起频偏,但相较于芯片中元器件如电感电容而言,该寄生参数相对较小,与金丝的寄生参数量级相当,故影响作用微小。
2) 3D集成引入了较小的空气腔,本设计空气腔高度为100μm(工程实践中会比这高度更低),带来了新的寄生效应,经分析,当空气腔高度为芯片基板3倍左右时,频偏现象可忽略。
3,通过本设计可以看出,应用于3D集成封装的芯片电路,若单纯采用传统平面型MMIC设计,3D封装后会造成一定的性能偏差。因此,需有针对性的做完整的3D集成封装MMIC优化设计,确保3D封装后满足电路指标要求。
审核编辑:汤梓红
-
3D封装技术能否成为国产芯片的希望?#芯片封装面包车 2022-08-10
-
3D封装2013-06-22 0
-
3D 模型封装2013-12-27 0
-
带3D封装的PCB库2015-03-07 0
-
3d封装2015-06-22 0
-
3D PCB封装库2015-08-06 0
-
altium designer 3D封装库2015-11-07 0
-
带有3D的封装2015-11-27 0
-
HFSS高频电磁场仿真应用2016-04-22 0
-
画PCB 3D封装问题2016-07-12 0
-
EMPro和HFSS有什么区别?2019-02-28 0
-
关于AD16的3D封装问题2019-05-10 0
-
如何让AD在3D显示下去除3D封装的显示?2019-09-23 0
-
AD16的3D封装库问题?2019-09-26 0
-
芯片的3D化历程2020-03-19 0
全部0条评论

快来发表一下你的评论吧 !

