

蔡司扫描电镜在第三代半导体领域的应用成果
电子说
描述
扫描电子显微镜-电子通道对比成像(SEM-ECCI)是在扫描电子显微镜下直接表征晶体材料内部缺陷的技术。SEM-ECCI技术的发展已经取代了透射电子显微镜(TEM)在缺陷表征领域的部分功能。与TEM分析相比,它提供了更高的吞吐量、更快的效率分析解决方案,并且具有更强的统计意义。
于该技术成像效率高,制样过程简单、无损,近年来在金属材料、化合物半导体等领域取得了很大的发展,也受到了越来越多的关注。
氮化镓异质结中穿线和失配位错的电子通道衬度成像分析。
异质外延生长的GaN/AlGaN薄膜材料广泛应用于光子学、电力电子学和微波射频器件中。随着GaN器件的小型化,其薄膜材料中位错缺陷的种类、面密度和分布已严重限制了器件的性能和可靠性。如何在不破坏薄膜材料的前提下精确表征GaN和GaN/AlGaN异质结中的位错缺陷仍是一个很大的挑战。
中国科学院苏州纳米研究所研究员范士钊,等基于蔡司场发射扫描电子显微镜沟道对比成像技术(ECCI)成功地分析了边缘位错、螺旋位错和混合位错的表面密度,并首次在GaN/AlGaN异质结中观察到。脱臼半环和位错滑移现象。
研究人员使用蔡司场发射扫描电子显微镜获得了GaN薄膜材料的菊池图案(图1)。通过系统地分析菊池晶带与垂直晶面和倾斜晶面的对应关系,准确地选择布拉格衍射条件,并将其用于位错通道衬度成像。

▲ (a)GaN薄膜的菊池花样及由电子束衍射的运动学理论计算得出的(b)垂直晶面和(c)倾斜晶面的菊池晶带分布图
通过比较不同双光束衍射条件下同一区域内位错对比度演化规律,将消光判据和位错对比度分布方向判据相结合,实现了位错Burgers矢量的确定(图2)。此外,通过分析基于电子通道衬度技术直接获得的位错类型比例和基于X射线衍射方法间接获得的位错类型比例,确定了电子通道衬度成像技术在分析混合位错方面的独特优势。

▲ 图2.同一区域GaN薄膜在不同双束衍射条件下的通道衬度成像及位错类型判定
最后,利用电子通道对比度成像技术对GaN/AlGaN异质结界面进行了直接测试,首次观察到位错半环,发现大量混合位错在界面处弯曲形成错位位错(图3)。通过分析位错弯曲的晶体学方向,发现在界面处存在位错滑移现象,为GaN器件的失效机理拓展了新的研究方向。
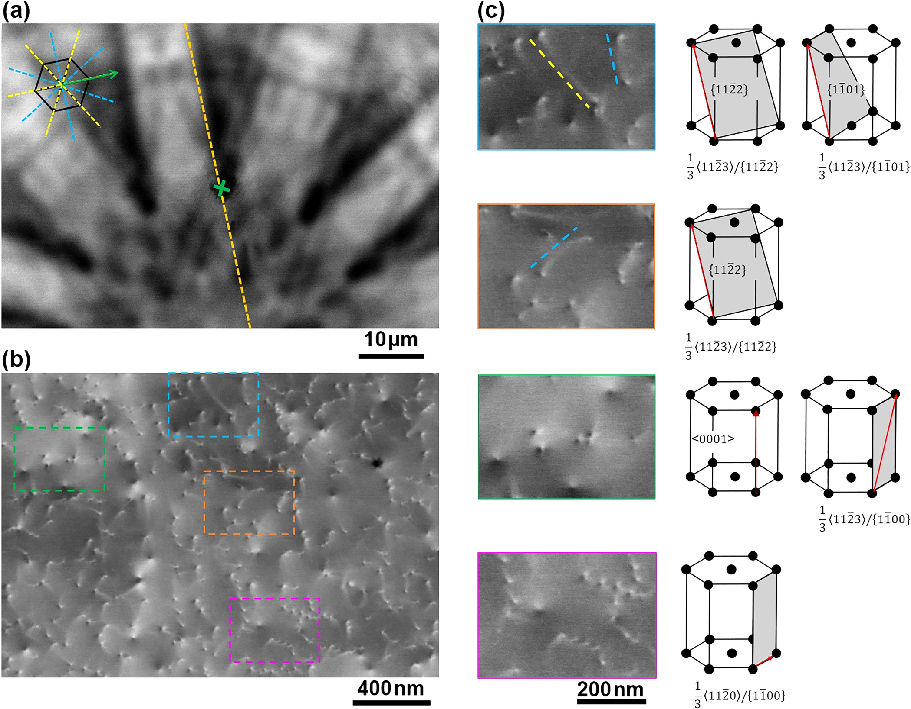
▲ 图3. GaN/AlGaN异质结的通道衬度成像及位错滑移体系的判定
审核编辑 黄宇
-
为什么我们要重视第三代半导体!#半导体 #硬声创作季Hello,World! 2022-10-06
-
什么是第三代移动通信2009-06-13 0
-
什么是IR-III技术(第三代红外)?2011-02-19 0
-
第三代红外技术(IR-III)并不是阵列式2011-02-19 0
-
第三代红外(IR3)技术与激光红外差别2011-02-19 0
-
liklon的第三代MP32013-08-10 0
-
第三代半导体科普,国产任重道远2017-05-15 0
-
第三代移动通信技术定义2019-07-01 0
-
碳化硅基板——三代半导体的领军者2021-01-12 0
-
中国第三代半导体名单!精选资料分享2021-07-27 0
-
基本半导体第三代碳化硅肖特基二极管性能详解2023-02-28 0
-
什么是第三代半导体?第三代半导体受市场关注2020-09-21 3850
-
蔡司扫描电镜在半导体领域的应用成果2023-07-31 408
-
蔡司扫描电镜与X射线显微镜检测介绍2023-12-15 202
-
蔡司场发射扫描电镜GeminiSEM 500介绍2023-12-20 344
全部0条评论

快来发表一下你的评论吧 !

