

工艺可靠性电迁移EM测试
描述
电迁移是金属线在电流和温度作用下产生的金属迁移现象——运动中的电子和主体金属晶格之间相互交换动量,金属原子沿电子流方向迁移时,就会在原有位置上形成空洞,同时在金属原子迁移堆积形成丘状突起。
前者将引线开路或断裂,而后者会造成光刻困难和多层布线之间的短路,从而影响芯片的正常工作。
为更好地满足客户EM测试需求,季丰电子提供EM测试样品制备服务,样品外形涵盖DIP8、DIP16、DIP24、DIP28等。
工艺可靠性电迁移(EM)测试
芯片经过长时间高温、大电流(密度),容易引起金属线metal-line或连接通孔Via失效,测试环境250~300°。
测试流程是通过在施加温度和电流时测量电阻,直至该颗测试样品达到设定电阻变化,被判定失效发生,测试实验终止。
样品制备流程:晶圆减薄划片-陶瓷管壳打线
陶瓷管壳焊线材质一般用金线和铝线,以下将2种材质的样品进行对比:
1. 陶瓷管壳封装-Au wire 实验温度条件 250°C

(FA picture of Au bond)
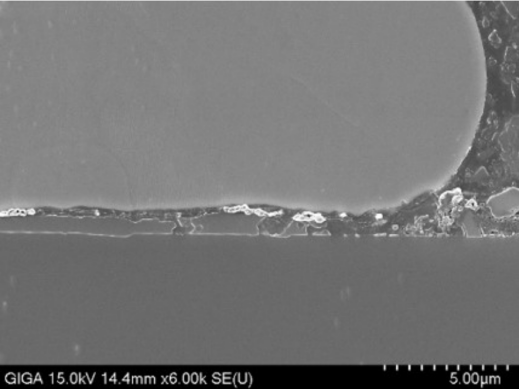
2. 陶瓷管壳封装-Al wire 实验温度条件 250°C
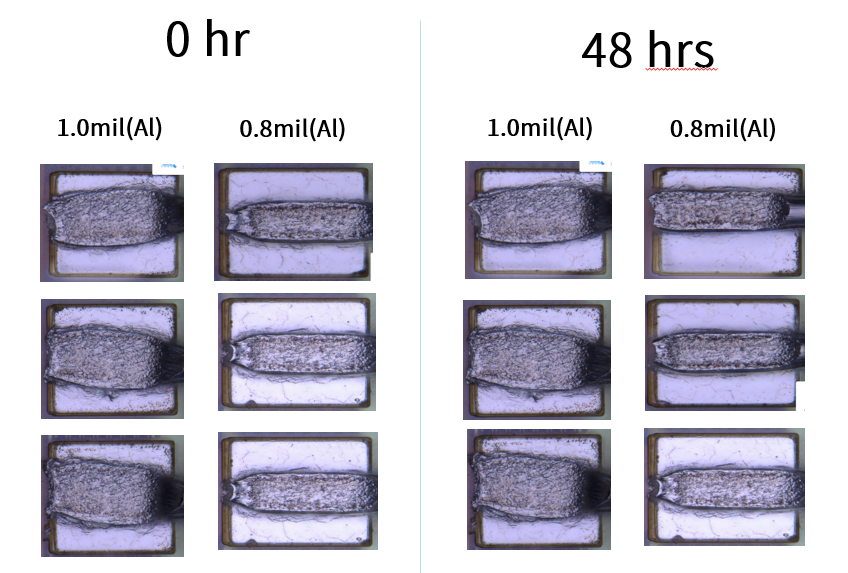
当温度处于250°C,时间达到48小时,顶部金属扩散到Au和Al衬底,会引起测试结构Open。
EM测试时需要250°以上高温,使用铝线制备EM样品最佳。
审核编辑:刘清
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
#硬声创作季 #可靠性 电子封装可靠性评价中的实验力学方法-3水管工 2022-09-29
-
#硬声创作季 #可靠性 电子封装可靠性评价中的实验力学方法-5水管工 2022-09-29
-
#硬声创作季 #可靠性 电子封装可靠性评价中的实验力学方法-6水管工 2022-09-29
-
电路可靠性设计与测试2011-07-25 0
-
可靠性测试2016-07-07 0
-
如何提高航空插头的可靠性?2017-08-01 0
-
汽车电子电器电性能测试和环境可靠性测试分解2018-02-05 0
-
可靠性验证2018-08-28 0
-
PoP的SMT工艺的可靠性2018-09-06 0
-
板阶 (BLR) 车电可靠性验证2018-09-06 0
-
GaN可靠性的测试2018-09-10 0
-
【PCB】什么是高可靠性?2020-07-03 0
-
什么是高可靠性?2020-07-03 0
-
单片机应用系统的可靠性与可靠性设计2021-01-11 0
-
航天电连接器的可靠性重要分析2021-03-25 0
全部0条评论

快来发表一下你的评论吧 !

