

电子元件失效分析
电子说
描述
电子元件是电子设备和系统产品的最基本组成部分,其性能和可靠性对电子设备和系统的安全可靠运行至关重要。随着电子信息产业的快速发展,以及对各行各业的快速渗透和融合,电子产品对电子元件性能和可靠性水平的要求也越来越高。此外,电子元件本身的性能日益先进、结构也日益复杂,应用日趋广泛,使用环境也变得更加严苛,这些都对电子元件的可靠性提出了更高的要求。
电子元件的门类繁多,从普通的电阻、电容、电感通用元件、机电元件、光电器件、半导体分立器件、微波器件及组件、电真空器件,直到大规模集成电路等, 其中只要有一个电子元件失效,整个电子设备或系统就不能正常工作,甚至导致灾难性的安全事故。而要确保每个电子元件的可靠性绝非易事,涉及到材料、工艺和应用的各个众多复杂的环节。
01
1、失效分析简介
- 基本概念
失效分析是指利用电学、物理、化学等技术手段对失效品进行分析,探究和查明失效机理和失效原因。
由于电子元件研制涉及到设计、工艺和材料选择等很多要素和复杂过程,其失效又与应用场景密切相关,不同的应用场景又涉及到包括电应力、机械、化学和气候环境应力等各种导致失效的要素。因此,失效分析需要声、光、电、热、物理和化学等各种高技术手段的综合运用,需要对产品和应用的了解,还需要有丰富的经验能够对各种证据之间的逻辑关系进行分析。
- 基本流程
失效分析的主要流程如下图所示,其中失效模式验证、确认失效机理,机理和原因验证是失效分析的关键步骤。

图2 失效分析流程图
在失效分析的过程中要坚持“先无损,后破坏,由外及里,由易到难”的原则,以避免失效证据丢失或产生假证据。
- 价值和意义
失效分析是指利用电学、物理、化学等技术手段对失效品失效分析,目标是寻找失效的原因和机理,因此失效分析的价值不在于分析本身,而在于其目标的达成与否,以及根据失效原因和机理所做的改进所带来的巨大价值和意义。此外,通过对失效分析获得的失效机理和案例数据分析整理,形成专家系统,可以很好地指导设计、优化工艺、选择材料、制定筛选方法、改良试验方法和规范标准等,从而进行分析、探究和查明失效机理及失效原因。
02
2、失效分析技****术简介
- 外观检查技术
外观检查是失效分析的开始,一般都是无损的,主要是对失效电子元件或模块的外部外观、失效周边的微环境,以及开封后内部电路和模块的外观的检查,目的是发现失效的现场或区域,以及导致失效的线索和直接证据,具体包括机械损伤、腐蚀、污染氧化、热电烧毁、密封与端子异常和标识等。传统的检查技术一般都是通过放大镜或立体显微镜和金相显微镜目测或检查,通常可以实现几十到上千倍的放大倍数。
- 电性能分析技术
电性能分析技术是指在各种温度条件和频率条件下的阻容感抗测试、半导体和集成电路的端口测试等,测试分析电子元件参数变化、异常节点和端口,为失效定位或分析方向提供依据。可分析出连接性失效、电参数失效和功能失效三种失效模式。其中,连接性失效多由静电放电(ESD)和过点应力(EOS)引起;电参数失效主要表现形式有电参数值超出规定范围或者参数不稳定,而对功能失效的分析主要用于集成电路。
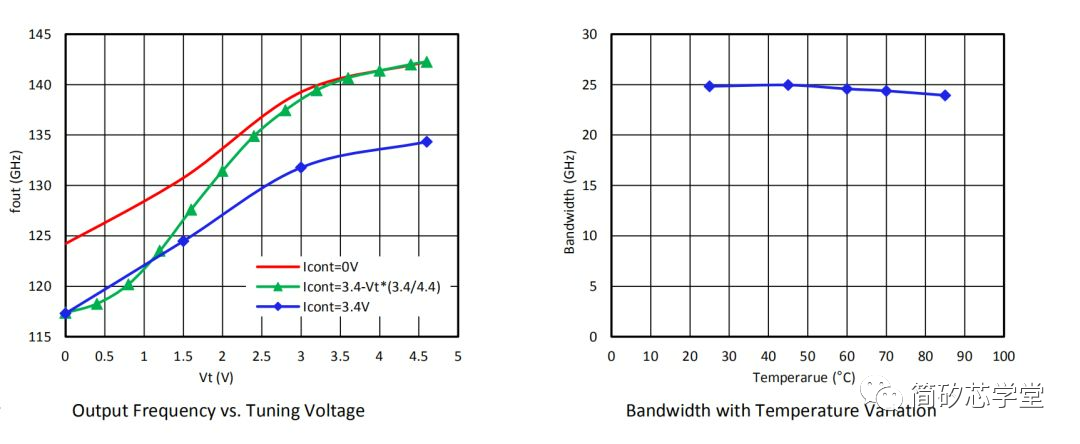
图3 芯片电性能分析示例
- 显微形貌技术
现代显微分析技术是失效分析最为核心的技术手段。主要是利用先进的扫描电子显微镜(SEM)、透射电镜(TEM)和原子力显微镜(AFM)技术分析失效点或疑似失效部位的微观结构和金相组织及其在应力条件下的演变、研究失效机理。如图4所示,利用SEM对TSV进行失效分析,发现三个失效品分别出现空洞、裂纹、填充缺失缺陷。

图4 利用扫描电子显微镜对TSV进行失效分析
- 无损结构分析技术
以X射线透视技术和声学扫描显微镜(SAT)为代表的结构无损分析技术,用以检测元器件的封装情况,如气泡、邦定线异常、晶粒尺寸、支架方向等。它可以分析板级的大样品,分辨率达到纳米级,对于高密度封装的电子元件内部结构缺陷分析定位是一种非常有力而方便的技术手段。如图5所示,利用X射线对TSV进行扫描后经三维模型重建后发现,失效品存在明显缺陷。
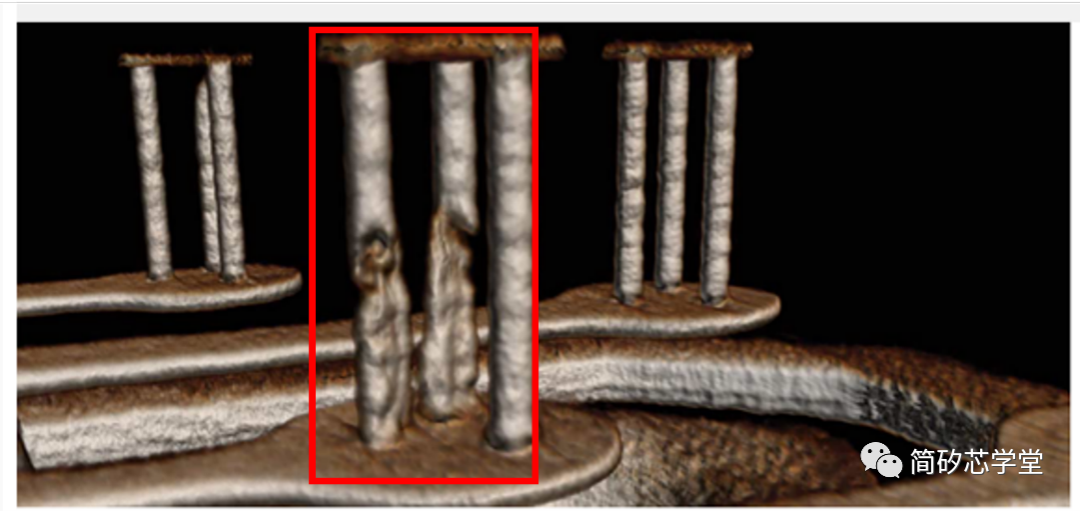
图5 利用X射线对TSV进行失效分析
- 开封制样技术
开封主要用于暴露封装体内部芯片,以便于观察芯片表面的形貌结构和进一步开展电测试。激光开封技术和先进的微波等离子体(MIP)开封技术很好地解决了复杂芯片封装的开封制样问题。
切片主要用于制作电子元件封装的关键截面,便于观察分析结构缺陷或互联界面的结构形貌。先进的双束聚焦离子束(FIB)利用高能离子束在可疑失效部位做微米级的切割修饰或制作切片,现已广泛地应用于集成电路的失效分析制样。以3D封装里硅通孔TSV为例,图6展示了FIB在失效分析中的作用。

图6 利用双束聚焦离子束对TSV进行失效分析
- 微区成分分析技术
由于污染氧化、腐蚀、迁移、工艺和环境导致的电子元件或芯片表面或微区产生化学成分的变化,而导致失效的案例比比皆是,因此微区成分的原位分析就非常重要。除了与扫描电子显微镜(SEM)配合使用的能谱分析(EDS)以外,还有很多高灵敏度的分析技术也达到了普遍的应用,包括光电子能谱(XPS)、俄歇电子能谱(AES)、二次离子质谱(SIMS)和傅立叶红外光谱(FTIR)等。
- 其他物理分析技术
利用电子元件特别是芯片内部缺陷在工作或非工作状态下产生光或热效应的原理来进行失效定位的物理分析技术这些年来发展迅速。例如,利用激光束扫描芯片电路产生电阻变化的差异来进行失效定位的光束感生电阻变化;利用电子束扫描芯片表面产生的电压衬度像来临侦测开路或短路的失效部位;利用红外探头扫描工作状态下样品表面的热辐射,并将其转换成温度分布的显微红外热像技术,根据异常点的温度变化来做失效定位,等等。
03
3、失效分析发展趋势
在5G、车载电子、消费电子和新基建等相关应用的带动下,高可靠性电子元件和半导体市场将迎来爆发性的增长。一方面,为了提高芯片单位面积的处理能力,半导体芯片制程已进入5nm时代。另一方面,以碳化硅(SiC)和氮化镓(GaN)等第三代半导体材料为代表的高功率半导体、激光雷达也越来越受到关注。此外,为了满足高密度小型化产品需求,以SiP、SOP为代表的新型2.5D/3D封装技术逐渐兴起。这些先进制程、先进材料及先进封装的采用和发展导致电子元件失效分析的难度大大增加,技术更加复杂和多样化。失效分析在集成电路产业链中的重要性越来越大,越高端的芯片对失效分析技术的要求越高。
-
电子元件-固态电子元件2011-01-07 0
-
电子元件失效分析2012-10-19 0
-
电子元件的失效分析2012-10-19 0
-
电子元件综合知识2009-11-17 967
-
电子元件符号图标表2008-04-18 18093
-
电子元件件的基本定义2009-12-03 2208
-
电子元件符号及术语2010-01-16 5346
-
电子元件介绍2015-11-30 1048
-
电子元件基础教程2016-01-20 1121
-
电子元件使用2016-12-09 1343
-
电子元件的输出电流是什么意思2018-04-09 16546
-
如何选择电子元件,它的挑选标准有哪些2020-06-17 2582
-
基础电子元件有哪些?2023-10-27 1512
-
电子元件的寿命期是多久2023-10-27 1591
-
汽车电子元件的失效分析2023-11-20 127
全部0条评论

快来发表一下你的评论吧 !

