

极紫外 (EUVL) 光刻设备技术应用分析
制造/封装
描述
这份报告详细介绍了在工作组会议上讨论的EUVL技术方面。首先,我们分成三个部分讨论了EUV光源模块,讨论了与EUV光互动的组件的现状和需求,介绍了如何利用EUV光作为计量工具来分析半导体制造过程中的组件。这个计量工具方面与讨论的辐射度有直接关联。
这些部分深入探讨了计量学、光源生成和半导体材料在EUVL生态系统内的相互关系,这些技术细节已经公开发布。将行业和NIST研究的技术专业知识和状态整合到一份报告中有助于更好地理解技术领域,报告中还包含了参考文献,以补充提供的技术细节。
● 滴液生成器
滴液生成器是欧洲极紫外光刻(EUVL)技术中的一个核心组件,对于半导体制造至关重要,在EUVL扫描仪的装配中担当重要角色,负责控制进入EUV光源室的材料的大小、速度和重复频率。
这些材料经过CO2激光的离子化过程后,将生成高度精密的13.5纳米EUV光,用于半导体芯片的生产。滴液生成器的作用非常关键,性能问题会直接影响到整个EUVL系统的稳定运行。如果滴液生成器出现故障,将会导致所有下游组件受到影响,从而导致整个制造过程中断。为了确保EUV光的可靠生成,滴液生成器必须能够可靠地交付微小的液滴,这些液滴通常具有27微米的直径,以每秒80米的速度运行,并且以每秒50千赫兹的频率重复生成。

可以说滴液生成器是整个EUVL系统的"心脏",运行状况直接影响到半导体制造的连续性和效率。在EUVL应用中,滴液生成器使用高纯度锡(>99.999 wt.%)作为工作流体,因为锡在离子化成等离子体后,能够产生所需的13.5纳米波长的光。
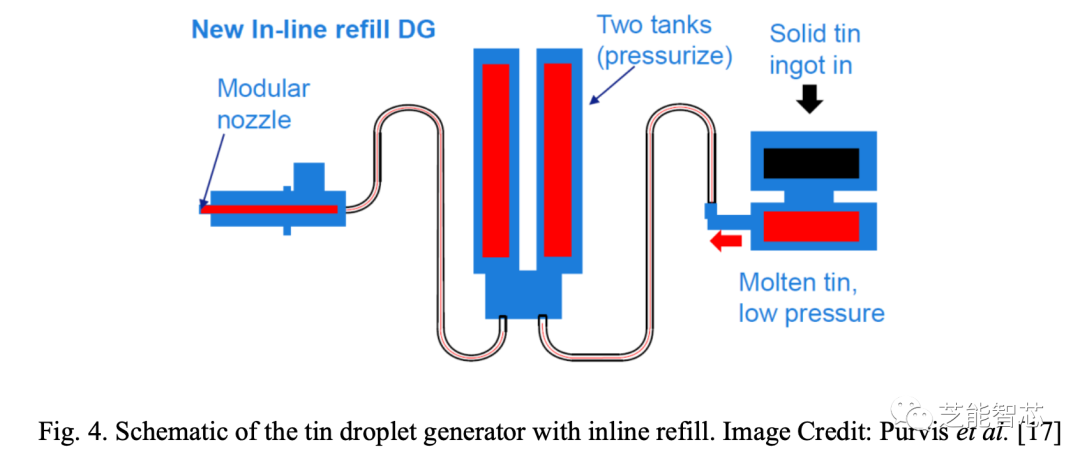
尽管近几十年来研究人员也研究过其他材料,如氙和锂,但从安全性、成本和性能等方面考虑,锡被证明是EUVL制造应用中最优选择的材料。目前,还没有公开的技术路线图指出除了锡以外的其他材料可以用于半导体制造中的EUV光源。对锡的基础科学水平进行深入研究将在近期和长期内产生重要影响。滴液生成器的操作原理是将高纯度固态锡装入一个容器中,然后加热到熔点以上(约232°C)。通过一个高纯度气体(通常是氮气)对容器中液体施加压力,使熔融锡通过过滤器流向另一端的喷嘴。通常情况下,锡滴液由一个压电晶体(PZT)调制,通过机械振动来实现。这种滴液生成器的位置稳定性非常高,误差仅为1微米。
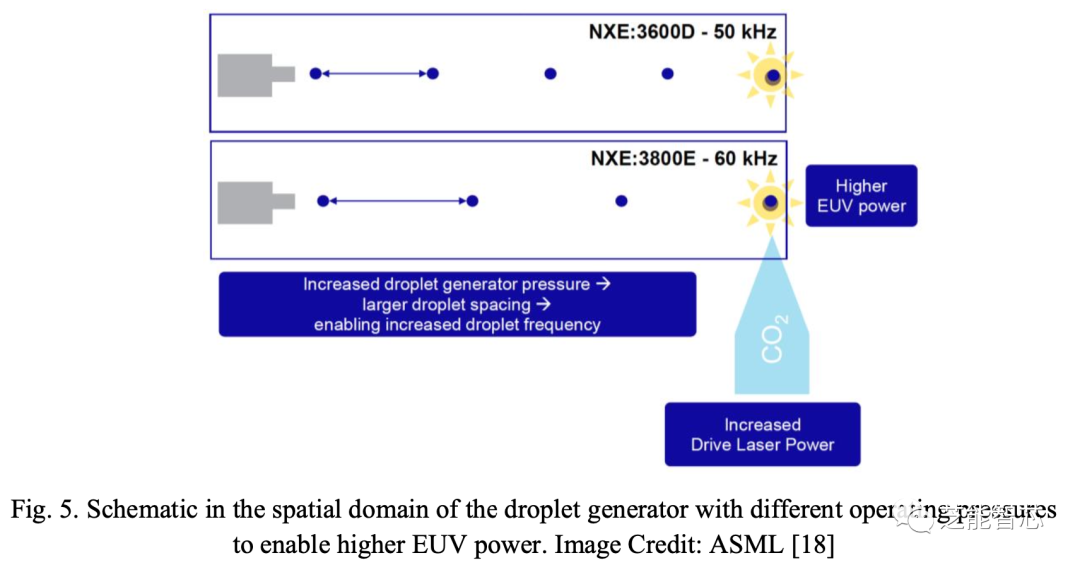
2021年,滴液生成器取得了新的进展,具备了在线补充功能,这可以降低系统停机时间,而不会影响下游EUV扫描仪的性能。这个新设计已经实现了超过3000小时的连续运行。
目前的挑战之一是缺乏在高于大气压的高压条件下的熔融锡的可靠材料性质数据,这阻碍了对滴液生成器的数值模拟。科学家和工程师们目前的实践是从已发布的文献中获取最接近的材料性质数据,然后推导出粗略的估算。接着,他们依赖于在操作条件下对整个系统的经验观察,来调整材料性质和操作参数之间的关系。
这种情况下,NIST(美国国家标准与技术研究院)的金属材料性质测量资源对于提供准确的材料性质数据至关重要。NIST的合金数据库是一个精选的数据库,包含金属的实验热物理性质数据,包括锡。
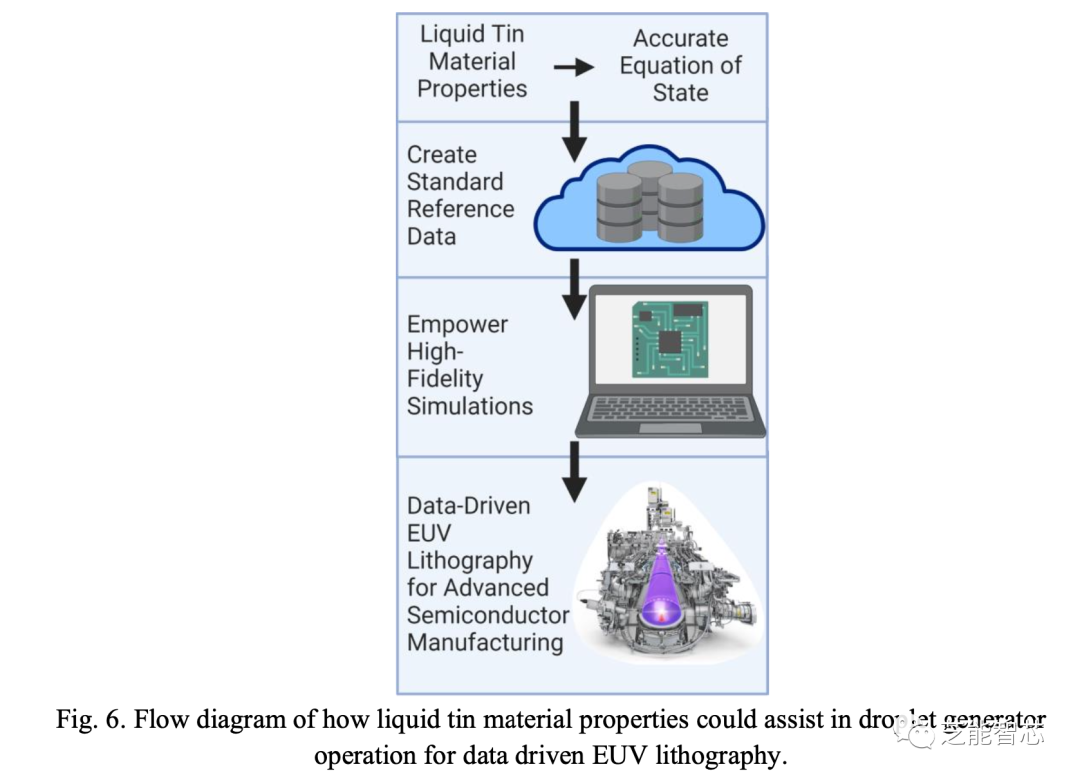
通过将这些数据整合到模拟软件中,可以实现高精度的滴液生成器模拟,从而提高EUVL技术的性能并推动创新。NIST还可以为锡等材料开发参考相关性和状态方程(EoS),进一步支持高保真度的模拟,以及数据驱动的EUVL技术发展。除了热物理和传输性质外,还需要在高压和高温条件下测量锡的结构和压电性质等数据,以帮助滴液生成器的设计和操作。这需要特殊的仪器和资源来开发和执行。
滴液生成器在EUVL技术中扮演着不可或缺的角色,而其性能的优化对于提高EUV芯片的生产效率至关重要。通过测量和理解锡在极端条件下的性质,可以为EUVL技术的发展提供有力支持,并推动模拟和创新,从而使当前设备更加高效,并为未来的设计创新打下坚实的基础。
● EUV 生成的辐射测量
极紫外光刻(EUVL)的辐射度用于EUV光的产生,而工业级EUVL工具主要涉及两种类型的光:脉冲的、高功率的红外(IR)激光用于离子化熔融锡(Sn),以及用于光刻的波长为13.5纳米的光。前者由专门设计的CO2激光器(波长λ = 10.6微米)提供,其平均功率约为30千瓦,重复频率为50千赫兹。锡离子化过程包括两个快速连续的IR激光脉冲:一个预脉冲将液滴从球形变成圆盘状,第二个更高能量的主脉冲用于离子化过程。
IR激光的输出对于开发未来的光刻工具至关重要。目前商用的光刻工具中,13.5纳米EUV光的最大不相干输出功率约为250瓦,实验室中已经演示出了600瓦的功率,这两个脉冲系统的示意图如图所示。
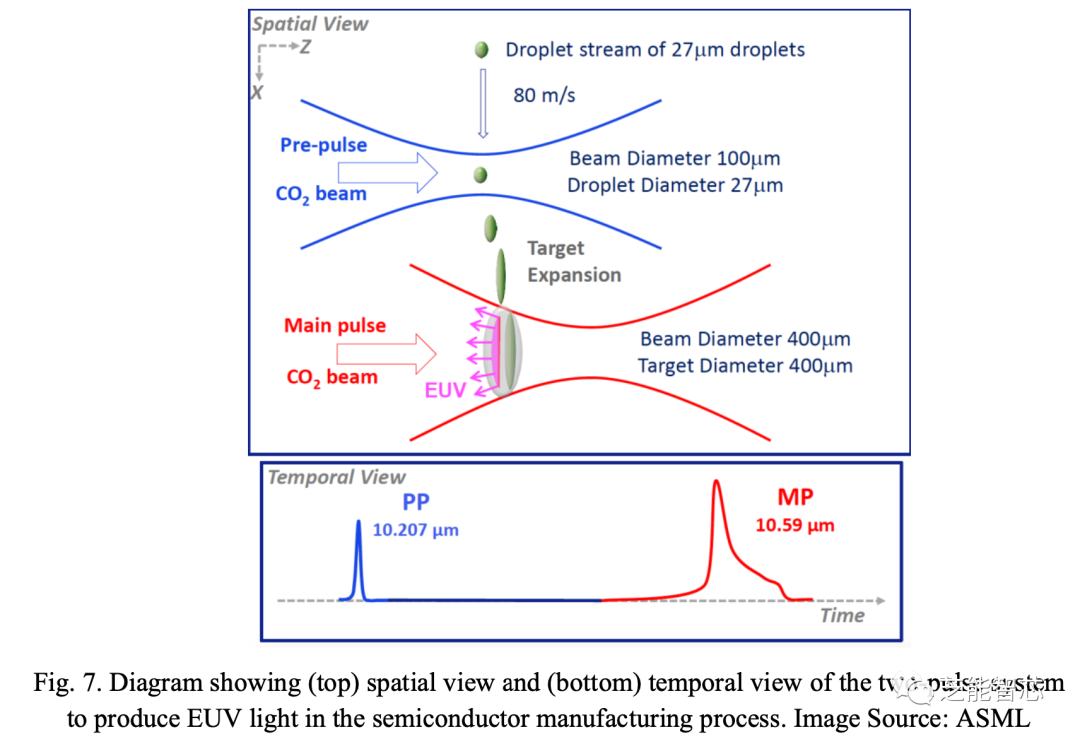
在EUV范围内还进行了其他光学特性的测试,包括滤波器透射和空间均匀性测试。一个计量学研究机会是扩展NIST的校准能力,以涵盖输入的IR激光光线、用于推断中段功率的EUV闪烁体以及直接的最终输出EUV光,所有这些都在与工业EUVL相关的条件下进行。这将立即影响半导体制造工艺开发,为关键工艺参数提供可追溯的计量学。长期的影响将来自于未来EUV仪器的发展,为验证EUV生成模拟提供高保真度的数据。绝对辐射度不仅对于光刻工艺开发和仪器验收测试非常重要,还对EUV光生成过程的准确量化至关重要。
● EUVL光谱计算
欧洲极紫外光刻(EUVL)技术利用波长为13.5纳米的光子来制造集成电路。产生这种光的主要来源是使用强大激光器产生的热锡等离子体。激光参数被调整以产生大多数在13.5纳米附近发射的锡离子(例如Sn10+-Sn15+)。
大多数等离子体特性已经在许多实验中得到了探索,但可靠且经过验证的理论支持对于开发更好的锡等离子体源至关重要。针对锡的激光产生等离子体的光发射的高级计算通常使用大规模碰撞辐射(CR)代码来进行,试图考虑导致光子辐射的最重要的物理过程。这些过程包括电子碰撞激发、去激发和电离、辐射、双电子和三体复合,以及自发电离等。此外,辐射传输和不透明度也可能是必要的,以及辐射流体动力学建模。等离子体建模也存在局限,因为对支撑物质相互作用的基本物理机制了解不足。这可能导致等离子体工程努力只能在支持高产量制造方面进行渐进式改进,而不是革命性的。
工业与政府实验室的合作伙伴关系曾试图理解并控制等离子体过程,复杂的模拟涵盖了跨越不同时间尺度的多个物理领域。对于使用等离子体建模来指导提高EUV光的产生和效率的工程存在一些问题。例如,对于建模带外光子和离子和电子的发射,可以提供有益的预测性见解,极大地有益于芯片生产的效率。另一个关注领域是EUV光刻光刻胶的光子、电子和化学相互作用,这是EUVL行业持续关注的研究兴趣。因此,建模等离子体物理也适用于EUV光学组件。EUV光学和材料将在第2篇中进行讨论。
在过去的三年里,EUVL建模社区开始了一个长期的CR代码验证计划,通过组织EUVL代码比较研讨会来进行。这种方法是根据美国国家标准与技术研究院(NIST)原子光谱学组组织的超过25年的非局部热力学平衡(NLTE)代码比较研讨会系列而建立的。因此,NIST原子光谱学组(ASG)被要求开发一个新的EUVL数据库和现代比较工具,用于智能比较EUVL的CR代码。到目前为止,已经成功完成了所描述的工作,没有直接的财政支持,而且参加了最后两次EUVL研讨会的参与者使用了数据库和用户界面来比较他们的软件包。
NIST研究人员报告的一个未来方向是基于多层反射镜的可用性而进行更短波长方案的研究。这将产生比锡重元素更重的元素产生的更短波长的光子(所谓的“超越EUV”)。研究社区对20多次电离的高Z元素的光谱知识不足。NIST ASG具有完全的实验和理论能力,为未来等离子体源提供了EUVL社区最精确的光谱数据。
NIST电子束离子陷阱(EBIT)不仅可以生成带电高达70+的离子,还可以在EUV和软X射线区域内记录最精确和详细的光谱,因为在这个光谱范围内有精密光谱仪可用。NIST ASG团队还使用最先进的原子方法和代码进行高精度大规模光谱计算。这种已经被证明的能力应该满足EUVL对未来等离子体源精确数据的需求。值得注意的是,当询问工业代表关于EUV的未来来源时,他们表示在不久的将来没有使用锡以外的源材料的公开计划。
编辑:黄飞
-
极紫外光刻机EUVL和深紫外光刻机DUVL的差异电厂运行娃 2022-10-15
-
放电等离子体极紫外光源中的主脉冲电源2010-04-22 0
-
光刻技术原理及应用2012-01-12 0
-
光刻胶2018-07-12 0
-
光刻机工艺的原理及设备2020-07-07 0
-
光刻胶材料的重大突破 极紫外光刻迈向实用2010-06-17 1484
-
ASML答应提早交付三星已经同意购买的极紫外光光刻设备(EUV)?2020-10-24 1540
-
台积电已向阿斯麦预订2021年所需极紫外光刻机2020-11-17 1690
-
ASML研发更先进光刻机 高数值孔径极紫外光刻设计基本完成2020-12-29 2349
-
未来极紫外光刻技术将如何发展?产业格局如何演变?2021-02-01 2662
-
高NA EUVL:光刻的下一个主要步骤2022-07-26 1608
-
虹科案例 | 用于低成本改造光刻设备的UV紫外光源2023-07-05 1166
-
EUV光刻市场高速增长,复合年增长率21.8%2023-08-07 448
-
美国NIST发布极紫外光刻分析报告2023-09-11 798
-
光刻机的基本原理和核心技术2024-04-25 247
全部0条评论

快来发表一下你的评论吧 !

