

AlGaN/GaN结构的氧基数字蚀刻
电子说
描述
引言
宽带隙GaN基高电子迁移率晶体管(HEMTs)和场效应晶体管(fet)能够提供比传统Si基高功率器件更高的击穿电压和电子迁移率。常关GaN非常需要HEMT来降低功率并简化电路和系统架构,这是GaN HEMT技术的主要挑战之一。凹进的AlGaN/GaN结构是实现常关操作的有用选择之一。
由于对栅极电介质厚度、均匀性、质量和表面形态的高要求,凹槽蚀刻在GaN HEMT的制造中是非常关键的步骤。通过使用氯(Cl2)或三氯化硼(BCl3)等离子体的反应离子蚀刻(RIE)在AlGaN和GaN之间会产生高选择性,同时,它们也会对AlGaN造成损伤,这会显著影响均匀性、表面质量和形态。
实验与讨论
在这项工作中,英思特使用电感耦合等离子体(ICP)工具中的氧等离子体作为氧化剂。从上到下,Si上的外延层是2.5nm GaN盖层、19nmAl0.25Ga0.75N阻挡层、0.8nmAlN间隔层和700nm本征GaN以及缓冲层。
我们将晶片分成五组,每组分别进行三到七次数字蚀刻循环。数字蚀刻的流程图如图1所示。
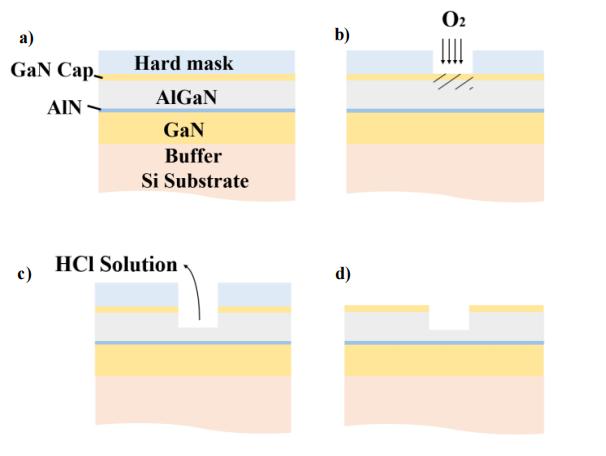
图1:显示外延结构的横截面的示意图
数字蚀刻是通过具有450W的ICP功率和40W的RF偏置功率的O2等离子体氧化AlGaN。英思特在75和40W下做了一系列测试,在湿法蚀刻步骤中,使用HCl溶液(去离子水∶HCl = 5∶1)中的90秒蚀刻。
通过原子力显微镜(AFM)测量AlGaN蚀刻深度。在每个样品上,测量六个点的深度,并使用平均蚀刻深度。蚀刻深度测量误差为1nm。在AFM测量之前,通过BOE溶液蚀刻掉硬掩膜和GaN覆盖层的天然氧化物。
随着AlGaN被更多的HCl溶液和氧等离子体轰击蚀刻,蚀刻将持续进行。在第6次循环后,厚GaN层暴露于ICP中的氧气,并被氧化成GaN3,其可以溶解在HCl溶液中。因此,在第6次循环后,蚀刻深度继续增加。
图2中比较了AlGaN/GaN样品在3次和7次数字蚀刻工艺循环后的表面形态,其通过AFM在每个样品的6个区域上测量,扫描面积为1×1μm2。随着循环次数的增加,粗糙度略有下降。然而,第6个周期的均方根粗糙度略有增加。由于AlN的厚度非常薄(0.8nm),该层的外延生长导致更高的AlN厚度不均匀性,并因此导致更高的Al2O3厚度不均匀性。
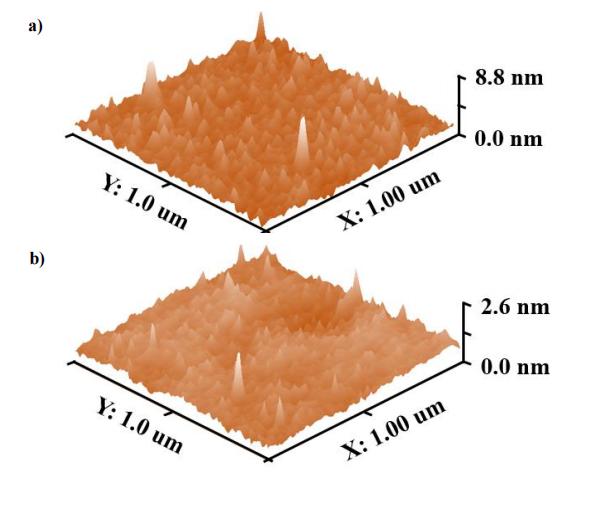
图2:AFM图像显示
结论
英思特通过使用ICP蚀刻机研究了GaN上具有0.8nmAlN间隔物的Al0.25Ga0.75N的基于O2等离子体的数字蚀刻。在40W RF偏压功率和40sccm氧气流量下,Al0.25Ga0.75N的蚀刻深度为每周期5.7nm。0.8nmAlN间隔层充当AlGaN凹陷的蚀刻停止层。
在数字蚀刻循环后,表面粗糙度改善到0.330nm。与仅干法蚀刻的方法相比,这种技术造成的损伤更少。与采用湿法蚀刻方法的选择性氧化相比,这种方法对外延生长的要求较低,并且节省了氧化工艺。AlN作为用于数字蚀刻的蚀刻停止层的存在保证了用于制备栅极凹陷HEMT的更好的凹陷控制。
江苏英思特半导体科技有限公司主要从事湿法制程设备,晶圆清洁设备,RCA清洗机,KOH腐殖清洗机等设备的设计、生产和维护。
审核编辑 黄宇
-
《炬丰科技-半导体工艺》GaN的晶体湿化学蚀刻2021-07-07 0
-
《炬丰科技-半导体工艺》GaN晶体蚀刻的几何方面和光子应用2021-07-08 0
-
《炬丰科技-半导体工艺》GaN 纳米线制造和单光子发射器器件应用的蚀刻工艺2021-07-08 0
-
《炬丰科技-半导体工艺》GaN、ZnO和SiC的湿法化学蚀刻2021-10-14 0
-
功率AlGaN_GaN肖特基二极管结构优化设计_徐儒2017-01-08 491
-
AlGaN和GaN界面陷阱对AlGaN与GaN及HEMT负阈值电压漂移的影响说明2019-10-09 2601
-
四甲基氢氧化铵水溶液湿蚀刻中AlGaN/AlN摩尔分数关系2021-12-13 1342
-
采用可控湿法蚀刻速率的AlGaN/GaN的精密凹槽 华林科纳2021-12-13 2247
-
关于AlN和GaN的刻蚀对比研究—江苏华林科纳半导体2022-01-14 2671
-
通过紫外线辅助光蚀刻技术实现的湿式蚀刻2022-02-14 785
-
AlGaN/GaN的光电化学蚀刻工艺2022-07-12 1151
-
GaN的晶体湿化学蚀刻工艺详解2022-07-12 3553
-
一种阳极连接P型埋层的AlGaN/GaN肖特基二极管2023-02-13 702
-
关于铝镓氮(AlGaN)上p-GaN的高选择性、低损伤蚀刻2023-11-27 387
-
在氮化镓和AlGaN上的湿式数字蚀刻2023-11-30 225
全部0条评论

快来发表一下你的评论吧 !

