

华为公布一项“半导体封装”专利
制造/封装
描述
天眼查显示,华为技术有限公司近日公布了一项“半导体封装”专利,申请公布日为2023年10月31日,申请公布号为CN116982152A。

图源:天眼查 专利摘要显示,本公开涉及一种半导体封装,该半导体封装包括:第一衬底、半导体芯片、引线框和密封剂。 该密封剂的下主面包括在第一平面中延伸的第一部分、在第二平面中延伸的第二部分、在该第一平面与该第二平面之间的第一过渡区中延伸的第三部分,以及在该第二平面与至少一个引线之间的第二过渡区中延伸的第四部分。该密封剂的该第一部分和该第一衬底的下主面在相同的第一平面中延伸,该第一平面形成该封装的下散热表面。该密封剂的该第二部分、该第三部分和该第四部分的尺寸被设置为在该密封剂的该第一部分与该至少一个引线之间保持第一预定义最小距离。
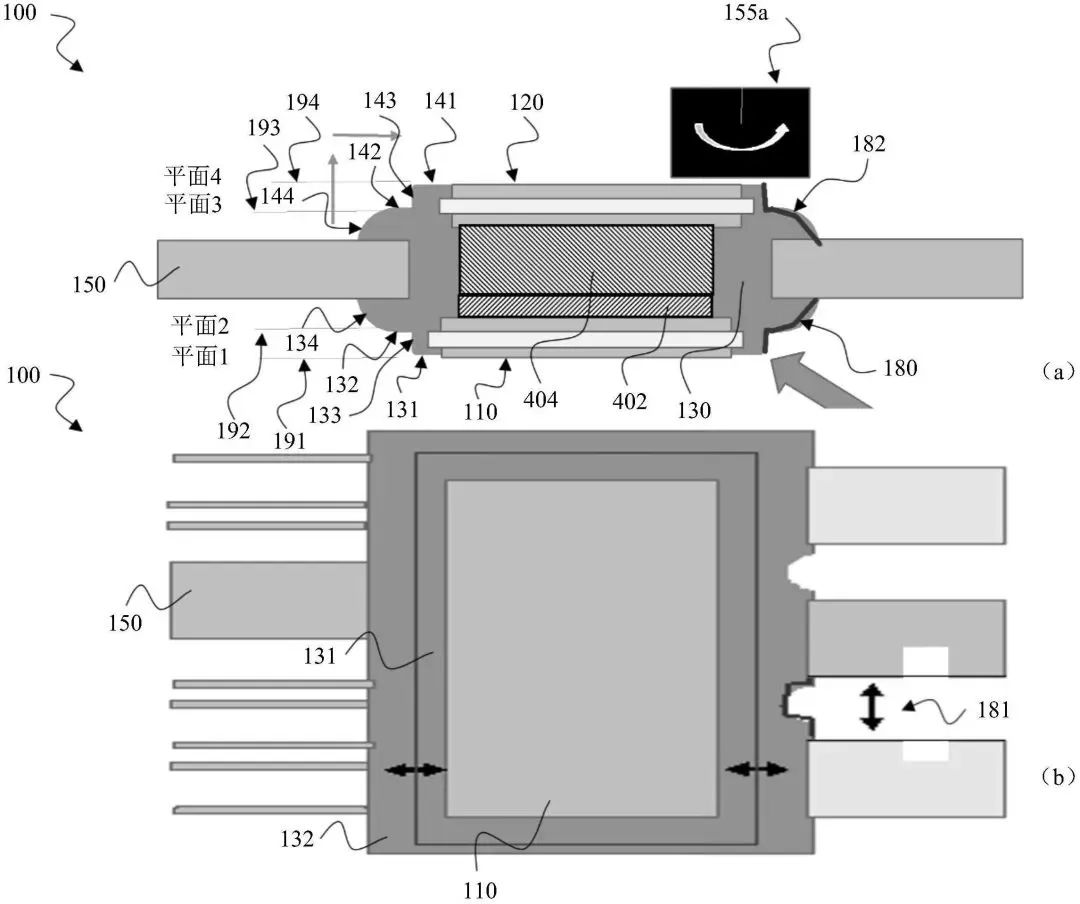
图源:天眼查
华为封装新专利对麒麟的解决方案——对于麒麟9000s的量产,国内和国外从发售之日起,便不停的研究,最终也没得出什么结果。但拆机结果有两点:第一,麒麟9000s比麒麟9000大了一圈;第二,麒麟9000s散热方面做了特殊结构。 这两点与华为这份封装专利不谋而合,尤其是散热方面,专利里有详细介绍与解决方案。这份专利较为新颖,相较于其他工艺,绝缘、散热、引线增量较多。 当前国内龙头封测厂商均有50%以上收入来自先进封装业务,在先进封装技术实现持续突破。方正证券表示,机器学习及AI相关应用对数据处理能力提出了更高的要求,先进封装实现超越摩尔定律,助力芯片集成度的进一步提高。
在先进封装市场中,2.5D/3D封装增速最快,2021至2027年CAGR可达14.34%。测试机领域,泰瑞达(美国)、爱德万 (日本) 分别有51%和33%的全球市场,分别在存储测试机和SOC测试机领域占据优势,国产厂商亦在高端封测品类持续发力。
开源证券认为,我国先进封装设备国产化率整体低于15%,后道测试机、分选机是国产替代进展最快的环节,国产化率超过10%;贴片机、划片机等后道设备国产化率仅约3%、TSV深硅刻蚀、TSV电镀设备、薄膜沉积等制程设备几乎都进口自海外。先进封装需求高增、产能紧缺,国内长电科技、通富微电、华天科技等封测厂也在加大2.5D/3D等先进封装平台的布局,在供应链自主可控需求下,国产设备厂商迎来发展良机。
编辑:黄飞
-
半导体芯片的制作和封装资料2023-09-26 0
-
华为公布“芯片堆叠封装结构及其封装方法、电子设备”专利 #华为 #华为芯片面包车 2022-08-10
-
山东高唐杰盛半导体科技有限公司2013-09-13 0
-
下图中的与打开文件相连的枚举常量是自己一项一项编辑...2014-03-17 0
-
半导体Acrich3 智能照明应用方案分享2015-04-07 0
-
半导体测试解决方案2019-07-29 0
-
芯片荒半导体封装需求激增,斯利通陶瓷封装基板供不应求2021-03-31 0
-
半导体封装,半导体封装是什么意思2010-03-04 12054
-
苹果又公布一项Micro LED新专利2018-11-13 3905
-
华为拍摄月亮专利公布2019-07-23 2716
-
华为公布芯片堆叠专利,能否解缺芯燃眉之急2022-05-09 24516
-
华为公布两项芯片堆叠相关专利2022-05-09 5543
-
华为芯片封装新专利公布!2023-08-08 1247
-
华为公布一项倒装芯片封装技术:能大幅改善CPU散热2023-08-18 1095
-
华为公布一项名为“钠电池复合正极材料及其应用”的发明专利2024-04-07 712
全部0条评论

快来发表一下你的评论吧 !

