

芯片制程之常见的金属化制程
制造/封装
描述
芯片的电子信号的传递需要金属的参与,因此金属化是芯片制程中必不可少的步骤之一。金属化的方式多种多样,我们今天就来介绍一下最常见的金属化制程。
1 什么是金属化
金属化(Metallization)指在晶圆上形成图形化的金属导电薄膜。
2 金属化的作用? 2.1互连作用 主要用于互连不同的电子组件,如晶体管、电阻、电容等。IC是由数亿甚至数十亿的晶体管组成,这些晶体管在硅片上并行工作。但是,如果这些晶体管不能相互导通,那么它们就不能实现指定功能。而这些互连金属电路像是IC的血管,确保电子信号在不同组件之间的顺利传输。
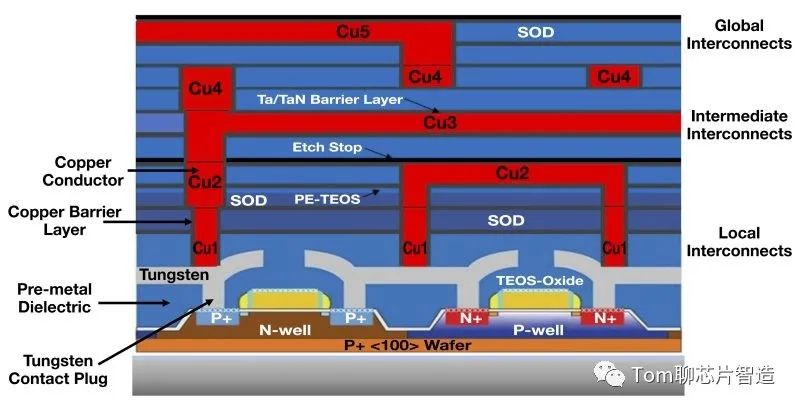
2.2充当阻挡层
阻挡层的作用是防止不同金属层间的电子迁移,将不同金属层之间相互隔离,避免物质之间的扩散或渗透等。另外,阻挡层有时也被用作其他材料层之间的粘附层,确保新沉积的材料可以牢固地附着在基底上。
典型的阻挡层材料包括钛、钛氮化物、钛钨化物,钽、钽氮化物等。例如,铝容易与硅发生反应。当铝需要在硅上布线时时,需要在两者之间放置阻挡金属(TiN,TiW)作为屏障。

2.3保护作用
金属化层可以作为一个保护层,紧紧地包裹在活泼金属的表面,防止环境中的化学物质、水分或氧气渗入芯片内部,达到防腐的作用。例如,暴露在空气中的铜会逐渐形成氧化铜层。为了防止这种情况,可以在铜导线上覆盖一层防腐金属,如钯、金或镍。
3 金属化有哪些方式?
3.1PVD
溅射沉积 (Sputtering):使用高能离子轰击靶材料,使靶材料的原子或分子溅射并沉积到基片上。 电子束蒸发 (E-beam Evaporation):利用高能电子束加热金属,使其蒸发并沉积到基片上。

3.2CVD 气态前驱体在晶圆上反应,形成所需的薄膜沉积在晶圆表面。CVD可用于沉积多种金属,如钨、铜、钛等。 主要方式有:MOCVD,LPCVD,PECVD,ALD等,常见反应式为:
TiCl4+2H2—>Ti+4HCl
WF6+3H2—>W+6HF
3.3电镀
通电,利用电化学原理,在晶圆表面沉积金属,一般电镀的镀种为Cu,Ni,Au,Sn等单质及其合金。比如Cu是互联的主要金属,由于铜无法被干法刻蚀,只能通过双大马士革工艺来进行互联金属的填充。 
3.4化学镀
不通电,单纯利用化学反应在晶圆表面沉积金属,常见的沉积金属为Ni,Pd,Au等单质。 晶圆制程的金属化一般只有这几种方式,可以根据设计的要求与实际需求来选择合适的金属化方式。
编辑:黄飞
-
芯片制造-半导体工艺制程实用教程2009-11-18 0
-
SMT制程常见缺陷分析与改善2012-08-11 0
-
半金属化孔的合理设计及加工方法2012-08-20 0
-
求助:IC芯片金属化在通孔位置出现空洞2016-10-30 0
-
什么是制程能力?2018-01-10 0
-
请问该怎么处理Altium Designer非金属化孔?2019-08-05 0
-
LCP天线金属化2020-01-10 0
-
常见的陶瓷金属化技术2021-01-06 0
-
什么是陶瓷金属化?斯利通来告诉你!2021-03-10 0
-
COG制程原理及流程2008-11-01 1768
-
半导体制程之薄膜沉积2009-03-06 5658
-
白光LED制程原理2009-03-07 1495
-
半导体知识:PVD金属沉积制程讲解2019-07-24 12396
-
功率芯片的制程2023-02-27 1501
-
芯片制程中常见的介质材料有哪些?都有什么作用?2023-10-19 3075
全部0条评论

快来发表一下你的评论吧 !

