

Si(111)衬底上脉冲激光沉积AlN外延薄膜的界面反应控制及其机理
电子说
描述
引言
通过有效控制AlN薄膜与Si衬底之间的界面反应,利用脉冲激光沉积(PLD)在Si衬底上生长高质量的AlN外延薄膜。英思特对PLD生长的AlN/Si异质界面的表面形貌、晶体质量和界面性能进行了系统研究。
我们研究发现,高温生长过程中形成非晶SiAlN界面层,这是由于高温生长过程中烧蚀AlN靶材时,衬底扩散的Si原子与脉冲激光产生的AlN等离子体之间发生了严重的界面反应所致。相反,通过在合适的生长温度下有效控制界面反应,可以实现突变且尖锐的AlN/Si异质界面。
因此英思特提出了通过PLD将界面层从非晶SiAlN层演变为突变且尖锐的AlN/Si异质界面的机制。通过PLD生长的AlN薄膜获得突变界面和平坦表面的工作对于高质量AlN基器件在Si衬底上的应用至关重要。
实验与讨论
使用H2SO4:H2O2:H2O(3:1:1)和缓冲氧化物蚀刻(BOE)HF(20:1)清洁收到的2英寸 Si(111) 基板以获得无氧化物且氢封端的Si表面。随后,将清洁后的Si(111)衬底在背景压力为1.0×10-8 Torr的超高真空(UHV)负载锁中脱气,然后 转移到背景压力为1.0×10-8Torr的生长室中。在外延生长之前,脱气后的Si(111)衬底在850℃下进行60分钟的退火,以去除残留的表面污染物,并为后续沉积获得原子级平坦的Si(111)表面。
在外延生长过程中,我们通过KrF准分子激光(λ= 248 nm,t= 20ns)烧蚀高纯度 AlN (4N)靶材,生长出厚度范围为~6–300nm的AlN薄膜。采用PLD法在Si(111)衬底上生长AlN薄膜示意图如图1所示。
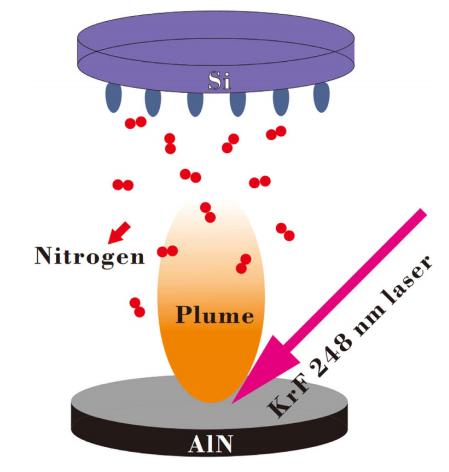 图1:通过PLD在Si(111)衬底上的AlN薄膜的外延生长示意图
图1:通过PLD在Si(111)衬底上的AlN薄膜的外延生长示意图
英思特采用RHEED测量来监测整个过程的生长过程。图2显示了在750℃下Si衬底上生长的AlN薄膜的照片,显示了在不同生长温度下生长的 AlN 薄膜的RHEED图案。很明显,在850℃退火60分钟后,可以在Si方向上识别出尖锐的条纹图案,这与退火工艺之前形成鲜明对比。随后,我们在退火后的Si衬底上生长AlN膜。在 850℃高温下生长约6nm厚的薄膜后,实验发现几乎无法识别 RHEED 图案,这表明发现了非常差的薄膜。这意味着生长出了表面相对粗糙的单晶AlN薄膜。如果在低温(800-700℃)下生长AlN薄膜,也可以获得单晶AlN薄膜。

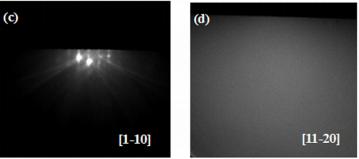
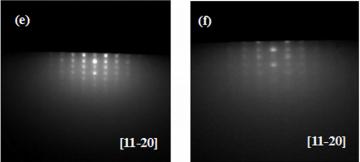
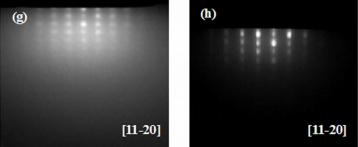 图2
图2
生长温度对 AlN 薄膜的结晶质量有重大影响。晶体生长温度的变化趋势与表面形貌的变化趋势非常一致。
结论
根据实验英思特提出了通过PLD将界面层从非晶SiAlN和层演化为突变且尖锐的 AlN/Si异质界面的机制。这项通过PLD生长的AlN薄膜获得突变界面和平坦表面的工作对于高质量AlN基器件在Si衬底上的应用具有重要意义。因此英思特提出了通过PLD将界面层从非晶SiAlN和层演化为突变且尖锐的AlN/Si异质界面的机制
审核编辑 黄宇
-
脉冲激光测距2021-05-08 0
-
激光配件——脉冲激光电源的原理2010-07-01 840
-
沉积氧气压力对纳米晶硅光致发光的影响2010-08-03 653
-
调Q激光自触发斩波产生纳秒脉宽单脉冲激光2010-12-13 895
-
硅单晶(或多晶)薄膜的沉积2009-03-09 7307
-
脉冲激光电源的设计与研制2009-07-15 1589
-
硅基GaN蓝光LED外延材料转移前后性能2011-04-14 498
-
硅基AlN薄膜制备技术与测试分析2011-06-24 789
-
脉冲激光测距仪的设计-课程设计2016-05-05 879
-
用脉冲激光在纯水中实现持续高速的水流2017-10-12 2939
-
脉冲激光能量参数关系_脉冲激光器的能量换算2018-05-17 22657
-
PLD脉冲激光沉积复合材料应用进展的详细资料概述2018-10-19 1081
-
泛林集团宣布推出全球首款面向量产的脉冲激光沉积(PLD)机台2024-04-07 525
-
异质外延对衬底的要求是什么?2024-04-17 147
全部0条评论

快来发表一下你的评论吧 !

