

半导体湿法清洗工艺
电子说
描述
随着技术的不断变化和器件尺寸的不断缩小,清洁过程变得越来越复杂。每次清洗不仅要对晶圆进行清洗,所使用的机器和设备也必须进行清洗。晶圆污染物的范围包括直径范围为0.1至20微米的颗粒、有机和无机污染物以及杂质。
清洁方法可分为湿法或干法。湿法清洁确实涉及溶剂、酸或水。另一方面,干洗则使用激光、气溶胶或臭氧化学物质。湿法硅片清洗方法是最常用的硅片清洗方法。
晶圆清洁必须在不向最终表面引入任何额外杂质或污染物的情况下进行。
RCA工艺
该工艺用于去除溶剂清洗工艺后可能存在于晶圆表面的有机材料、重离子或碱金属离子。通过超声波搅拌去除不需要的颗粒。使用比例范围在1:1至1:4之间的硫酸和过氧化氢,其中将硅晶片浸入这种溶液中约十分钟,同时将温度条件保持在一百到一百五十摄氏度之间。下一步是将晶圆浸入按1:10比例混合的盐酸和水的溶液中,该过程持续一分钟。然后在室温条件下用水冲洗晶片表面。RCA 清洗工艺的目的是氧化硅,在晶圆表面形成一层薄薄的氧化层,以保护晶圆。
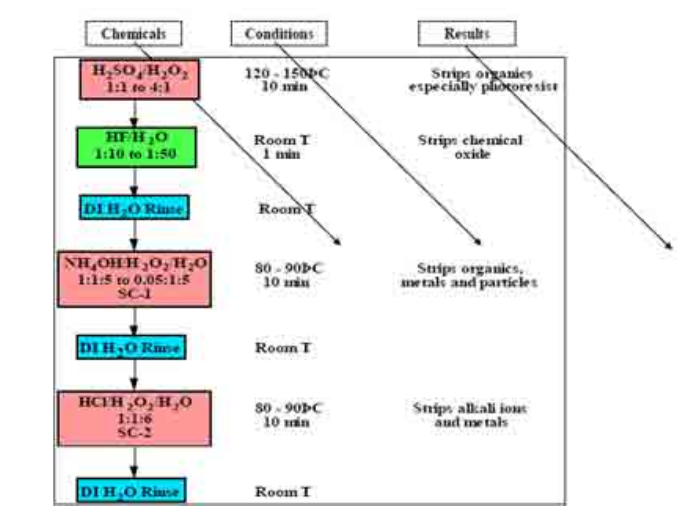
图1:RCA清洗过程
RCA清洁是晶圆的标准清洁工艺。它需要在高温处理步骤之前进行。RCA清洗是将RCA溶液加热至75或80摄氏度10分钟来进行。清洗硅片的过程比较复杂。这些材料非常脆弱,很容易被污染。
清洁硅片的过程涉及使用去离子水浴。这种水呈高酸性,必须不含硫和其他化学物质。水对于氧化溶液的正常运作比较重要,可以用于硅片的氧化处理。施加浆料后,我们用去离子液体冲洗。最后一步是臭氧清洗。
硅基板清洗程序
湿法清洗是最流行的硅片清洗方法。它使用苛性碱溶液溶解污垢和其他杂质,并彻底清洁晶圆。超声波清洗时间长达30分钟,但不宜使用太久。如果超声波照射时间过长,会损伤晶格。此外,过度暴露于超声波能量可能导致硅晶片上氧化层的生长。
清洗工艺是半导体制造中最重要的部分。清洁过程消除了可能影响成品的任何颗粒和污染物。它还减小了集成电路元件的尺寸。适当的清洁工艺将确保半导体的良好清洁和尺寸减小。因此,确保清洁高效的制造环境对于半导体制造有很大的作用。
审核编辑:汤梓红
-
半导体引线键合清洗工艺方案2010-04-22 0
-
半导体及光伏太阳能领域湿法清洗2011-04-13 0
-
硅片湿法清洗设备设备出售2015-04-02 0
-
半导体清洗设备2016-09-05 0
-
半导体湿法腐蚀设备2016-09-06 0
-
上海新国际博览中心参加2017慕尼黑上海半导体展2017-03-04 0
-
超声波清洗机,苏州晶淼半导体设备有限公司2020-05-26 0
-
《炬丰科技-半导体工艺》DI-O3水在晶圆表面制备中的应用2021-07-06 0
-
半导体清洗工艺全集2011-12-15 3782
-
工业泵在半导体湿法腐蚀清洗设备中的应用2023-04-20 930
-
半导体工艺—晶片清洗工艺评估2022-03-04 2642
-
半导体制造中的清洗工艺技术改进方法2023-08-01 2300
-
半导体工艺里的湿法化学腐蚀2023-08-30 2082
-
智程半导体完成股权融资,专注半导体湿法工艺设备研发2024-01-12 894
-
半导体清洗工艺介绍2024-01-12 1329
全部0条评论

快来发表一下你的评论吧 !

